Заблоцкий А.В., Тимофеев А.А., Коростылёв Е.В., Кузьмин А.А. Электронная микроскопия в нанодиагностике
Подождите немного. Документ загружается.


Московский физико-технический институт
Учебное пособие
Электронная микроскопия
в нанодиагностике
А.В. Заблоцкий, А.А. Тимофеев,
Е.В. Коростылев, А.А. Кузьмин
Москва
2011

УДК 537.533.35
Целью данного пособия является ознакомление основными методами ра-
стровой и просвечивающей электронной микроскопии, устройством и принципом
работы микроскопов и формированием изображении электронно-оптической сис-
темой. Читатели ознакомятся со способами интерпретации изображений, спектров
характеристического рентгеновского излучения, спектров катодолюминесценции,
расшифровки картин дифракции обратно отраженных и прошедших электронов и
так же получат представления о некоторых методах приготовления образцов.
Для студентов старших курсов и аспирантов.
Данное пособие издано на средства государственного контракта
№16.647.12.2016
от 25 ноября 2010 г. в рамках работ по направлению 2 Федеральной целевой
программы «Развитие инфраструктуры наноиндустрии в Российской Федерации
на 2008–2011 годы».
ISBN 987-5-8493-0230-0
© Можайский полиграфический комбинат
оформление, 2011

3
Оглавление
Введение ..........................................................................................................................5
Глава 1. Взаимодействие пучка ускоренных электронов с веществом ..............6
1.1. Виды взаимодействия, получаемая информация .......................................6
1.2. Описание процессов рассеяния ...................................................................9
1.3. Упругое рассеяние электронов ....................................................................9
1.4. Неупругое рассеяние электронов ..............................................................10
1.5. Вторичные, истинно вторичные и обратнорассеянные электроны .......14
1.6. Оже-электроны и характеристическое рентгеновское излучение ..........19
1.7. Контаминация .............................................................................................20
1.8. Нагрев образца электронным зондом .......................................................24
1.9. Контрольные вопросы к главе 1 ................................................................25
Глава 2. Общие элементы электронно-оптических приборов ............................26
2.1. Конструкция электронной пушки .............................................................26
2.2. Электромагнитные линзы ..........................................................................31
2.3. Аберрации электромагнитных линз ..........................................................34
2.4. Вакуумная система .....................................................................................39
2.5. Контрольные вопросы к главе 2 ................................................................40
Глава 3. Основы просвечивающей электронной микроскопии. Часть 1 .........41
3.1. Области применения. Преимущество и недостатки ...............................41
3.2. Основные характеристики .........................................................................42
3.3. Основные узлы ПЭМ ..................................................................................44
3.4. Механизмы формирования изображения. Режимы работы ....................49
3.5. Виды контраста в просвечивающей электронной микроскопии............56
3.6. Контрольные вопросы к главе 3 ................................................................63
Глава 4. Основы просвечивающей электронной микроскопии. Часть 2 .........64
4.1. Юстировка и калибровка ...........................................................................64
4.2. Примеры исследований методами высокого разрешения .......................68
4.3. Основы методов электронной дифракции ................................................72
4.4. Приготовление образцов для просвечивающей
электронной микроскопии .........................................................................82
4.5. Контрольные вопросы к главе 4 ................................................................90

4
Глава 5. Основы растровой электронной микроскопии. Часть 1 ......................91
5.1. Области применения. Преимущество и недостатки ...............................91
5.2. Основные характеристики .........................................................................92
5.3. Основные узлы РЭМ ..................................................................................94
5.4. Механизм формирования изображения ..................................................100
5.5. Виды контраста в растровой электронной микроскопии .....................104
5.6. Контрольные вопросы к главе 5 ..............................................................107
Глава 6. Основы растровой электронной микроскопии. Часть 2 ....................108
6.1. Калибровка ................................................................................................108
6.2. Измерение линейных размеров ...............................................................109
6.3. Эффект каналирования и дифракция
обратнорассеянных электронов...............................................................114
6.4. Оже-электронная спектроскопия ............................................................121
6.5. Электронно-зондовый рентгеновский микроанализ .............................124
6.6. Катодолюминесценция .............................................................................138
6.7. Контрольные вопросы к главе 6 ..............................................................144
Литература .................................................................................................................145

5
Введение
При помощи электронных микроскопов получают увеличенное изо-
бражение объекта исследования. Разрешение современных растровых
электронных микроскопов (РЭМ) достигает 1 нм, разрешение просвечива-
ющих электронных микроскопов (ПЭМ) таково, что с их помощью можно
получить изображения индивидуальных атомных колонок кристаллических
материалов (последние модели современных ПЭМ с корректором сферичес-
кой аберрации имеют разрешение по точкам 0,08 нм).
Просвечивающая электронная микроскопия требует подготовки образ-
цов – утонения до толщины порядка 100 нм и менее. В силу этого методами
ПЭМ можно изучать тонкую структуру веществ, получить данные о дефек-
тах кристаллической решетке и многие другие их характеристики, некоторые
из них в настоящее время нельзя исследовать другими методами. Информа-
ция, получаемая при помощи просвечивающей электронной микроскопии,
предоставляет возможность найти корреляцию между макросвойствами и
структурой (тонкой структурой) объекта.
Растровая микроскопия, в отличие от просвечивающей, обычно не тре-
буется никакой предварительной подготовки поверхности. Ещё одно её пре-
имущество – большая глубина резкости, получаемая вследствие принципа
работы растровой электронной микроскопии – сканировании исследуемой
поверхности тонким электронным лучом по типу телевизионной развёртки.
Порожденные электронным лучом вторичные электроны регистрируются де-
тектором электронов. Интенсивность полученного с детектора сигнала опред-
еляет яркость точки растра на итоговом изображении. Так как коэффициент
вторичной эмиссии зависит от локального рельефа поверхности, на экране
монитора возникает увеличенное изображение объекта.
Целью данного курса является ознакомление основными методами ра-
стровой и просвечивающей электронной микроскопии, устройством и прин-
ципом работы микроскопов и формированием изображении электронно-
оптической системой. Слушатели ознакомятся со способами интерпретации
изображений, спектров характеристического рентгеновского излучения,
спектров катодолюминесценции, расшифровки картин дифракции обратно
отраженных и прошедших электронов и так же получат представления о
некоторых методах приготовления образцов.
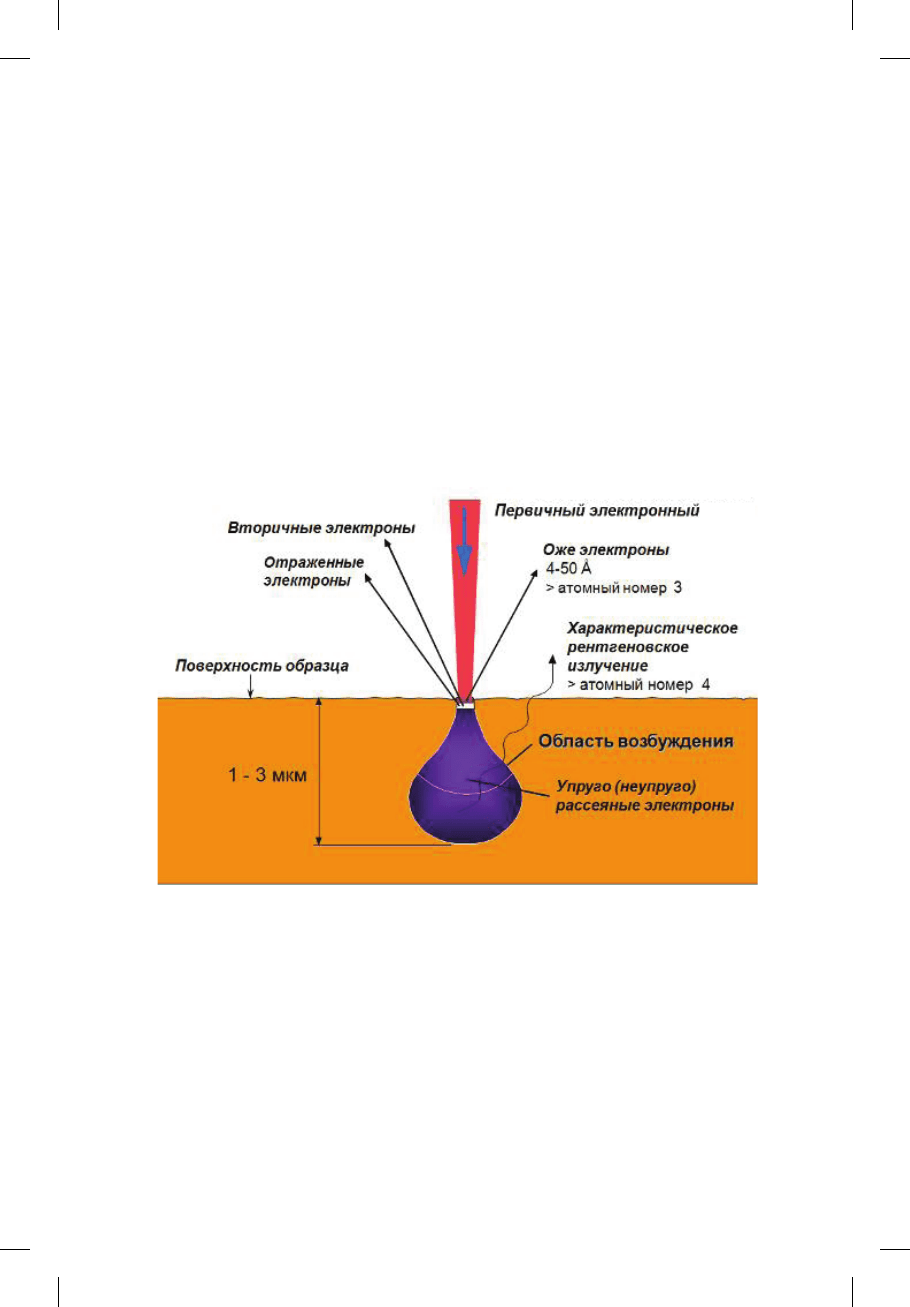
6
Глава 1. Взаимодействие пучка ускоренных
электронов с веществом
1.1. Виды взаимодействия, получаемая информация
При взаимодействии пучка ускоренных электронов с веществом про-
исходит различные процессы. На рисунке 1.1 изображена область возбуж-
дения (генерации) разных процессов при взаимодействии электронного
пучка с массивным образцом. Характер взаимодействия электронного пуч-
ка с веществом зависит от энергии падающих на вещество электронов, сле-
довательно, и получаемая информация. На принципе регистрации резуль-
татов тех или иных процессов (откликов) взаимодействия электронного
пучка с веществом основаны различные количественные и качественные
методы исследования материалов.
Рисунок 1.1 – Область возбуждения вещества при взаимодействии
электронного пучка с веществом для массивного образца.
Электронно-оптические приборы, работающие на этих принципах,
применяются для визуализации микроструктуры, анализа элементного
состава, для определения кристаллографических параметров и т.д. (см.
таблицу 1.1). Рисунок 1.2 иллюстрирует, что в этих приборах информа-
цию получают от некоторого ограниченного объема образца, и разре-
шение зависит от диаметра электронного зонда и размера области, где
генерируется тот или иной информативный сигнал. Приборы, регистри-
рующие вторичные и отраженные электроны, называются растровыми
электронными микроскопами (РЭМ).
пучек
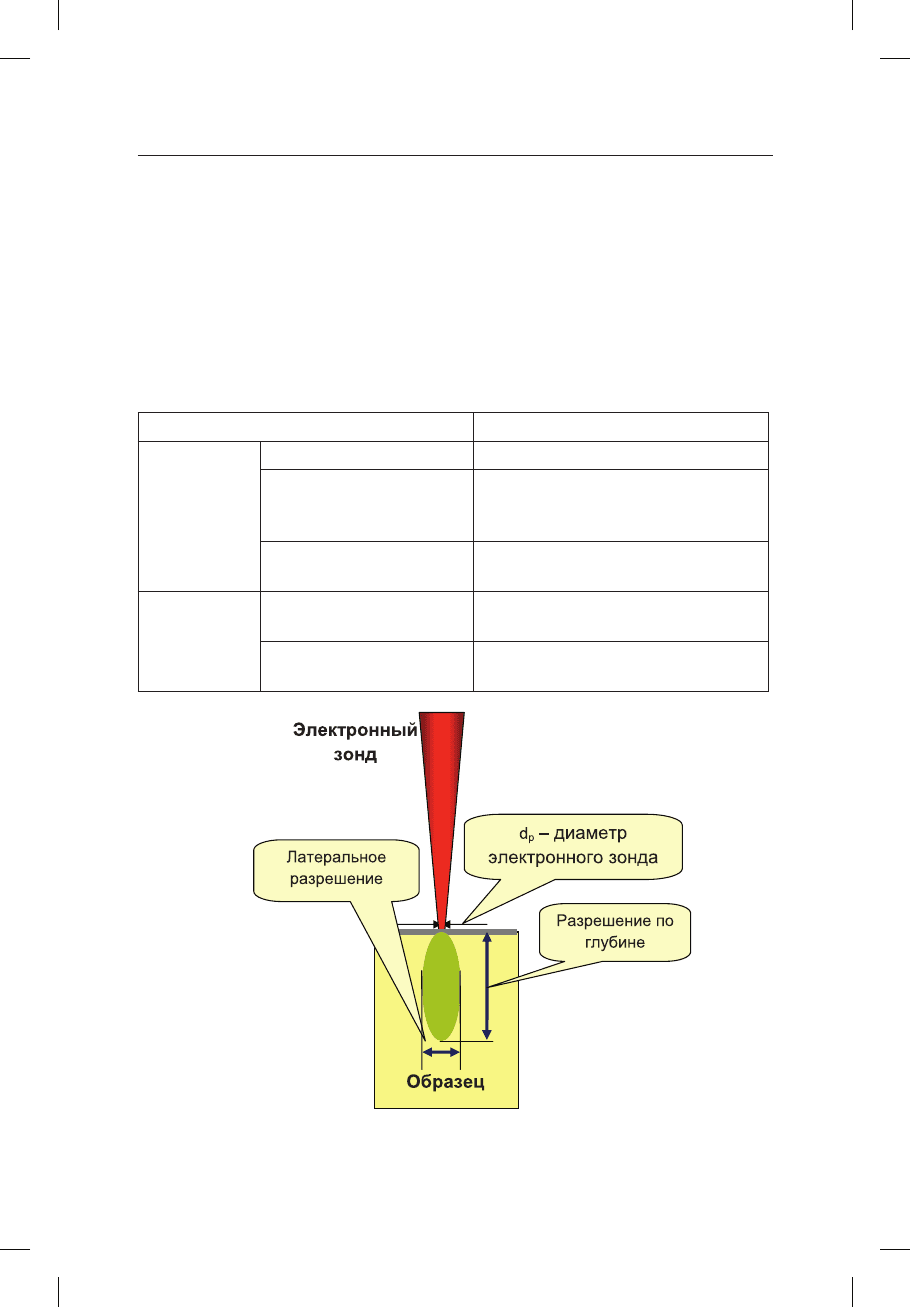
7
Можно выделить еще один класс приборов, в которых используется
электронный пучок, это так называемые – просвечивающие электронные
микроскопы (ПЭМ, в английской аббревиатуре TEM). В ПЭМ использу-
ются тонкие образцы. В этом случае подавляющая часть электронов «про-
ходит» сквозь образец (рисунок 1.3). Прошедшие через образец электроны
условно можно разбить на три части: прямо прошедшие, упруго рассеянные
электроны и неупруго рассеянные электроны.
Таблица 1.1. Информативность сигналов при исследовании массивных образцов
Сигналы Информативность
Электроны
Истинно вторичные Морфология поверхности
Обратнорассеянные
(отраженные)
Рельеф (качественно)
Элементный контраст
Кристаллографическая информация
Оже-электроны
Химический состав
(химические связи)
Фотоны
Характеристическое
рентгеновское излучение
Элементный состав
Катодолюминесценция
Структура энергетических уровней
Мелкие примеси
Рисунок 1.2 – Пространственное разрешение определяется размером
области, из которой регистрируется информативный сигнал.
1.1. Виды взаимодействия, получаемая информация

8
1.1. Виды взаимодействия, получаемая информация
Прямопрошедшие – это те электроны, траектории которых совпада-
ет с траекторией первичного электронного пучка. К упруго рассеянным
электронам относятся те электроны, которые в результате взаимо-
действия с объектом отклонились от первоначальной траектории, но
при этом сохранили первоначальную скорость (энергию). Некоторая
часть электронов при прохождении через образец теряет часть своей
энергии и траектории этих электронов отличаются от первоначальной.
Эти электроны называют неупругорассеянными. Неупругорассеянные
электроны так же несут определенную полезную информацию и анализ
спектра энергии электронов (величин потери энергии электронов) пред-
оставляет возможность определить элементный состав образца.
Рисунок 1.3 – Взаимодействие электронного пучка с тонким образцом.
В просвечивающей электронной микроскопии, в том числе и в
электронной микроскопии высокого разрешения (ПЭМ ВР) главным обра-
зом используют прямопрошедшие и упруго рассеянные электроны. Иног-
да, в некоторых случаях, когда хотят подчеркнуть, что при проведении ис-
следований не использовалось дополнительное оборудование (приставки)
этот метод еще называют обычной просвечивающей электронной микрос-
копией (ОПЭМ). На микроскопы можно установить приставки для опред-
еления локального элементного состава, такие как энергодисперсионный
спектрометр характеристического рентгеновского излучения (ЭДС, в ан-
глийской аббревиатуре EDS), спектрометр характеристических потерь
энергии электронов (СХПЭЭ, в английской аббревиатуре EELS) и др. При
применении в микроскопических исследованиях установленного на ми-
кроскоп дополнительного оборудования метод называется аналитической
просвечивающей электронной микроскопией (АПЭМ).

9
1.2. Описание процессов рассеяния
1.2. Описание процессов рассеяния
При движении электронов в твердом теле (мишени) происходит их
взаимодействие с атомами твердого тела – рассеяние. Результатом рассея-
ния является изменение траектории и (или) энергии электрона. Процессы
рассеяния характеризуются своей вероятностью, мерой которой обычно
является сечение рассеяния σ. В общем случае сечение определяется как:
(1.1)
где N – число актов рассеяния в единице объема, nм – число атомов ми-
шени в единице объема, nп – число частиц, падающих на единицу площа-
ди. Сечение рассеяния может рассматриваться как эффективная площадь
атома при данном взаимодействии. При этом часто используется внесис-
темная единица – барн, сокращение б., бн. 1 бн = 10
-28
м
2
= 10
-24
см
2
.
Из сечения рассеяния можно получить длину свободного пробега:
(1.2)
где А – атомный вес (г/моль), N0 – число Авогадро (6.02·10
23
атом/
моль), ρ – плотность (г/см
3
), σ – сечение.
Длина пробега при наличии нескольких процессов рассеяния с
различными сечениями дается выражением:
12
111
...,
lll
=++
(1.3)
где λi – длина пробега, рассчитанная для соответствующего сечения
i–го типа рассеяния.
Процессы рассеяния делятся на упругие и неупругие. При упругом рас-
сеянии меняется только направление скорости движения электрона, а его
энергия остается практически той же.
1.4. Неупругое рассеяние электронов
При неупругом рассеянии электрон постепенно передает энергию
атомам и электронам мишени и таким образом замедляется. При акте од-
нократного рассеяния угол неупругого рассеяния намного меньше угла
упругого рассеяния (θну<< θу). Существует несколько механизмов потери
энергии электрона при движении в мишени:
• возбуждение плазмонов – квантов плазменных колебаний в электрон-

10
ном газе мишени;
Таблица 1.2. Средняя длина свободного пробега для рассеяния в нм
Элемент
Энергия электрона
10 кэВ 20 кэВ 30 кэВ 40 кэВ 50 кэВ
С (Z=6)
5.5 22 49 89 140
Al (Z=13)
1.8 7.4 17 29 46
Fe (Z=26)
0.3 1.3 2.9 5.2 8.2
Ag (Z=47)
0.15 0.6 1.3 2.3 3.6
Pb (Z=82)
0.08 0.34 0.76 1.4 2.1
U (Z=92)
0.05 0.19 0.42 0.75 1.2
• возбуждение электронов с внешних оболочек атомов или электронов
проводимости – эмиссия вторичных электронов с энергиями 0-50 эВ,
катодолюминесценция;
• возбуждение электронов с внутренних оболочек атома – при после-
дующей релаксации атома происходит эмиссия характеристического
рентгеновского излучения или эмиссия оже-электронов;
• непрерывное или тормозное рентгеновское излучение – при торможе-
нии электрона в кулоновском поле атома энергия электрона тратится
на излучение кванта рентгеновского излучения. Так как величина по-
тери энергии может принимать любое значение, то спектр тормозно-
го излучения является непрерывным;
• возбуждение фононов – значительная доля энергии электрона пе-
редается мишени за счет возбуждения квантов колебания решетки
(фононов), т.е. за счет нагревания. Не облучаемая часть массивной
мишени работает как эффективный тепловой сток, предотвращая ее
чрезмерное нагревание.
Неупругое рассеяние происходит при одновременном участии всех этих
механизмов. Сечение рассеяние индивидуального процесса трудно полу-
чить для всех типов мишеней, поэтому часто рассматривают все механизмы
рассеяния с непрерывными потерями энергии сгруппированными вместе.
Г. Бете вывел уравнение, учитывающее все механизмы неупругого
рассеяния. Оно описывает скорость потери энергии на отрезке про-
йденного пути:
2
2
22
e
2
0
e
2
4
ln
4
mv
dE nz e
dx I
mv
p
pe
⎛⎞
⎛⎞
−= ⋅ ⋅
⎜⎟
⎜⎟
⎝⎠
⎝⎠
, (1.6)
где , mev
2
/2 – кинетическая энергия электрона, I – сред-
ний потенциал ионизации атома мишени, x – длина участка сложной тра-
ектории электрона.
1.3. Упругое рассеяние электронов
