Заблоцкий А.В., Тимофеев А.А., Коростылёв Е.В., Кузьмин А.А. Электронная микроскопия в нанодиагностике
Подождите немного. Документ загружается.

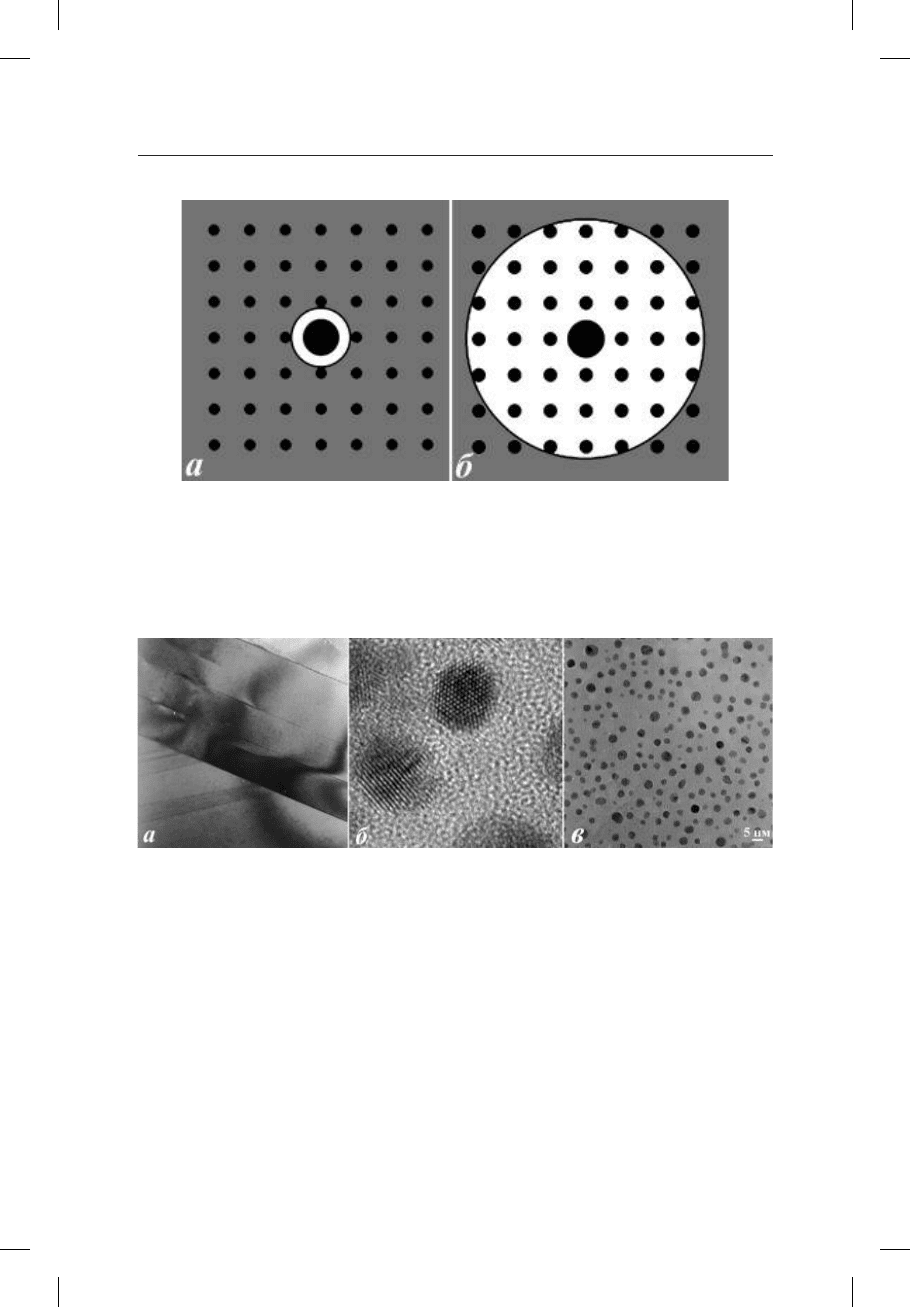
51
Рисунок 3.9 – Расположение диафрагмы объектной линзы
относительно центрального и дифрагированных пучков
(режим дифракции) при получении светлопольного изображений.
а – через диафрагму проходит только центральный пучок.
б – через диафрагму проходят центральный
и дифрагированные пучки.
Рисунок 3.10 – Светлопольные (СП) изображения.
а – СП изображение обычного разрешения висмутового ВТСП фазы 2212;
б – СП изображение высокого разрешения наночастицы золота в матрице
аморфного SiO2; в – СП изображение наночастиц золота на углеродной пленке.
Для получения светлопольного изображения используется прямо про-
шедший пучок электронов, т.е. в формировании светлопольного изображе-
ния обязательно участвует прямо прошедший пучок. Выделение прямого
пучка производится в режиме дифракции (рисунок 3.9а), путем пропус-
кания через диафрагму объективной линзы прямого пучка и отсеканием
«лишних» дифрагированных пучков диафрагмой. В случае прохождения
через диафрагму объективной линзы только прямого пучка, на светлополь-
3.4. Механизмы формирования изображения. Режимы работы

52
ном изображении преобладает дифракционной контраст. Само изображе-
ние в этом случае является однолучевым.
Если на путь электронного пучка выставить диафрагму такого раз-
мера, которая наряду с прямым пучком пропускает и дифрагированные
пучки (определенное количество), то на светлопольноем изображении до-
минирует фазовый контраст (рисунок 3.9б). Изображение в этом случае
будет многолучевым. При определенных условиях (точная ориентация об-
разца относительно электронного пучка, необходимая толщина образца,
требуемые инструментальные параметры, в том числе соответствующее
разрешение) возможно получения прямого разрешения атомной решетки.
Примеры светлопольных изображений приведены на рисунке 3.10.
Рисунок 3.11 – Расположение диафрагмы объектной линзы относительно
центрального и дифрагированных пучков (режим дифракции) при получе-
нии темнопольных изображений. а – через диафрагму проходит только один
дифрагированный пучок. б – через диафрагму проходят большое количество
дифрагированных пучков. в – центральный пучок перекрыт мини экраном.
Используя любой дифрагированный пучок без использования цен-
трального пучка можно получить темнопольное (ТП) изображение.
На темнопольных изображениях видно, какие области образца вно-
сят свой вклад в определенный дифрагированный пучок. Выделение
дифрагированных пучков, как и в случае светлого поля, осуществляет-
ся диафрагмой объективной линзы в режиме дифракции (рисунок 3.11).
При формировании ТП изображения одним дифрагированным пуч-
ком получаем однолучевое ТП изображение, на котором доминирует
дифракционный контраст. Если в получении ТП изображении участву-
ет большое количество дифрагированных пучков, то ТП изображение
называется многолучевым и на нем преобладает фазовый контраст.
Существуют несколько способов получения изображений темного
поля. Более простой способ заключается в выборе дифрагированных пуч-
3.4. Механизмы формирования изображения. Режимы работы

53
ков путем смещения диафрагмы объективной линзы с оптической оси. Не-
достаток такого способа заключается в том, что точки на изображении из-
за сферической аберрации удлиняются вдоль направления от центрального
рефлекса к выбранным рефлексам дифракционной картины, т.е. теряется
разрешение в указанном направлении и темнопольное изображение будет
не резким. Влияние сферической аберрации можно свести к минимуму
изменением угла падения электронного пучка на образец таким образом,
чтобы выбранный дифрагированный пучок был направлен вдоль оптичес-
кой оси микроскопа. В этом случае разрешение на ТП изображениях не
будет отличаться от светлопольных.
Рисунок 3.12 – Светлопольное (СП) и темнопольное (ТП)
изображения окиси алюминия в матрице полимера. а – СП изображение;
б –д – ТП изображения; е –электронграмма с выбранной области.
3.4. Механизмы формирования изображения. Режимы работы

54
На рисунке 3.12 приведен пример темнопольного изображения. В
формировании ТП изображений участвовали разные дифракционные
максимумы. При сравнении ТП и СП изображений видно, что темные
области на СП изображении на ТП изображениях выглядят светлыми, т.е.
СП и ТП изображения взаимоинвертируемы. На однолучевом темнополь-
ном изображении наблюдаются те области объекта, которые дают вклад в
интенсивность дифрагированного пучка, в котором оно получено. Вслед-
ствие этого, ТП изображения являются очень полезными при анализе
сложных структур, при интерпретации электронограмм от многофазных
материалов и дефектов структуры.
Режим дифракции. В режиме дифракции работы микроско-
па, дифракционная картина, которая образуется на задней фокальной
плоскости объективной линзы, в увеличенном виде проецируется на
экран. В электронной микроскопии дифракционную картину называют
электронограммой, а дифракционные максимумы – рефлексами.
Рисунок 3.13 – Типичные дифракционные картины.
а – ДК от амофного материала; б – ДК от монокристалла;
в – ДК в сходящимся пучке от монокристаллического материала.
Электронный микроскоп позволяет получить дифракционную картину
с локальных областей, тем самым появляется возможность отождествле-
ния структурных особенностей с кристаллографическими характеристи-
ками. Дифракционная картина позволяет определить состояние вещества
и получить ответы на такие вопросы как является ли материал образца
кристаллическим или аморфным, поликристаллическим или мононкрис-
таллическим, имеется ли текстура. Из анализа электронограммы можно
получить данные о параметрах решетки, о симметрии, о типе структуры и
другие данные. Так же можно определить ориентация зерен относительно
электронного пучка и относительно друг друга.
Существует несколько способов получения дифракции. Самым
используемым является метод получения дифракции с выбранной области
или его называют микродифракцией. В этом случае, область, откуда по-
3.5. Виды контраста в просвечивающей электронной микроскопии
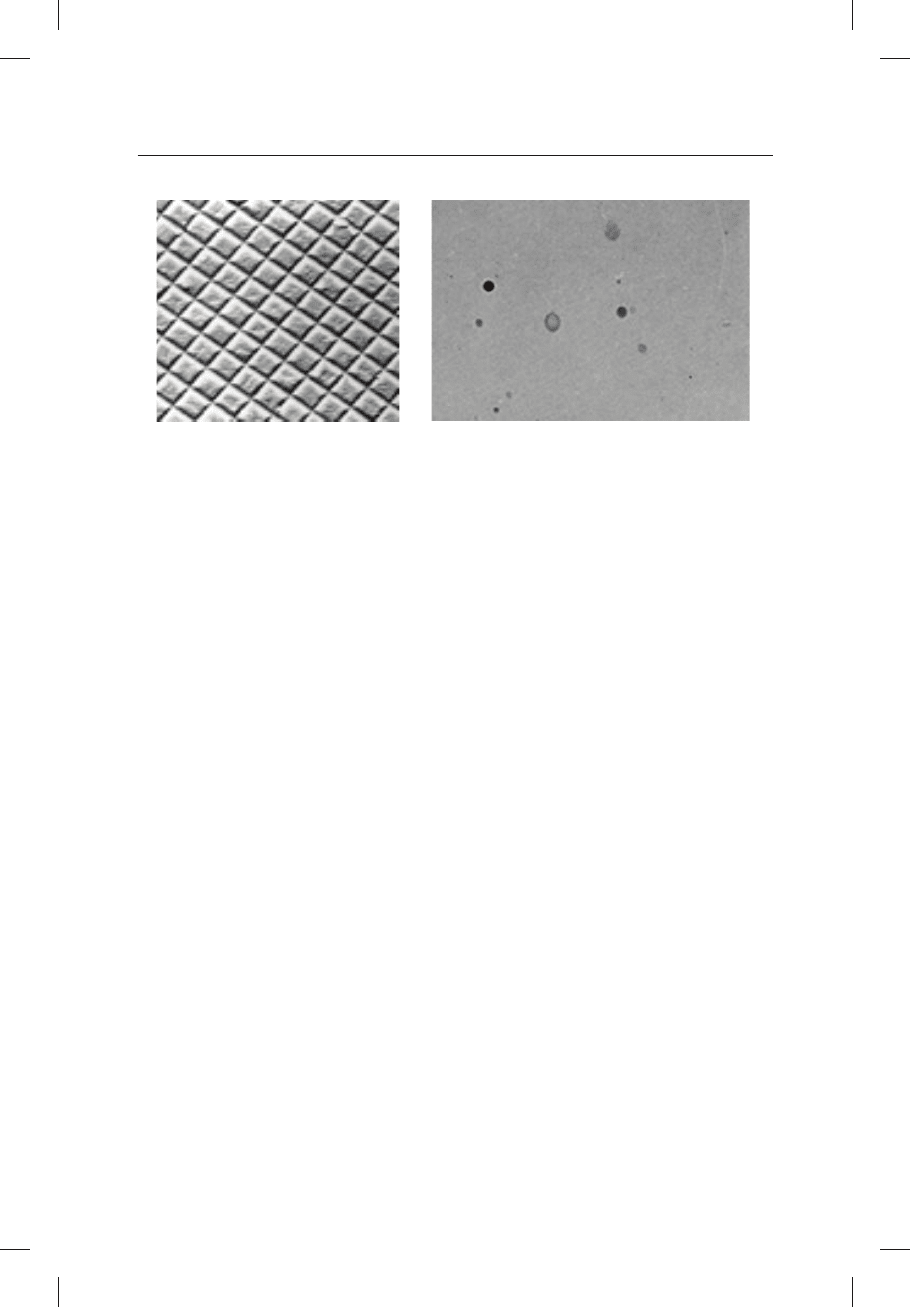
55
лучается дифракция, выбирается при помощи селекторной диафрагмы.
Минимальная область, откуда получается дифракция, для этого метода со-
ставляет примерно 100 нм.
Область при микролучевой дифракции (нанодифракции) определяет-
ся размером пятна электронного пучка на объекте. У современных ми-
кроскопов электронный пучок можно сфокусировать на объекте размером
около 1 нм. Объект для исследования можно расположить не только на
предметном столике, но и после всех линз. Тогда, вся колонна микроскопа
будет играть роль осветителя. В этом случае, можно получить дифракци-
онную картину и полученная дифракционная картина проецируется напря-
мую на экран или на фотопластину. Полученная таким образом картина
не подвержена влиянию сферической аберрации электромагнитных линз и
называется дифракционной картиной высокого разрешения. Существуют
и другие способы получения дифракционной картины.
Примерами других дифракционных картин являются дифракция в схо-
дящемся пучке, дифракция с прецессией. Примеры дифракционных картин
приведены на рисунке 3.13. При прохождении электронов сквозь образец
некоторые электроны теряют незначительную часть своей энергии. С увели-
чением толщины образца количество неупругорассеянных электронов уве-
личивается. Для «толстых» образцов интенсивность неупругорассеянных
электронов довольно высокая. В достаточно совершенном кристалле, для
части этих электронов может выполняться условие Вульфа-Брэга, в резуль-
тате которого на электронограмме появляются парные светлые и темные
линии, которые называются избыточной и дефектной, соответственно. Та-
кие линии называются Кикучи – линиями.
3.5. Виды контраста в просвечивающей электронной микроскопии
аб
Рисунок 3.14 – Примеры изображений с амплитудным контрастом.
а - светлопольное изображение реплики дифракционной решетки
с линейностью 2600 штрихов на мм; б - светлопольное изображение
углеродной пленки, содержащей кластеры вольфрама.

56
3.5. Виды контраста в просвечивающей
электронной микроскопии
Контраст на электронно-микроскопических изображениях зависит от
распределения электронов на внешней стороне образца и определяется как
разница в интенсивностях между соседними областями на изображении:
К= ∆I/ I1 = (I1 – I2)/ I1. Довольно часто в электронной микроскопии контраст
понимают шире. Различают два типа контраста: амплитудный и фазовый
контраст. На однолучевых изображениях преобладает амплитудный контр-
аст и разрешение на таких изображениях не лучше 1 нм. С помощью тако-
го контраста невозможно выявить атомную структуру объекта.
Амплитудный контраст условно можно разбить на контраст,
обусловленный эффективной толщиной образца, иногда его называют
контрастом толщины и плотности, и на дифракционный контраст. Контр-
аст, обусловленный эффективной толщиной характерен для большинства
биологических объектов, аморфных материалов и полимеров. Участки об-
разцов, которые отличаются по толщине или отличаются по элементному
составу, рассеивают электроны на различные углы. Большая часть
электронов рассеянные «толстыми» участками и областями, содержащие
более тяжелые элементы, при соответствующих размерах диафрагмы
объективной линзы, задерживаются этой диафрагмой. На изображениях
такие участки образцов выглядят более темными по сравнению с дру-
гими участками. На рисунке 3.14 приведены снимки таких образцов. На
изображении реплики бороздки дифракционной решетки выглядят более
темными вследствие увеличения локальной толщины слоя аморфного
углерода в местах бороздки. На правом рисунке 3.14 в более темных об-
ластях локализованы атомы вольфрама в аморфной углеродной пленке.
В кристаллических материалах дифракция электронов происходит в
каком-то объеме вещества согласно закону Вульфа-Брэга. Вследствие нали-
чия дефектов в этом объеме возникают локальные области деформации ре-
шетки. Условие Вульфа-Брэга в этих деформированных областях будет отли-
чаться от соседних. Ввиду малости длины волны электронов в электронных
микроскопов, угол отклонения 2ΘВ является небольшим. В случае откло-
нения электронов на угол превышающей половины угла α диафрагмы
объективной линзы, дифрагированные электроны будут задерживаться этой
диафрагмой. На изображении эти участки будут наблюдаться более темными.
Полученный таким образом контраст называется дифракционным. Следова-
тельно, дифракционный контраст обусловлен дефицитом электронов.
Образование дифракционного контраста можно проиллюстрировать на
3.5. Виды контраста в просвечивающей электронной микроскопии

57
Рисунок 3.15 – Изображение краевой дислокации:
а – упрощенное схематическое изображение возникновения дифракционно-
го контраста; б – ход лучей при дифракции электронов от деформированных
атомных плоскостей ядра краевой дислокации.
изображении краевой дислокации (рисунок 3.15). В искаженной краевой
дислокацией части кристалла (ядро дислокации) дифракционные условия
отличаются от окружающих областей. Электроны, которые отклонились
на углы больше чем α/2, задерживаются диафрагмой объективной линзой.
В результате этого, на светлопольных изображениях дислокации видны в
виде темных линий. На рисунке 3.16 приведены примеры изображений с
дифракционным контрастом.
Для совершенных кристаллов дифракционный контраст проявляется в
виде эффектов толщины, упругих напряжений и изгиба. Обычно, в боль-
шинстве случаях интерпретация изображений с дифракционным контрас-
том не вызывает трудностей, т.к. контраст от многих дефектов известен.
Однако, положение может сильно усложняться, например, когда исследу-
ются сильно деформированные образцы или частицы выделенной фазы
занимают достаточно большой объем материала, когда имеются большая
плотность дефектов и перекрывающиеся поля деформаций.
Фазовый контраст имеет место, когда изображение получено более чем
одним пучком и разрешение по точкам на многолучевых изображениях,
полученных при помощи современных микроскопов достигает 0,19 нм и 0,08
нм при применении корректоров сферической аберрации. Фазовый контраст
появляется в результате сдвига фаз выходящих из образца электронных волн.
Этот сдвиг фаз очень чувствителен к таким факторам как толщина, состав и
структура образца и инструментальным параметрам, как дефокусировка и др.
Это обстоятельство предъявляет весьма жесткие условия получения
прямого изображения кристаллической решетки. Интерпретировать такие
3.5. Виды контраста в просвечивающей электронной микроскопии

58
изображения как проекции зарядовой плотности возможно только для уль-
тратонких образцов. При этом изображения должны быть получены при
строгой ориентации образца относительно электронного пучка и при опти-
мальном выборе инструментальных параметров микроскопа (дефокуси-
ровка, условие освещения, оптимальный диаметр диафрагмы объективной
линзы). Достаточно большая часть образцов «слишком толстые». Изобра-
жения от таких образцов хотя и определяются конкретно расположенными
атомами в кристалле, но не передают их расположения.
аб
Рисунок 3.16 – Примеры ПЭМ изображений с дифракционным контрастом.
а - изображение геликоидальных дислокаций;
б – изображение сферообразных частиц кремния.
аб
Рисунок 3.17 – Экспериментальные электронно-микроскопические
изображения высокого разрешения. а – изображение образца Si;
б – изображение фазы 2212 висмутового ВТСП.
3.5. Виды контраста в просвечивающей электронной микроскопии

59
На рисунке 3.17 приведены ПЭМ изображения высокого разрешения
кремния и фазы 2212 висмутового ВТСП. Левое изображение получено
при условиях, удовлетворяющих вышесказанным требованиям и его мож-
но интерпретировать как проекция зарядовой плотности, т.е. светлые пят-
на на изображении представляют собой колонны атомов кремния. На та-
ких изображениях непосредственно можно наблюдать дефекты решетки.
На рисунке 3.17б приведено изображение, которое получено от образца,
толщина которого больше оптимальной.
Рисунок 3.18 – Экспериментальное
изображение высокого разрешения
гетероструктуры InAs/InAsSb.
Стрелками указаны область ядра
краевых дислокаций несоответствия.
Рисунок 3.19 – Экспериментальное
изображение высокого разрешения
фазы 2212 висмутового ВТСП.
Видно изменение изображения,
вызванное изменением локальной
толщины образца (в направлении
стрелки).
На рисунке 3.18 показано изображение высокого разрешения на кото-
ром видна экстраплоскость краевой дислокации. В некоторых случаях ис-
следуемая часть объекта имеет вид клина. В таких случаях видоизменение
изображения по площади возможно не связано модификацией структуры
образца, а возможно вызваны изменением локальной толщины образца
(см. рисунок 3.19). Подобные изображения дают ошибочное представле-
ние о структуре образца. Для интерпретации таких изображений необхо-
димо получить расчетные изображения в зависимости от дефокусировки и
толщины и сравнить их с экспериментальными. Существуют программы
для расчета изображений, в которых реализованы разные методы. Самым
распространенным является многослоевой метод. Блок-схема этой
программы приведена на рисунке 3.20.
3.5. Виды контраста в просвечивающей электронной микроскопии

60
3.5. Виды контраста в просвечивающей электронной микроскопии
Рисунок 3.20 – Блок схема программы для расчета
изображений многослоевым методом.
В некоторых случаях экспериментальные микроснимки перед срав-
нением с расчетным подвергают улучшению. Обычно используют ме-
тод Фурье фильтрации. На рисунке 3.21 представлена микрофотография
наночастицы золота после Фурье фильтрации. Моделирование расчетных
изображений золота проводилось для направления [111]. Вначале были
получены расчетные изображения с грубыми шагами толщины и дефоку-
сировки, по которым были выбраны диапазоны для последующего модели-
