Строшио М., Дутта М. Фононы в наноструктурах
Подождите немного. Документ загружается.

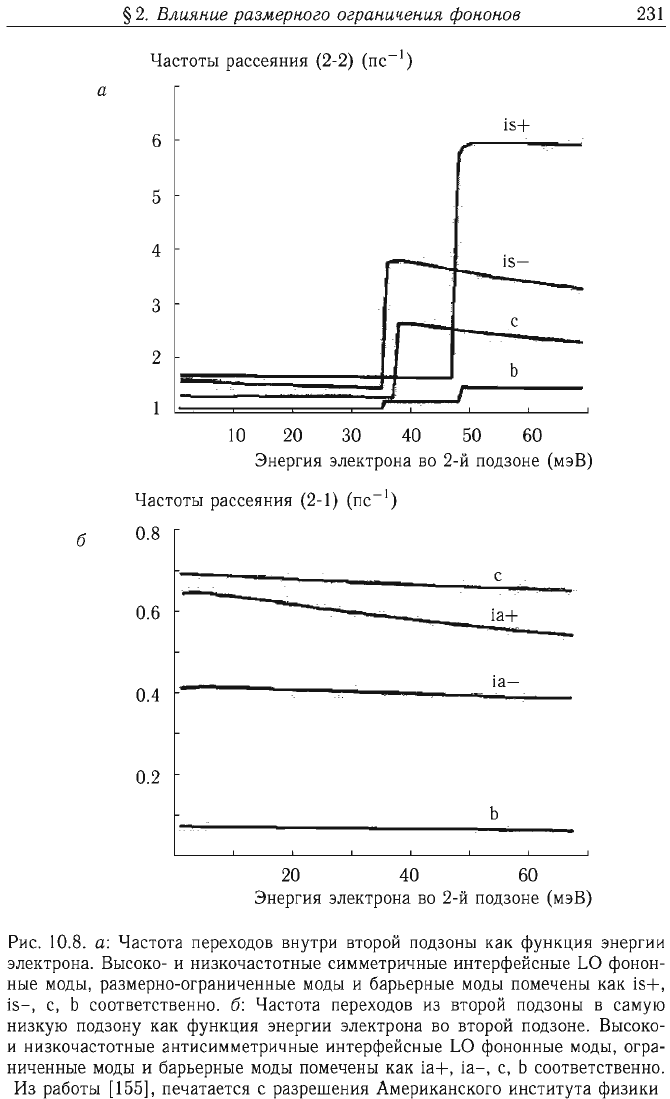
§2.
Влияние
разм-ерного
ограничения
фононое
Частоты
рассеяния
(2-2)
(пс
")
а
231
6
5
4
3
2
is+
............
.--.,.
is-
-......:.
......
.....
с
Ь
1
10 20 30 40 50 60
Энергия
электрона
во
2-й
подзоне
(мэБ)
Частоты
рассеяния
(2-1)
(пс
-1)
б
0.8
с
0.6
0.4
0.2
ia+
ia-
ь
20 40 60
Энергия
электрона
во 2-й
подзоне
(мэБ)
Рис.
10.8.
а:
Частота
переходов
внутри
второй
подзоны
как
функция
энергии
электрона.
Бысоко-
и
низкочастотные
симметричные
интерфейсные
LO
фонон
ные
моды,
размерно-ограниченные
моды
и
барьерные
моды
помечены
как
is+,
is-,
с,
Ь
соответственно.
б:
Частота
переходов
из
второй
подзоны
в
самую
низкую
подзону
как
функция
энергии
электрона
во
второй
подзоне.
Бысоко
и
низкочастотные
антисимметричные
интерфейсные
LO
фононные
моды,
огра
ниченные
моды
и
барьерные
моды
помечены
как
ia+,
ia-,
с,
Ь
соответственно.
Из
работы
[155],
печатается
с
разрешения
Американского
института
физики

232
Гл.
10.
Последние
разработки
Частоты
рассеяния
(1-1)
(пс"
1)
is-
---..~-------
5
6
4
3
а
2
5 6
7
8 9
Ширина
ямы
(нм)
б
Частоты
рассеяния
(2-1)
(пс
" ")
1.5
1.0
0.5
5
6 7 8 9
Ширина
ямы
(нм)
Рис.
10.9.
а:
Частота
переходов
внутри
низшей
подзоны
как
функция
толщины
квантовой
ямы.
Начальная
энергия
электрона
в
первой
подзоне
- 60
мэБ.
б:
Частота
переходов
из
второй
подзоны
в
первую
как
функция
толщины
ямы.
Начальная
энергия
электрона
во
второй
подзоне
- 10
мэБ.
Из
работы
[155],
печатается
с
разрешения
Американского
института
физики

§
З.
Вклад
фононое
в
долинный
ток
2ЗЗ
а
отношение
функций
распределения
11j12
для
упрощенного
случая
па
раболических
зон
с
эффективными
массами
m1
и
m2
дается
формулой
11 = n1 m1
ехр
[_Е_
(1
_ m
1)]
(10.29)
12 n2 m2
на;
m2'
n1
и
n2 -
поверхностные
концентрации
электронов
двух
подзон.
Член
[W(E)]2,
ответственный
за
уширение
в
знаменателе
выражения
для
Те(П),
связан
с
частотой
ljT(E)
рассеяния
с
участием
фононов,
а
также
с
частотами
других
типов
рассеяния,
таких
как рассеяние
электронов
на
плазмонах.
Частота
рассеяния
для
процессов
с
уча
стием
Фононов
обычно
доминирует
над
частотами
других
процессов
рассеяния
[155]
и
является
единственной
рассматриваемой
здесь
часто
той.
Спектры
усиления
при
комнатной
температуре
для
концентрации
1011
см-
2
электронов
во
второй
подзоне
показаны
на
рис.
10.10,10.11.
Из
приведенных
кривых
усиления
видно,
что
эффекты
размерного
ограничения
фононов
играют
роль
в
определении
оптического
усиления
лазеров
на
межподзонных
переходах
с
узкими
ямами.
Это
особен
но
хорошо
видно
из
рис.
10.10,
б,
где
кривые
усиления,
основанные
на
полном
спектре
размерно-ограниченных
фононных
мод
и
только
на
объемных
фононах,
разительно
отличаются
и
даже
имеют
проти
воположные
знаки
в
значительном
диапазоне
энергий
фотонов.
Для
пони
мания
этого
результата
полезно
рассмотреть
устойчивое
состоя
ние,
характеризующееся
сохранением
потока
частиц:
n2 n1
- = W12n2 = - . (10.30)
Т12
Tout
Это
равенство
показывает,
что
отношение
подзонных
населенносгей
в
равновесии
напрямую
зависит
от
соотношения
частоты
межподзон
ных
переходов
и
характерного
времени
утечки
из
нижней
подзоны.
Действительно,
если
время
утечки
увеличивается
по
сравнению
с
ве
личиной,
обеспечивающей
это
условие
равновесия,
то
нельзя
ожидать,
что
будет
поддерживаться
инверсия
населенности,
а
значит
усиление
станет
отрицательным.
Для
параметров,
относящихся
к
рис.
10.10,
б,
имеем:
Т12
=
0,56
пс,
что
объясняет
такую
чувствительность
кривых
усиления
при
Tout
=
0,55
пс
к
энергетическому
спектру
фононных
мод.
§ 3.
Вклад
фОНОНОВ
В
ДОЛИННЫЙ
ток
В
структурах
с
двумя
барьерами
в
работах
[161, 162]
были
проведены
согласованные
экспери
ментальные
и
теоретические
исследования
эффекта
туннелирования
с
участием
фононов
в
структурах
GaAs/
AIAs
с
двумя
барьерами.
В
этих
экспериментах
наблюдались
туннельные
токи
и
спектры
магни
тотуннелирования,
показывающие,
что
основная
часть
долинного
тока
в
некоторых
квантовых
ямах
GaAs/
AIAs
с
двумя
барьерами
возникает
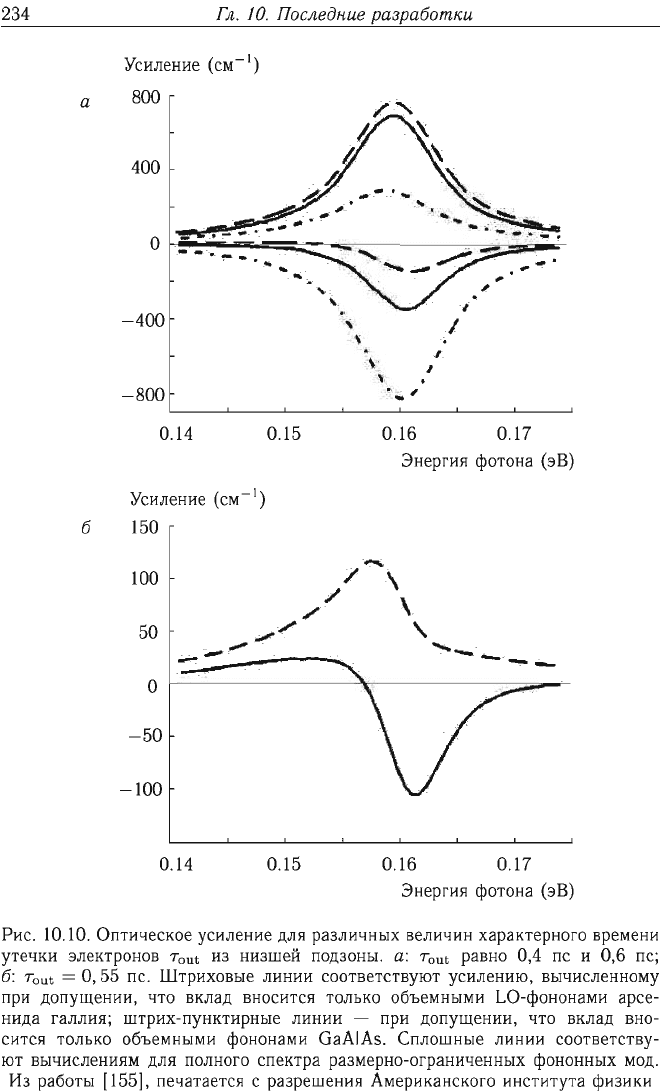
234
а
Гл.
10.
Последние
разработки
Усиление
(см"")
800
400
-400
-800
0.14 0.15 0.16 0.17
Энергия
фотона
(эВ)
Усиление
(CM-
1)
б
150
100
50
О
-50
-100
-
/ \
,/
\
_/
,
......
_.
.
~
........
0.14 0.15 0.16 0.17
Энергия
фотона
(эВ)
Рис.
10.10.
Оптическое
усиление
для
различных
величин
характерного
времени
утечки
электронов
Tout
из
низшей
подзоны.
а:
Tout
равно
0,4
пс
и
0,6
пс;
б:
Tout
=
0,55
пс.
Штриховые
линии
соответствуют
усилению,
вычисленному
при
допущении,
что
вклад
вносится
только
объемными
LО-фононами
арсе
нида
галлия;
штрих-пунктирные
линии
-
при
допущении,
что
вклад
вно
сится
только
объемными
фононами
GaA1As.
Сплошные
линии
соответству
ют
вычислениям
для
полного
спектра
размерно-ограниченных
фононных
мод.
Из
работы
[155],
печатается
с
разрешения
Американского
института
физики
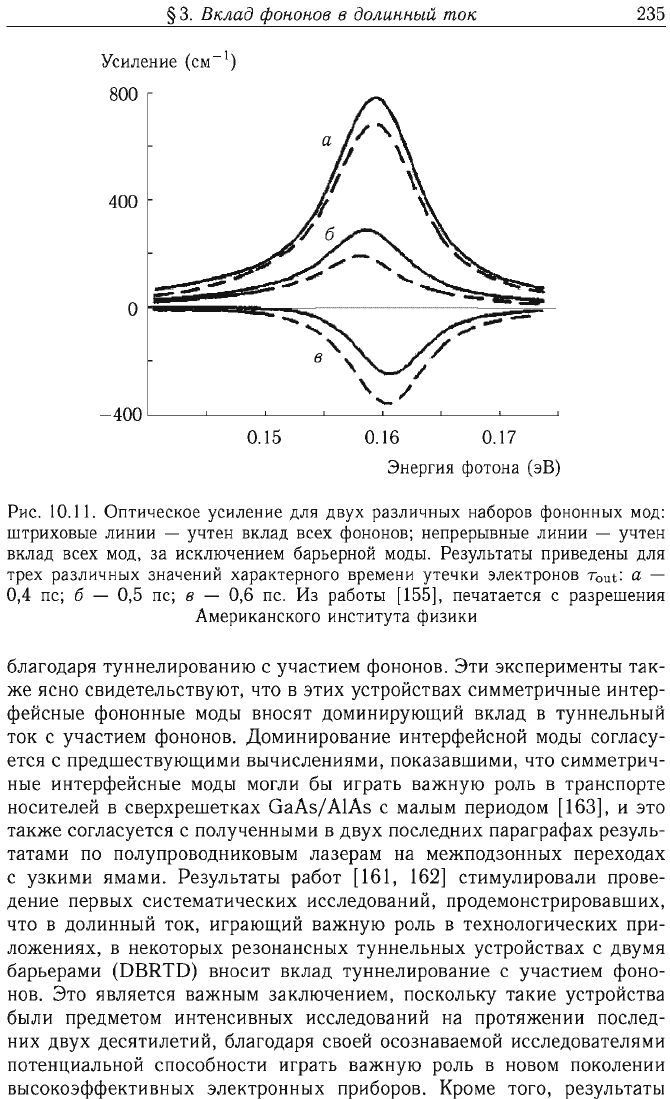
§3.
Вклад
фононое
в
долинный
ток
Усиление
(CM-
1)
800
400
-400
'-----_---'---_-----'--
__
L--_---'----_-----'--
__
L--_-'
235
0.15 0.16 0.17
Энергия
фотона
(эВ)
Рис.
10.11.
Оптическое
усиление
для
двух
различных
наборов
фононных
мод:
штриховые
линии
-
учтен
вклад
всех
фононов;
непрерывные
линии
-
учтен
вклад
всех
мод,
за
исключением
барьерной
моды.
Результаты
приведены
для
трех
различных
значений
характерного
времени
утечки
электронов
Tout:
а
-
0,4
пс;
б
- 0,5
пс;
в
- 0,6
пс.
Из
работы
[155],
печатается
с
разрешения
Американского
института
физики
благодаря
туннелированию
с
участием
фононов.
Эти
эксперименты
так
же
ясно
свидетельствуют,
что
в
этих
устройствах
симметричные
интер
фейсные
фононные
моды
вносят
доминирующий
вклад
в
туннельный
ток
с
участием
фононов.
Доминирование
интерфейсной
моды
согласу
ется
с
предшествующими
вычислениями,
показавшими,
что
симметрич
ные
интерфейсные
моды
могли
бы
играть
важную
роль
в
транспорте
носителей
в
сверхрешетках
GaAs/
A1As
с
малым
периодом
[163],
и
это
также
согласуется
с
полученными
в
двух
последних
параграфах
резуль
татами
по
полупроводниковым
лазерам
на
межподзонных
переходах
с
узкими
ямами.
Результаты
работ
[161, 162]
стимулировали
прове
дение
первых
систематических
исследований,
продемонстрировавших,
что
в
долинный
ток,
играющий
важную
роль
в
технологических
при
ложен
иях,
в
некоторых
резонансных
туннельных
устройствах
с
двумя
барьерами
(DBRTD)
вносит
вклад
туннелирование
с
участием
фоно
нов.
Это
является
важным
заключением,
поскольку
такие
устройства
были
предметом
интенсивных
исследований
на
протяжении
послед
них
двух
десятилетий, благодаря
своей
осознаваемой
исследователями
потенциальной
способности
играть
важную
роль
в
новом
поколении
высокоэффективных
электронных
приборов.
Кроме
того,
результаты

236
Гл.
10.
Последние
разработки
тщательных
и
систематических
исследований
[161, 162]
убедительно
демонстрируют
применимость
модели
диэлектрического
континуума
размерно-ограниченных
фононов.
Вольтамперные
характеристики
при
температуре
4,2
К,
измеренные
в
работе
[162],
показаны
на
рис.
10.12.
В
этом
случае
структура
с
дву
мя
барьерами
представляла
собой
квантовую
яму
GaAs
ширины
80
А
с
барьером-эмиттером
A1As
ширины
33
А
и
барьером-коллектором
A1As
ширины
45
А.
Все
эти
слои
номинально
нелегированные.
На
рис.
10.12
основной
пик
резонансного
туннелирования
расположен
вблизи
0,54
В,
а
отчетливый
пик
туннелирования
с
участием
фононов
заметен
вблизи
0,81
В.
Плотность
тока
(А
см-
2
)
1.00.50.0
-0.5
4
3
2
1
О
-1
- 2
<::.....1.
-'--_--0.-_---'-
'--
--'--
-1.0
Приложенное
напряжение
(В)
Рис.
10.12.
Измеренная
при температуре
4,2
К
вольтамперная
характеристика
структуры
с
двумя
барьерами,
состоящей
из
квантовой
ямы
GaAs
ширины
80
А,
барьера-эмиттера
A1As
ширины
33
А
и
барьера-коллектора
A1As
шири
ны
45
А.
Основной
пик
туннелирования
находится
около
0,54
В,
а
мощный
пик,
вызванный
туннелированием
с
участием
фононов,
проявляется
вблизи
значения
0,81
В.
Из
работы
[162],
печатается
с
разрешения
Американского
физического
общества
Эксперименты
по
влиянию
магнитного
поля,
проведенные
в
ра
ботах
[161, 162],
дали
еще
более
убедительные
результаты.
На
рис.
10.13,
а,
б
изображено
измеренное
магнитное
поле
как
функция
приложенного
напряжения.
Два
«веера
Ландау»
сходятся
на
значе
ниях
0,67
В
и
0,81
В.
Кроме
того,
на
рис.
10.14
присутствуют
две
прямые
вертикальные
линии,
соответствуюшие
значениям
-0,45
В
и
-0,52
В,
к
которым
сходятся
другие
линии.
В
работе
[162]
путем
калибровки
шкалы
напряжения,
полученной
в
эксперименте,
удалось
найти
связь
электронной
энергии
tlE
z
с
прикладываемым
напряжени
ем
V
вида
V = O'.tlE
z
,
где
О'.
= 5,49 ±
о,
15
В/эВ,
и
сделать
заключение,
что
«вееры
Ландау»,
сходящиеся
к
точке
0,67
В
на
рис.
10.13,
а,
б
соответствуют
размерно-ограниченным
LО-фононным
модам
с
энер
гиями
в
диапазоне
36,
О
±
0,9
мэВ.
Аналогично,
«вееры
Ландау»,
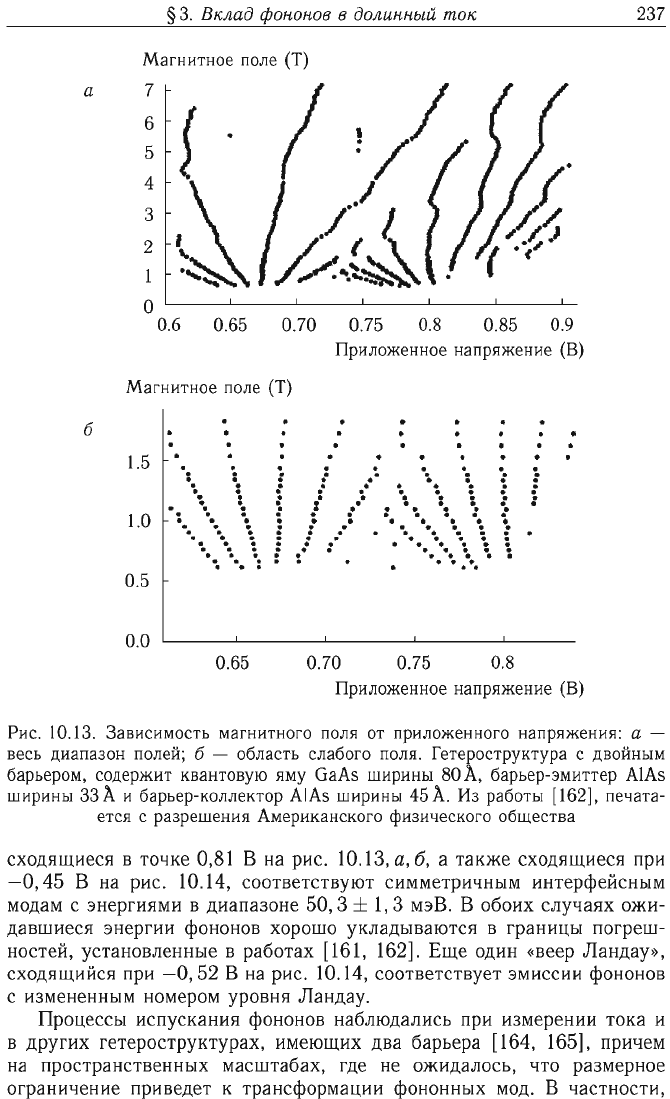
§3.
Вклад
фононое
в
долинный
ток
237
0.75
0.8 0.85 0.9
Приложенное
напряжение
(В)
0.70
0.65
6
5
4
3
2
1
О
0.6
Магнитное
поле
(Т)
7а
Магнитное
поле
(Т)
б
.
.
·
.
·
1.5
·
.
·
. . .
.
·
. .
.
·
f
.
"
.
"
;
~
f
.
·
.
\""
·
.
.
" "
\
·
.
."
'
..
-::,
·
.
.
·
;
.
.
·
. .
1.0
·
. . .
.
\
!
/.
"
. .
·
'
..
..
-,
. . .
.
·
-.\
"
.
.
\
.
. .
. .
·
..
.
·
·
.. .
·
.
.
·
:
.
·
"
.
·
.
·
. ..
·
.
.
·
·
. .
.
·
".
. .
.
0.5
0.0
0.65 0.70 0.75
0.8
Приложенное
напряжение
(В)
Рис.
10.13.
Зависимость
магнитного
поля
от
приложеннога
напряжения:
а
-
весь
диапазон
полей;
б
-
область слабого
поля.
Гетероструктура
с
двойным
барьером,
содержит
квантовую
яму
GaAs
ширины
80
'А,
барьер-эмиттер
A1As
ширины
33
'А
и
барьер-коллектор
A1As
ширины
45
'А.
Из
работы
[162],
печата-
ется
с
разрешения
Американского
физического
общества
сходящиеся
в
точке
0,81
Б
на
рис.
10.13,
а, б,
а
также
сходящиеся
при
-0,45
Б
на
рис.
10.14,
соответствуют
симметричным
интерфейсным
модам
с
энергиями
в
диапазоне
50,3
± 1,3
мэБ.
Б
обоих
случаях
ожи
давшиеся
энергии
фононов
хорошо
укладываются
в
границы
погреш
ностей,
установленные
в
работах
[161, 162].
Еще
один
«веер
Ландау»,
сходящийся
при
-0,52
В
на
рис.
10.14,
соответствует
эмиссии
фононов
с
измененным
номером
уровня
Ландау.
Процессы
испускания
Фононов
наблюдались
при
измерении
тока
и
в
других
гетероструктурах,
имеющих
два
барьера
[164, 165],
причем
на
пространственных
масштабах,
где
не
ожидалось,
что
размерное
ограничение
приведет
к
трансформации
фононных
мод.
Б
частности,

238
Гл.
10.
Последние
разработки
Магнитное
поле
(Т)
7
6
5
4
3
2
1
О
-0.4
11
-0.5 -0.6 -0.7
-0.8
-0.9
Приложенное
напряжение
(В)
Рис.
10.14.
Зависимость
магнитного поля
от
приложенного
напряжения
об
ратного
смещения.
Гетероструктура
с
двойным
барьером,
содержит
квантовую
яму
GaAs
ширины
80
А,
барьер-эмиттер
AIAs
ширины
33
А
и
барьер-коллектор
AIAs
ширины
45
А.
ИЗ
работы
[162],
печатается
с
разрешения
Американского
физического
общества
в
работе
[164]
определен
коэффициент
передачи
по
току
при
темпера
туре
4,2
К
и
его
производная
т:
Ic
а
= I
E
'
da
r = dV
E
.
(10.31)
(10.32)
Здесь,
Ic
-
ток
коллектора,
IE -
ток
эмиттера,
а
VE -
напряжение
смещения,
подаваемое
на
гетероструктуру,
показанную
на
рис.
10.15.
Структура
на
рис.
10.15
состоит
из
эмиттера
GaAs
ширины
1О00А
с
легированием
n-типа
2
х
1017
см-
З,
нелегированного
инжекционного
барьера
АlО.З5GаО.65Аs
ширины
120А,
базы
GaAs
ширины
1520А
с
ле
гированием
2
х
1017
см
:",
нелегированного
анализатора
Alo.25Gao.75As
ширины
165
А
и
коллектора
GaAs
ширины
1000
А
с
легированием
2
х
1017
см-
З.
На
рис.
10.16
представлены
экспериментальные
и
тео
ретические
значения
коэффициента
передачи
и
его
производной
как
функций
V
E
.
Доминирующими
являются
пики
V
1
И
112,
а
небольшие
пики
V
P 1
и
V
P 2
связаны
с
испусканием
фононов.
Эти
пики,
как
и
ожида
лось,
разделены
энергией
LО-фононов,
составляющей
в
GaAs
36
мэВ.
В
других
экспериментах
работы
[165]
было
определено
распреде
ление
горячих
электронов
р(Е)
в
режиме,
когда
важными
являют
ся
процессы
эмиссии
как
фононов,
так
и
плазмонов.
Гетерострукту
ра,
использованная
в
этих
экспериментах,
состояла
из
слоя-эмиттера
GaAs,
инжекционного
барьера
AlGaAs,
базы
GaAs
ширины
1500А

§3.
Вклад
фононое
в
долинный
ток
239
Е
1
с
-
-----
E~
-----
E~
-----
E~
-----Е;
~_р(Е)
VE
Е в
с
Рис.
10.15.
Зонная
структура
при
бора,
исследованная
в
работе
[164]
при
сме
щении
VE.
Распределение
энергии
тока,
так
называемое
распределение
горячих
электронов
р(Е),
показано
в
области
барьера
В.
1Е
-
ток,
вытекающий
из
эмиттера
Е, 1с
-
ток
коллектора
С.
Состояния
E~
(n =
1,2,3,4)
-
резо
нансные
состояния,
созданные
в
барьере.
Ер
-
энергия
Ферми,
Ер
-
энергия
излученного
фонона.
ГИ
и
Г
L -
полуширины
«верхней»
И
«нижней»
части
распределения
энергии
после
эмиссии
фононов.
Из
работы
[164],
печатается
с
разрешения
Американского
физического
общества
с
легированием
2
х
1017
см
:",
двухбарьерного
фильтра
с
полосой
пропускания
280
мэБ,
и
коллектора
GaAs.
Эта
структура,
а
также
теоретическое
и
экспериментальное
распределение
энергии
электронов
р(Е)
показаны
на
рис.
10.17.
Начальное
распределение
инжектирован
ных
электронов
принимается
гауссовым
с
шириной
22
мэБ.
Энергия
инжекции
принимается
в
виде
elVel.
Экспериментальная
зависимость
коэффициента
передачи
фото
тока
ар
от
напряжения
эмиттера
V
e
для
гетероструктуры,
изображенной
на
рисунке
10.17,
показана
на
рис.
10.18
в
виде
сплошной
линии.
Теоретические
вклады
эмиссии
плазмонов,
эмиссии
фононов
и
эмиссии
как
фононов,
так
и
плазмонов
обозначены
треугольниками,
крести
ками
и
кружками
соответственно.
Различие
между
теоретическими
и
экспериментальными
вкладами
при
высоком
напряжении
"V;;
объясня
ется
нелинейным
соотношением
между
инжектируемой
энергией
и
"V;;.
По
результатам
этих
экспериментальных
и
теоретических
исследо
ваний
в
работе
[165]
был
сделан
вывод, что
эмиссия
фононов
доми
нирует,
когда
плотность
легирования
базы
менее
3,3
х
1017
см
:".
При
более
высоких
плотностях
легирования
эмиссия
плазмонов
становится
более
существенной.
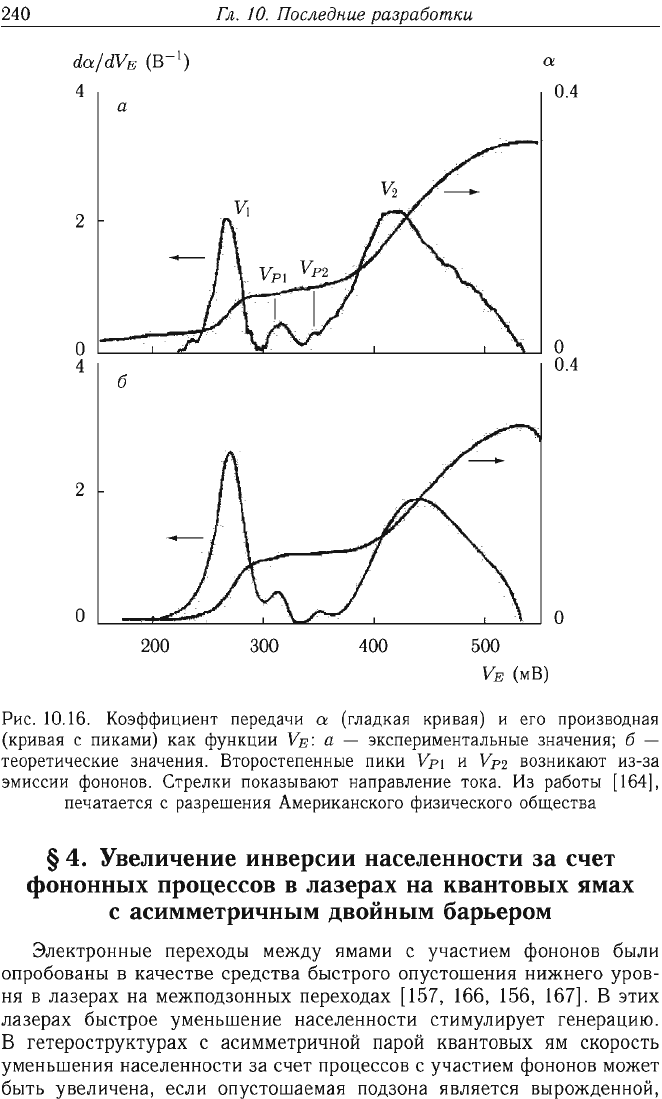
240
а
Гл.
10.
Последние
разработки
а
0.4
2
о
4
2
о
б
о
0.4
о
200
300
400
500
VE
(мВ)
Рис.
10.16.
Коэффициент
передачи
а
(гладкая
кривая)
и его
производная
(кривая
с
пиками)
как
функции
VE:
а
-
экспериментальные
значения;
б
-
теоретические
значения.
Второстепенные
пики
VPl
и
V
P2
возникают
из-за
эмиссии
фононов.
Стрелки
показывают
направление
тока.
Из
работы
[164],
печатается
с
разрешения
Американского
физического
общества
§ 4.
Увеличение
инверсии
населенности
за
счет
фононных
процессов
в
лазерах
на
квантовых
ямах
с
асимметричным
двойным
барьером
Электронные
переходы
между
ямами
с
участием
фононов
были
опробованы
в
качестве средства
быстрого
опустошения
нижнего
уров
ня
в
лазерах
на
межподзонных
переходах
[157, 166, 156, 167].
В
этих
лазерах
быстрое
уменьшение
населенности
стимулирует
генерацию.
В
гетероструктурах
с
асимметричной
парой
квантовых
ям
скорость
уменьшения
населенности
за
счет
процессов
с
участием
фононов
может
быть
увеличена,
если
опустошаемая
подзона
является
вырожденной,
