Ghodssi R., Lin P., MEMS Materials and Processes Handbook
Подождите немного. Документ загружается.

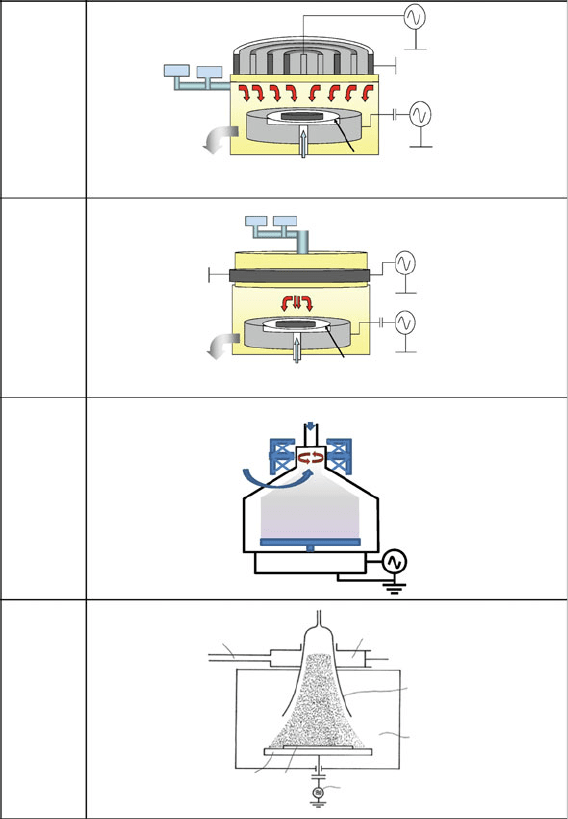
414 S. Tadigadapa and F. Lärmer
and therefore these machines are not particularly useful for high-definition pattern
transfer applications.
High Density Plasma Sources: Inductively coupled plasma sources (ICP) or
transformer coupled plasma sources (TCP) (see Fig. 7.5) have emerged as the most
effective source technology for plasma etching and are now more or less the industry
standard.
Inductively Coupled Plasma: This is generated by the inductor coil which
together with a capacitor forms part of a more complex resonant LC-network
Rf Matching Network
Plasma
2.4 GHz
Magnets
ECR Resonance
Rf Bias
Substrate
2.45 GHz
13.56 MHz
RF-bias
Quartz-
Surfatron
Process
Chamber
Waveguide/Terminator
Circulator
Substrate-Electrode
and Wafer
Transformer
Coupled Plasma
Microwave
Surfatron Source
ECR Plasma
Source
Inductively
Coupled Plasma
Gas1
Gas2
Gas1
Gas2
U
RF1
U
RF2
U
RF1
U
RF2
Platen
Reaction Gases
Pumping
Helium
Backside
Cooling
Electrostatic
Chuck
Gas Inlet
Wafer
Platen
Reaction Gases
Pumping
Helium
Backside
Cooling
Electrostatic
Chuck
Gas Inlet
Wafer
Inductive Coil
Ceramic Vessel
Fig. 7.5 Schematic illustration of popular high-density plasma sources
7 Dry Etching for Micromachining Applications 415
(“matching unit”). The coil-and-capacitor arrangement is driven in resonance by
radio frequency (RF) power. In most cases, RF frequency of 13.56 MHz is used
for driving the ICP, but also 2 MHz and lower frequencies can be found in some
cases. In the ICP-configuration, the coil of one or several turns, depending on the
chosen frequency, is wound around a dielectric vessel. In the TCP arrangement, a
flat or dome-shaped coil covers a dielectric window, which may again be flat or
dome-shaped, on top of the etching chamber.
By feeding radio frequency power to the coil, a high-frequency oscillating mag-
netic field is generated inside the chamber, in the vicinity of the coil, with a
corresponding oscillating electric field resulting from Maxwell’s induction law.
The electric field can excite and drive a high-density plasma within the process
chamber. The plasma cannot shield itself effectively from this inner driving elec-
tric field by sheath formation, thus extremely high densities of charged particles
(electrons and ions ∼10
18
− 10
20
m
−3
) can be obtained by the inductive coupling
technology. Electrons are heated by the RF electric field and generate the ions and
chemically active species by collisions with gas molecules. However, before the
plasma of charged and neutral species reaches the substrate, the hot electrons need
to cool down and as a rule, the distributions of ions and neutrals requires some
kind of readjustment and rearrangement, for the homogenization of etching results.
Mechanical apertures [32], gas flow guides and gas flow redirectors, in combination
with balanced excitation of the inductive coil [33] and magnetic lenses for plasma
collimation [34], are found in this place.
Electron Cyclotron Resonance: This equipment is based on the fact that electro-
magnetic power can be propagated into the plasma more efficiently in the presence
of a magnetic field. Typically a cyclotron resonance condition can be established
when the frequency at which the electrons orbit around the magnetic field lines is
equal to the frequency of the applied electric field. In most cases, microwave fre-
quencies of 2.45 GHz or higher are used in ECR-equipment. Note that there is some
confusion with the use of the term “ECR” also for magnetically enhanced RIE con-
figurations (so-called MERIE or HRE), where plasma densities in a diode or triode
reactor configuration are enhanced to some degree by the interaction with stationary
or slowly varying magnetic fields.
In the ECR microwave system, the pressure should be low enough so that the
electrons can undergo several orbits without colliding with gas molecules (usu-
ally less than 0.132 Pa). One of the concerns with use of ECR-sources for RIE
applications is the nonvertical incidence of electrons and ions on the sample which
causes some isotropic behavior in the etch profile unless additional RF biasing is
applied to the substrate electrode for a more directional acceleration of the ions
to the wafer. The major drawback of ECR sources is the low operating pressure
window (0.0132–0.132 Pa) which limits the density of chemically active species in
the plasma and in many cases the achievable etching rates f or lack of reactants. At
higher pressure, electron cyclotron resonance disappears and microwave excitation
changes to an inefficient thermal heating of the plasma. On the other hand, in the
ECR mode, the degree of ionization and ion flux to the wafer are higher than with
other high-density plasma sources discussed, which makes the ECR an ideal source
for strongly ion driven reactions.
416 S. Tadigadapa and F. Lärmer
Microwave Excitation: Microwaves can be used to establish glow discharges
such as in ECR (see above) or surfatron sources as shown in Fig. 7.5 [35, 36].
A microwave surfatron consists of a dielectric tube or horn (in most cases made from
fused silica or ceramics material) which guides the microwave field coupled into it
along the border between its dielectric surface and the generated plasma. Microwave
surfatron plasma excitation yields plasma properties (densities of reactive species,
electrons, and ions) quite close to those from ICP sources and offers a similar pro-
cess window with regard to the operating pressure and gas flow ranges. The major
benefits of using microwave excitation is that available microwave power levels
are virtually unlimited: magnetron tubes even for the very high power are com-
paratively low cost and extremely robust, and microwave configurations including
magnetron, circulator, and water-load are highly resistant to damage, for example,
from high reflected power situations that occur from time to time due to tempo-
rary mismatch conditions from quickly varying plasma impedances. This makes
microwave excitation an economic solution for the very high power levels needed
in some applications.
Table 7.2 lists a brief comparison between the various plasma sources with
respect to their plasma characteristics.
Substrate Cooling and Clamping: For improved heat dissipation off the wafer,
helium backside cooling is applied in most high-density plasma etching systems.
Heat is generated on the wafer surface due to (i) exothermic etching reactions,
(ii) flow of energetic ions to the wafer surface, and (iii) absorption of radiation power
from the plasma by the wafer. Insufficient heat removal would increase the wafer
temperature to values intolerable from a process standpoint (e.g., degrading the pho-
toresist mask or sidewall passivation films). To prevent overheating, gaseous helium
is used as a convective medium supplied at elevated pressure (1–2 kPa) between the
wafer backside and the substrate electrode top surface. To enable backside pressur-
izing, the wafer needs to be tightly clamped to the substrate electrode. Clamping
is often achieved through mechanical clamps in the f orm of springs or clamp-rings
pressing onto the wafer perimeter, or by electrostatic forces exerted from an elec-
trostatic chuck. Today electrostatic clamping is the most common way of fixing
the wafer to the substrate electrode, because the clamping force is homogeneously
distributed all over the wafer thus reducing the risk for wafer breakage, and edge
exclusion zones caused by plasma disturbances from the mechanical clamps can be
significantly reduced thus increasing usable wafer area and chip yield in production.
Many constructions of electrostatic chucks do exist. What is common to all of
them is an arrangement of conducting segments put on top of an insulating disk and
covered by an isolating layer. A high DC voltage of the order of kV is supplied to the
conducting segments, either in a unipolar arrangement or in a bipolar arrangement
(with respect to ground level).
In the unipolar arrangement, all conducting segments of the chuck are connected
to the same voltage level, and electrostatic forces build up between the wafer and
the E-chuck surface as soon as the high-density plasma is ignited. The conductivity
of the plasma establishes a defined wafer potential, depending on RF biasing power.
The difference in potentials between wafer and chuck segment electrodes is the

7 Dry Etching for Micromachining Applications 417
Table 7.2 Comparison of different plasma source types with regard to key performance parameters
a
Plasma source Excitation//bias frequencies Operating pressure range (Pa) Chemical activity Ionization level (m
−3
) Independent ion energy control
Barrel RF 10−1000 Low – –
Diode RF 1−100 Mid 10
14
−10
16
No
Triode RF//RF, LF 1−100 Mid 10
14
−10
16
Mid
Downstream etcher RF, μWave 10−1000 High – –
Microwave ECR μWave//RF, LF 0.01−0.1 Low 10
19
−10
21
High
Microwave surfatron μWave//RF, LF 0.1−100 (→ atm.) High 10
18
−10
20
High
ICP/TCP RF//RF, LF 0.1−100 (→ atm.) High 10
18
−10
20
High
a
RF = radio frequency 27.12, 13.56, or 2 MHz; LF = low frequency 100–450 kHz; μWave = microwave frequencies 7.35, 4.9, or 2.45 GHz

418 S. Tadigadapa and F. Lärmer
source of the electrostatic clamping forces. When the plasma (and the clamping
voltage) is (are) switched off, the wafer is released and can be easily removed from
the substrate electrode.
In the bipolar arrangement, the voltage polarity of the segments on the E-chuck is
alternating from one area to the other, for example, between +1 kV and –1 kV sym-
metrically. Irrespective of plasma conditions, electrostatic forces build up between
the wafer (at virtual ground potential with respect to the clamping voltages) and
the top surface of the E-Chuck. For declamping, in general a depolarizing voltage
cycling is needed before completely switching off the clamping voltage and removal
of the wafer from the electrode to overcome the holding forces of residual charges
accumulated in the chuck dielectrics.
7.3 Plasma Process Parameters and Control
In general, plasma etching processes can be considered as comprising three basic
unit steps namely:
(i) Adsorption and chemisorption of the reactant atoms on the surface of the
substrate
(ii) Reaction and formation of a volatile reaction product having a high vapor
pressure
(iii) Desorption and diffusion of the product molecules away from the substrate.
In general plasma etching processes use gases containing halogens (halogens
are group VII elements, namely, fluorine, chlorine, bromine, iodine) because these
elements are known to be highly electronegative and reactive. Upon reacting with
the materials of interest, halogens form compounds that are known as halides. The
volatility or inertness of the resulting halide is particularly significant. For the third
step to be most effective, products with high vapor pressure are desired. Table 7.3
lists the boiling temperature of silane and various silicon halides. It is clear that in
comparison with other halides, silicon tetrafluoride is highly volatile and likely to
most easily desorb off the surface.
Table 7.3 Boiling temperature of various silicon halides and silane
a
Boiling temperature (
◦
C)
SiH
4
−111.8
SiF
4
−86
SiCl
4
57.6
SiBr
4
154
SiI
4
287.5
a
The volatility of these molecules is an important reason for the reactive
etching of silicon and silicon compounds [37].
Used with permission, copyright 2000, Springer

7 Dry Etching for Micromachining Applications 419
Each of these steps plays an important role in the determination of the eventual
etch rate of a given material and the rate limiting process among these limits the
overall process. For example, the etching mechanism of silicon using fluorine (a
halogen) can be schematically depicted as shown in Fig. 7.6. In this reaction the
formation of fluorinated skin upon exposure to fluorine neutrals is an important first
step. Fluorine is readily adsorbed into the first few monolayers of silicon typically
forming fluorosilyl layer composed of SiF
x
(x = 1−3) whereas chlorine owing to its
larger atomic size tends to be adsorbed mainly on the surface. The ion-bombardment
step slightly enhances the final step of the reaction, the formation of volatile SiF
4
which then desorbs from the surface of the substrate. This combination of adsorption
of fluorine into several monolayers of silicon as well as the greater volatility of SiF
4
in comparison to SiCl
4
results in a higher yield per striking ion and therefore a
higher etch rate of silicon in fluorine plasmas. In fact etching of silicon in fluorine
plasma proceeds fast even without ion assistance.
SiF
X
SiF
4
Si
Si
Si
F
F
F
F
F
F
F
F -Plasma
Si
SiF
2
Fig. 7.6 Schematic
illustration of the mechanism
of plasma etching of silicon
in fluorine chemistry. Few
monolayers thick fluorinated
skin is formed on the silicon
surface which upon further
attack by fluorine radicals
liberates the surface silicon as
SiF
2
(minor process) while
the remaining surface silicon
atoms proceed through
various SiF
x
steps until
eventually liberated as SiF
4
(dominant process) [3]
7.3.1 Energy-Driven Anisotropy
In the 1970s pioneering experiments were performed by Coburn and Winters t hat
have elucidated the role of ion bombardment on the etch rate [38]. These exper-
iments on silicon etching used XeF
2
as the etch gas with Ar
+
as the bombarding
ions. The choice of Ar
+
as the ion was to preclude any role in chemical reactions
with silicon whereas XeF
2
was chosen to readily provide the atomic fluorine atoms.
Figure 7.7a shows the result of the experiment and its relevance to energy-driven
anisotropy in etching. In the i nitial part of the experiment, the silicon wafer was
exposed to XeF
2
gas only and the etch rate obtained was small. This phase essen-
tially reflects pure chemical component of the etching. At the end of this period, the
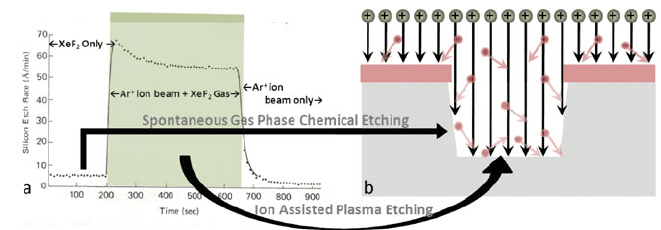
420 S. Tadigadapa and F. Lärmer
Fig. 7.7 (a) Silicon etch rate in three different condition [38] (Used with permission, copyright
1979, the American Institute of Physics). From the experimental results it can be clearly seen that
the etch rate upon Ar
+
ion bombardment of the fluorinated silicon surface results in an etch rate that
is much larger than the sum of spontaneous chemical etching in XeF
2
gas or in pure Ar
+
plasma.
This difference in the etch rates can be used to achieve anisotropic e tching as shown schematically
in (b). The solid arrows are used to show that the etching on the sidewalls mimics spontaneous
chemical etching due to the lack of ion bombardment on these surfaces whereas the bottom of the
etched feature is rapidly etched due to the ion-assisted plasma process
Ar
+
ion flux is turned on and the etch rate i s observed to immediately rise i n this
ion-assisted etching phase. At the end of this period, the XeF
2
gas supply is turned
off. In the absence of atomic fluorine supply, the etch process becomes a pure phys-
ical sputtering process accomplished by the bombarding Ar
+
ions. It is clear that the
etch rate during the reactive ion etching phase is much larger than the sum of pure
physical and chemical etch rates. It is this observation that imparts anisotropy in the
plasma etching processes. Because the sidewalls of etched features are not subjected
to ion bombardment as opposed to the bottom of the etch features, t he etch rates of
the bottom of the wafer are significantly higher than on the sidewalls. In other words,
the etch rate downwards is determined by ion-assisted chemistry whereas the side-
wall etching proceeds via spontaneous reactions at much slower rates resulting in
the desired anisotropy. Figure 7.7b illustrates the origin of this anisotropy schemat-
ically. Note that fluorine radicals from plasma behave differently than XeF
2
, in that
XeF
2
needs some activation energy to etch silicon whereas fluorine radicals do not
need any such activation energy beyond the thermal energy levels.
7.3.2 Inhibitor-Driven Anisotropy
In inhibitor-driven anisotropic etches; preferential etching of the bottom of the fea-
tures as opposed to the sidewalls is achieved by the formation of a protective layer
on these facets during the etching process. Bombardment of the energetic ions either
prevents the formation of the passivation layer or continuously removes it so as to
facilitate the preferential reactive (chemical) etching of the substrate. For exam-
ple, during silicon etching, introduction of hydrogen in any of the fluorocarbon
etch gases (e.g., CF
4
,C
2
F
6
,CHF
3
, etc.) reduces the amount of free fluorine by
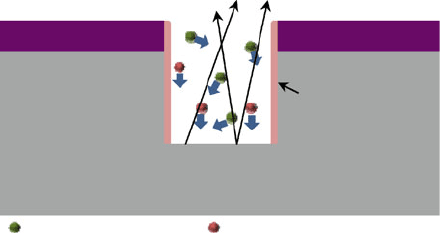
7 Dry Etching for Micromachining Applications 421
readily combining to form HF. This results in the deposition of a polymer layer
(polymerization) on all the surfaces of the substrate.
However, inasmuch as the sidewalls of the etched features are not significantly
bombarded by the energetic ions, the formation of fluorocarbon polymer layer pro-
tects the underlying silicon substrate whereas the polymer layer is continuously
cleared by the energetic ion bombardment at the bottom thereby exposing the
substrate silicon to the fluorine gas. This technique can be used to create highly
anisotropic etches with aspect ratios in the range of up to 50:1. However, care must
be taken so as not to compromise the critical dimension of the etched feature due
to the deposition of excessive amounts of polymer layer on the sidewalls. The same
concept can be extended by etching the substrates at extremely low temperatures.
For example, etching silicon substrates at cryogenic temperatures of <–100
◦
Cusing
fluorocarbon gases, results in the formation of nonvolatile residues on the sidewalls
whereas the etching of the bottom surface is driven by the continuous bombardment
of the energetic ions. This method has the advantage of avoiding the formation of
the passivating polymers on the sidewalls which can be very difficult to remove.
However, at the cryogenic temperatures the etch process is very sensitive to any
contaminants in the chamber and to the existence of native oxide layers because, at
these low temperatures, the breakdown of these materials is very difficult. Figure 7.8
schematically illustrates the inhibitor-driven anisotropic etching process.
+
+
+
Volatile Reaction Product
Fluorocarbon
Protective Sheath
+
Neutral Radicals
Ions
Fig. 7.8 Schematic illustration of inhibitor-driven anisotropy. Preferential buildup of protective
fluorocarbon protective sheath due to the lack of ion bombardment results in enhanced etching of
the bottom of the feature
7.3.3 Selectivity in Plasma Etching
In addition to etch rate and anisotropy, selectivity is a major consideration in trans-
ferring patterns into the substrate via etching processes. A large selectivity between
the masking material and the etched material is desirable. This enables the achieve-
ment of high-fidelity pattern transfer which typically involves a certain amount of
overetching to compensate for the nonuniformity in the etch process across a wafer.
422 S. Tadigadapa and F. Lärmer
In general, selectivity can be achieved due to differences in any of the three steps
involved in plasma etching. Specifically, high selectivity can be achieved when:
(i) One of the materials in given plasma is highly inert. For example, removal of
photoresist from SiO
2
surface using oxygen plasma is a very high selectivity
process. This is because oxygen atoms adsorb minimally onto the oxidized sur-
face and no reactive processes between the SiO
2
film and the oxygen plasma
occur. On the other hand, oxygen plasma volatizes the photoresist via the
formation of various carbon–hydrogen–oxygen reaction products which are
pumped away resulting in a very high selectivity for the photoresist ashing
process.
(ii) High selectivity can also be achieved due to the formation of nonvolatile prod-
ucts in the plasma. This situation is best illustrated when fluorine plasma
is used for the removal of silicon dioxide mask layer on III-V compound
semiconductors such as GaAs. Atomic fluorine upon reaction with group III
elements such as Al, Ga, or In forms involatile AlF
3
,GaF
3
, and InF
3
which
have boiling points of ∼1290, 1000, and >1200
◦
C, respectively, whereas sil-
icon dioxide can be readily etched in fluorine plasma via the formation of
volatile SiF
4
.
(iii) High selectivity can also be achieved if the etch rate of one of the materials
in question, in the same plasma, can be comparatively retarded. For example,
in fluorocarbon-based plasma etching of silicon and silicon dioxide it is well
known that the net etch rate achieved for each material is the result of the
competing processes of: (i) fluorine-based reactive etching and (ii) inert film
formation due to the polymerization of fluorocarbon. By the appropriate addi-
tion of hydrogen into such plasma, the process can be adjusted such that for
SiO
2
surface, the fluorine-based etch process slightly dominates the passiva-
tion film formation. However, for the same plasma conditions, the process is
likely to be skewed towards the formation of the polymer film on silicon sur-
faces due to the unavailability of the surface O
2
and a difference in the sticking
coefficient between the two material surfaces for the plasma gas species. These
differences are typically exploited to realize selective etching of SiO
2
against
silicon. However, the selectivity obtained in this case is not very high and very
careful control of the etch process has to be maintained to achieve a repeatable
etch selectivity.
7.4 Case Study: Etching Silicon, Silicon Dioxide,
and Silicon Nitride
Etching Silicon and Its Compounds Using Halogen Chemistry: Silicon can be etched
in any halogen containing gases such as F
2
,CF
4
,C
2
F
6
,C
4
F
8
,SF
6
,CHF
3
,NF
3
,
Cl
2
, CCl
4
, BCl
3
,Br
2
, CBr
4
, and the like. As explained above, fluorine radicals
spontaneously etch silicon by the formation of volatile SiF
4
product. Although
7 Dry Etching for Micromachining Applications 423
chlorine molecules dissociatively chemisorb on silicon at room temperature, they
have to surmount an energy barrier of ∼10 eV to attack the backbonds of the atoms
on the silicon surface to form SiCl
4
. No such energy barrier is observed for the for-
mation of SiF
x
and thus the reaction proceeds spontaneously at room temperature.
Thus, bombardment of the etched surface with energetic ions is necessary to initiate
the SiCl
4
and SiBr
4
formation reaction whereas ion bombardment in the case of
fluorine gases slightly enhances the reaction.
Furthermore, radicals produced in the plasma from the halogens of lower reac-
tivity, such as chlorine and bromine, react with silicon producing less volatile
reaction products which stick to the surface. Thus, ion impact both activates and
induces the formation of silicon chlorides or bromides from silicon depending
upon the adsorbed halogen radicals, and simultaneously removes the nonvolatile
(inhibitor) films of the reaction products. In particular, silicon bromides are of very
low volatility and need energetic ion bombardment to assist their clearing from the
silicon surface. The sidewalls of etched features typically see a very small flux of
ion bombardment, thus etching in chlorine and bromine chemistries results in an
energy-driven anisotropic etch. Fluorine etches tend to have a greater isotropic etch
tendency and result in minimal surface damage.
The etch rate of silicon and its compounds in fluorocarbon-based plasma can be
increased by the addition of O
2
which scavenges carbon away, preventing the poly-
merization of the unsaturated fluorocarbon species. The same effect can be achieved
by the addition of chlorine gas to CF
4
and CCl
4
because chlorine acts as an effective
oxidizer. However, addition of oxidizers reduces the selectivity to photoresist masks
because carbon polymers are also aggressively etched through the same chemistry.
Anisotropy in Halogen Chemistry: Anisotropy in fluorine etches is usually
inhibitor driven. Addition of hydrogen containing gases in fluorocarbon chemistry,
leads to the depletion of fluorine radicals and therefore a reduction in the F/C ratio.
An F/C ratio in the 2–3 range is required for effective inhibitor driven anisotropic
etch process development [39]. Passivation of sidewalls can be enhanced via oxida-
tion or nitridation of unbombarded silicon surfaces by addition of small amounts of
oxygen or nitrogen gas to the plasma. Sidewall protection may also be improved by
deposition of chlorocarbon or bromocarbon films, by the addition to t he plasma of
chlorocarbon or bromocarbon gases which readily polymerize upon plasma activa-
tion. Ion bombardment breaks up the passivation or protective films formed on such
surfaces, that is, the structure bottom, leading to a directional and vertical etching.
High Selectivity SiO
2
Etching in Fluorocarbon Plasma: Addition of hydrogen
leads to the preferential formation of the CF
x
film on silicon surfaces rather than
on silicon dioxide surfaces. This is because the continuous bombardment upon a
SiO
2
surface causes the fluorocarbon film to volatilize via reaction with the surface
oxygen in the SiO
2
layer in the form of CO, COF
2
, and CO
2
products. This results
in the selective formation of a protective polymer film on silicon surfaces and leads
to preferential etching of SiO
2
[40–42]. Photoemission peak studies on CF
4
/40%
H
2
plasma-treated silicon surface shows a clear Si-C “bridging” bond peak at
284 eV [43] which is critical to the formation of the fluorocarbon film on the silicon
surface.
