Bhushan B. Handbook of Micro/Nano Tribology, Second Edition
Подождите немного. Документ загружается.


© 1999 by CRC Press LLC
building near 100 Hz. This requires a spring with extremely low vertical spring constant (typically, 0.05 to
1 N/m) as well as low mass (on the order of 1 ng). Today, the most-advanced AFM cantilevers are
microfabricated from silicon, silicon dioxide, or silicon nitride using photolithographic techniques. (For
further details on cantilevers, see Section 1.3.2.6.) Typical lateral dimensions are on the order of 100 µm
with the thicknesses on the order of 1 µm. The force on the tip due to its interaction with the sample is
sensed by detecting the deflection of the compliant lever with a known spring constant. This lever
deflection (displacement smaller than 0.1 nm) has been measured by detecting tunneling current similar
to that used in STM in the pioneering work of Binnig et al. (1986a) and later used by Giessibl et al.
(1991), by capacitance-detection (Neubauer et al., 1990; Goddenhenrich et al., 1990), and by four optical
techniques, namely, (1) by optical interferometry (Mate et al., 1987; McClelland et al., 1987; Erlandsson
et al., 1988a; Mate, 1992; Jarvis et al., 1993) and with the use of optical fibers (Ruger et al., 1989; Albrecht
et al., 1992); (2) by optical polarization detection (Schonenberger and Alvarado, 1990); (3) by laser diode
feedback (Sarid et al., 1988); and (4) by optical (laser) beam deflection (Meyer and Amer, 1988, 1990a,b;
Marti et al., 1990). More recently, Smith (1994) used a piezoresistive cantilever beam which requires no
external sensor. It makes the SPM design simpler and the STM and AFM functions can be combined
readily. However, the piezoresistive beam needs power on the order of 10 mW and has less sensitivity.
Geometries of the four more commonly used detection systems are shown in Figure 1.12. The tunneling
method originally used by Binnig et al. (1986a) in the first version of AFM uses a second tip to monitor
the deflection of the cantilever with its force-sensing tip. Tunneling is rather sensitive to contaminants
and the interaction between the tunneling tip and the rear side of the cantilever can become comparable
to the interaction between the tip and sample. Tunneling is rarely used and is mentioned earlier for
historical purposes. Giessibl et al. (1991) recently used it for a low-temperature AFM/STM design. In
contrast to tunneling, other deflection sensors are far away from the cantilever at distances of microns
to tens of millimeters. The optical technique is believed to be a more sensitive, reliable, and easily
implemented detection method than others (Sarid and Elings, 1991; Meyer, 1992). The optical beam
deflection method has the largest working distance, is insensitive to distance changes, and is capable of
measuring angular changes (friction forces); therefore, it is most commonly used in commercial SPMs.
Almost all AFMs use piezotranslators to scan the sample, or alternatively, to scan the tip. An electric
field applied across a piezoelectric material causes a change in the crystal structure, with expansion in
some directions and contraction in others. A net change in volume also occurs (Ashcroft and Mermin,
1976). The first STM used a piezotripod for scanning (Binnig et al., 1982). The piezotripod is one way
FIGURE 1.12 Geometries of the four commonly used detection systems for measurement of cantilever deflection.
In each setup, the sample mounted on piezoelectric body is shown on the right, the cantilever in the middle, and
the corresponding deflection sensor on the left. (From Meyer, E. (1992), Surf. Sci., 41, 3–49. With permission.)

© 1999 by CRC Press LLC
to generate three-dimensional movement of a tip attached to its center. However, the tripod needs to be
fairly large (~50 mm) to get a suitable range. Its size and asymmetric shape makes it susceptible to thermal
drift. The tube scanners are widely used in AFMs (Binnig and Smith, 1986). These provide ample scanning
range within a small size.
Control electronics systems for AFMs can use either analog or digital feedback. Digital feedback circuits
might be better suited for ultralow noise operation.
Images from the AFMs need to be processed. An ideal AFM is a noise-free device that images a sample
with perfect tips of known shape and has perfect linear scanning piezo. In reality, scanning devices are
affected by distortions for which corrections must be made. The distortions can be linear and nonlinear.
Linear distortions mainly result from imperfections in the machining of the piezotranslators causing
cross talk between the Z-piezo to the X- and Y-piezos, and vice versa. Nonlinear distortions mainly result
because of the presence of a hysteresis loop in piezoelectric ceramics. These may also result if the scan
frequency approaches the upper frequency limit of the X- and Y-drive amplifiers or the upper frequency
limit of the feedback loop (Z-component). In addition, electronic noise may be present in the system.
The noise is removed by digital filtering in the real space (Park and Quate, 1987) or in the spatial frequency
domain (Fourier space) (Cooley and Turkey, 1965).
Processed data consists of many tens of thousand of points per plane (or data set). The output of the
first STM and AFM images were recorded on an X-Y chart recorder, with Z-value plotted against the tip
position in the fast-scan direction. Chart recorders have slow response so storage oscilloscopes or com-
puters are used for display of the data. The data are displayed as wire mesh display or gray scale display
(with at least 64 shades of gray).
1.3.2.1 Binnig et al.’s Design
In the first AFM design developed by Binnig et al. (1986a), AFM images were obtained by measurement
of the force on a sharp tip created by the proximity to the surface of the sample mounted on a three-
dimensional piezoelectric scanner. The tunneling current between the STM tip and the backside of the
cantilever beam with attached tip was measured to obtain the normal force. This force was kept at a
constant level with a feedback mechanism. The STM tip was also mounted on a piezoelectric element
to maintain the tunneling current at a constant level.
1.3.2.2 McClelland et al.’s Design
An AFM developed by Erlandsson et al. (1988a) for operation in ambient air is shown schematically in
Figure 1.13. Following the STM design, the test sample was mounted on three orthogonal piezoelectric
tubes (2 to 5 mm long), two of which (x, y) raster the sample in the surface plane while the third (z)
moves the sample toward and away from the tip. The lever was made from a 70-µm-diameter, 3-mm-
long tungsten microprobe with a 90° bend near one end that serves as the tip. (In most cases, the tip is
electrochemically etched using a 12-V AC in 2 N (normal) NaOH solution to obtain a nominal tip radius
between 150 to 300 nm.) The main resonant frequency of this lever was about 5 kHz and the force
constant was about 30 N/m. The lever support was mounted on a piezoelectric transducer that makes it
possible to oscillate the lever when needed. The lever motion was measured by optical interference. A
light beam was focused on the backside of the lever by a microscope objective, and the interference
pattern between the reflected beam and a reference beam reflected from an optical flat is projected on a
photodiode that measures the instantaneous deflection of the lever as well as its vibration amplitude at
high frequencies. The deflection can be detected within ±0.2 nm; so for a typical lever force constant of
10 N/m a force as low as 0.2 nN could be detected.
More recently, a high-sensitivity fiber-optic displacement sensor has been developed by the IBM group
which is compact and does not require specular reflection and thus is compatible with both microfab-
ricated thin-film cantilevers as well as fine wire cantilevers. All fiber construction results in smaller size
and improved mechanical robustness (Rugar et al., 1989; Albrecht et al., 1992). Schematic design of the
AFM with a fiber optic interferometer is shown in Figure 1.14. A multimode GaAlAs diode laser with a
direct single-mode fiber output is used as a light source. The light is coupled into the input (labeled “1”)
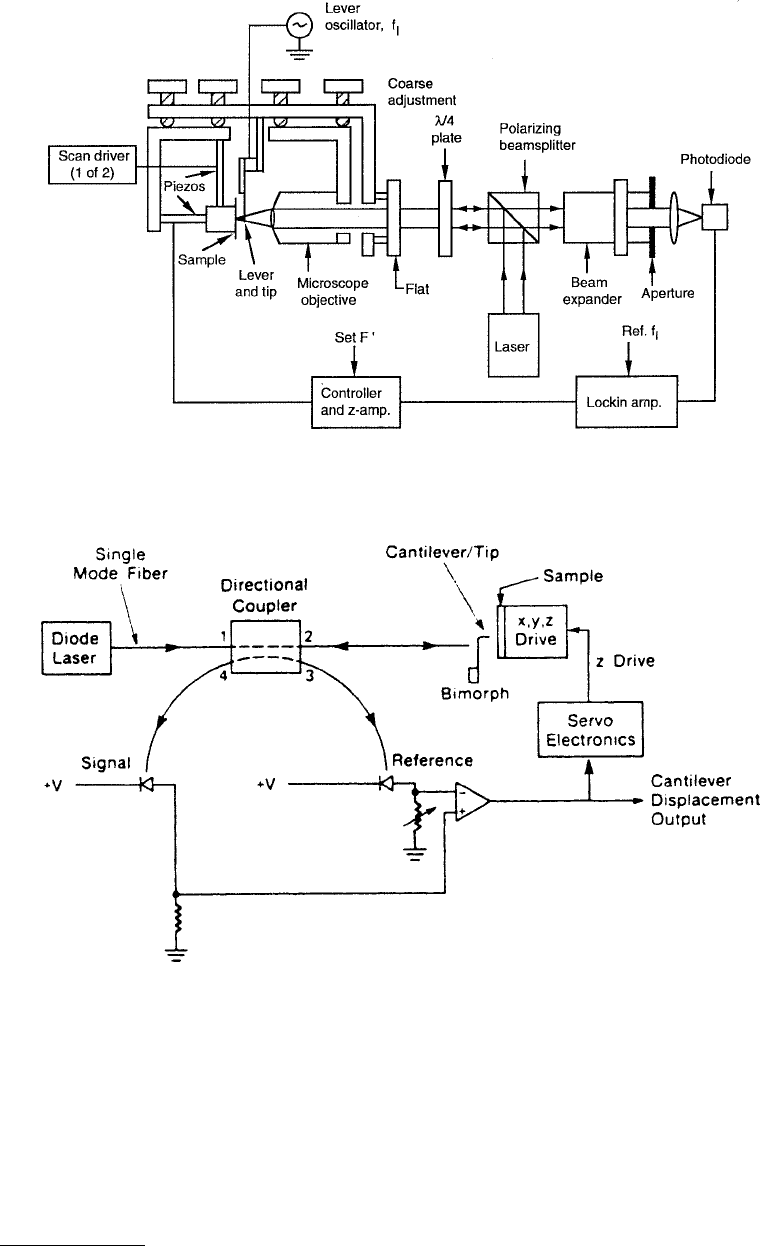
© 1999 by CRC Press LLC
of a 2 × 2 single-mode directional coupler. The coupler splits the incident optical power equally between
leads 2 and 3, which carry the light to the AFM cantilever and the “reference” photodiode, respectively.
Approximately 4% of the light in lead 2 is reflected from the glass–air interface at the cleaved end of the
fiber. This reflected light comprises one of the two interfering beams. The other 96% of the light exits
the fiber and impinges on the cantilever with a spot size of about 5 µm. Part of this light is scattered
back into the fiber and interferes with the light reflected from the fiber end. The total optical power
reflected back through the fiber depends on the phase difference between the fiber end reflection and
FIGURE 1.13 Schematic of an AFM which uses optical interference to detect the lever deflection. (Erlandsson, R.
et al. (1988), J. Vac. Sci. Technol., A6, 266–270. With permission.)
FIGURE 1.14 Schematic of an AFM with a fiber-optic interferometer. (From Rugar, D. et al. (1989), Appl. Phys.
Lett., 55, 2588–2590. With permission.)

© 1999 by CRC Press LLC
the cantilever reflection. The coupler directs half of the total reflected light to lead 4 and into the signal
2 photodiode where the intensity of the optical interference is measured. To reduce reflections from the
ends of leads 3 and 4, the fibers were cleaved at a nonorthogonal angle and an index-matching liquid
was placed between the photodiodes and the fiber ends. The output of the signal photodiode can be used
directly as the AFM signal (Rugar et al., 1989).
AFMs can be used to obtain topographic images using repulsive contact forces as well as attractive
electrostatic forces. Several methods have been used to detect the forces (Binnig et al., 1986a; Erlandsson
et al., 1988a). In one force-detection method, the signal corresponding to the force can either be used
as a control parameter for the feedback circuit to generate contours of equal force or be displayed directly
without feedback while pressing the tip onto the sample with an average force larger than the recorded
force variations. In another method, a small AC voltage is applied to the z-tube to induce an oscillation
in the sample and, through the force coupling, to the lever. The resultant oscillation in the photodiode
signal is converted by the lock-in amplifier to a voltage that is proportional to the derivative of the force,
F′. The z-amplifier compares the voltage to some preset value and drives the z-tube to form a feedback
loop to maintain F′ constant, and a three-dimensional surface of F′ can be obtained (Erlandsson et al.,
1988a).
1.3.2.3 Kaneko et al.’s Design
In the AFM designs developed by Kaneko and co-workers for use in ambient air, the instrument consists
of a piezoelectric tripod that holds the sample, a sharp diamond tip (to be presented later) supported
by a parallel-leaf spring unit mounted on a laminated piezoelectric stack, and a focusing error detection
type optical head, Figure 1.15 (Kaneko et al., 1988; Kaneko and Hamada, 1990; Miyamoto et al., 1990).
This design was later modified by Kaneko et al. (1990, 1991). The major modifications were that a
piezotube scanner was used to hold the sample and the tip was supported on a single-leaf spring,
Figure 1.16. In their even newer design, they have incorporated a new tube scanner and an optical
FIGURE 1.15 Schematic of an AFM in which the sample is mounted on a piezoelectric tripod and the tip is
supported by a parallel-leaf spring unit. (From Kaneko, R. et al. (1988), J. Vac. Sci. Technol., A6, 291–292. With
permission.)
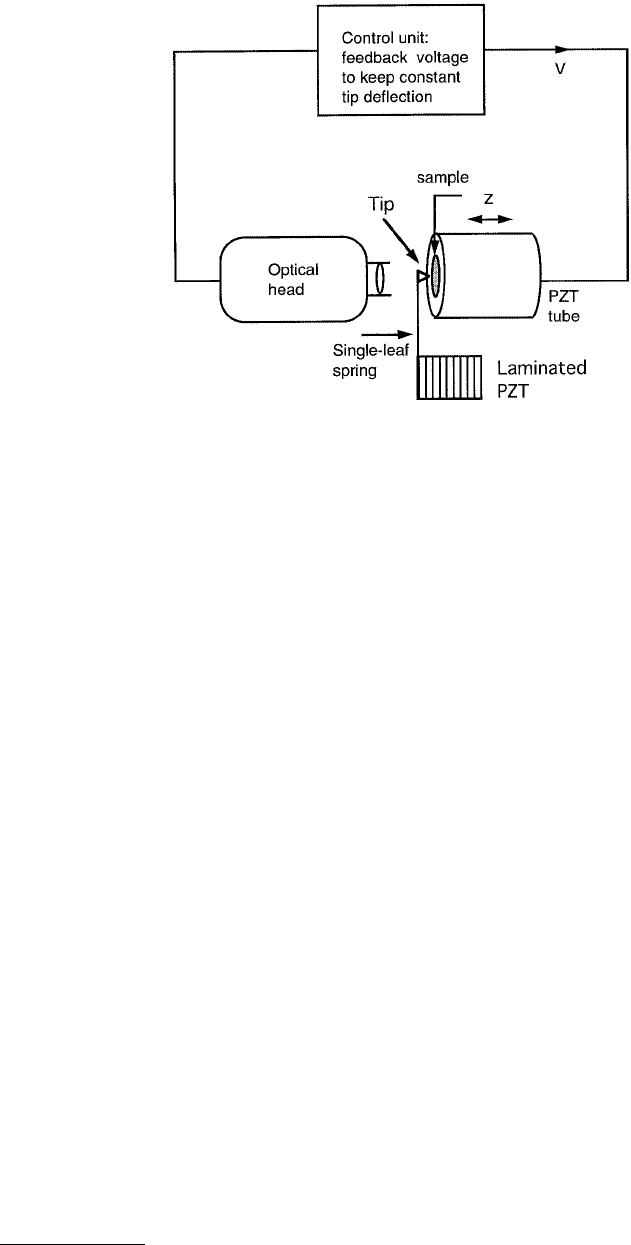
© 1999 by CRC Press LLC
multifunction sensor (Kaneko et al., 1992). The spring constants used in Figures 1.15 and 1.16 are 3 to
24 N/m and 0.3 to 3 N/m, respectively. A laminated piezoelectric stack was used for initial positioning
of the tip and the piezoelectric tripod or piezotube scanner was used to place the tip in contact with the
surface in the z-direction and to scan the surface in the x- or y-direction. For surface topography
measurements, the sample was slowly moved in the z-direction until it contacted the tip then it was
scanned in the x- or y-direction. Tip displacement during scanning was measured by a focusing error-
detection-type optical head (with an accuracy of better than 1 nm), and the displacement signal was
used as a control signal for the z-displacement of the piezoelectric tripold or tube scanner to keep the
spring load constant. Variations in the vertical motion of the sample represented a roughness profile.
Additional details of the construction of these designs can be found in a following FFM section.
1.3.2.4 Meyer and Amer’s Design
In the AFM design developed by Meyer and Amer (1988) for operation in an ultrahigh vacuum (UHV),
bending of a tungsten cantilever beam resulting from the normal force being applied at the tip was
measured by detecting the deflection of a laser beam, which was reflected off its backside. The deflection
was sensed with a segmented photodiode detector, typically a bicell, which consists of two photoactive
(e.g., Si) segments (anodes) that are separated by about 10 µm and have a common cathode. This optical
beam deflection technique is simple and sensitive and is used in a commercial AFM whose description
follows.
1.3.2.5 Commercial AFMs
There are a number of commercial AFMs available on the market since 1989. Major manufacturers of
AFMs for use in an ambient environment are Digital Instruments, Inc., 112 Robin Hill Road, Santa
Barbara, CA; Park Scientific Instruments, 476 Ellis Street, Mountain View, CA; Topometrix, 5403 Betsy
Ross Drive, Santa Clara, CA; Seiko Instruments, Japan; Olympus, Japan; and Centre Suisse D’Electronique
et de Microtechnique (CSEM) S.A., Neuchâtel, Switzerland. In the CSEM design, both force sensors
(using optical beam deflection method) and scanning unit are mounted on the microscope head; thus
their AFM/FFM designs can be used as stand-alone (Hipp et al., 1992). UHV AFM/STMs are manufac-
tured by Omicron Vakuumphysik GmbH, Idsteiner Strasse 78, D-6204, Taunusstein 4, Germany. Personal
FIGURE 1.16 Schematic of an AFM in which the sample is mounted on a piezoelectric tube scanner and the tip
is supported by a single-leaf spring. (From Kaneko, R. et al. (1990), Tribology and Mechanics of Magnetic Storage
Systems (B. Bhushan, ed.) SP-29, pp. 31–34, STLE, Park Ridge, IL. With permission.)

© 1999 by CRC Press LLC
STMs and AFMs for ambient environment and UHV/STMs are manufactured by Burleigh Instruments,
Inc., Burleigh Park, Fishers, NY.
We describe here the commercial AFM for operation in ambient air, produced by Digital Instruments,
Inc., with scanning lengths ranging from about 0.7 µm (for atomic resolution) to about 125 µm (Alex-
ander et al., 1989; Anonymous, 1992b; Bhushan and Ruan, 1994a; Ruan and Bhushan, 1994a,b). This is
the most commonly used design and the multimode AFM comes with many capabilities. The original
design of this AFM version comes from Meyer and Amer (1988). Basically, the AFM scans the sample in
a raster pattern while outputting the cantilever deflection error signal to the control station. The cantilever
deflection (or the force) is measured using a laser deflection technique, Figure 1.17. The digital signal
processor (DSP) in the workstation controls the Z-position of the piezo based on the cantilever deflection
error signal. The AFM operates in both the constant-height and constant-force modes. The DSP always
adjusts the height of the sample under the tip based on the cantilever deflection error signal, but if the
feedback gains are low the piezo remains at a nearly constant height and the cantilever deflection data
is collected. With the gains high, the piezo height changes to keep the cantilever deflection nearly constant
(therefore, the force is constant), and the change in piezo height is collected by the system. The following
description of the instrument is almost exclusively based on Anonymous (1992b).
To further describe the principle of operation of the commercial AFM, the sample is mounted on a
piezoelectric tube scanner which consists of separate electrodes to scan the sample precisely in the X–Y
plane in a raster pattern as shown in Figure 1.18 and to move the sample in the vertical (Z) direction.
A sharp tip at the free end of a microfabricated flexible cantilever is brought in contact with the sample.
Features on the sample surface cause the cantilever to deflect in the vertical direction as the sample moves
FIGURE 1.17 Principle of operation of a commercial AFM/FFM — sample mounted on a piezoelectric tube scanner
is scanned against a sharp tip and the cantilever deflection is measured using a laser deflection technique.

© 1999 by CRC Press LLC
under the tip. A laser beam generated from a diode laser (light-emitting diodes or LEDs with a 5-mW
max peak output at 670 nm) is directed by a prism onto the back of the cantilever near its free end, tilted
downward at about 10° with respect to a horizontal plane. The reflected beam from the vertex of the
cantilever is directed through a mirror onto a quad photodetector (split photodiode detector with four
quadrants commonly called position-sensitive detector or PSD), produced by Silicon Detector Corpora-
tion, 1240 Avenida Acasco, Camarillo, CA. The differential signal from the top and bottom photodiodes
[(T – B)/(T + B)] provides the AFM signal which is a sensitive measure of the cantilever vertical deflection.
In the AFM operating mode, the “height mode,” this AFM signal is used as the feedback signal to control
the vertical position of the piezotube scanner and the sample, such that the cantilever vertical deflection
(hence the normal force at the tip–sample interface) will remain (almost) constant as the sample is
scanned. Thus, the vertical motion of the tube scanner relates directly to the topography of the sample
surface. We note that normal force and vertical motion of the sample can be independently measured
by the photodiode and the piezoelectric scanner, respectively. Topographic measurements are made using
the height mode at any scanning angle. At a first instance, the scanning angle may not appear to be an
important parameter. However, the friction force between the tip and the sample (which we will discuss
later in the FFM section) will affect the topographic measurements in a parallel scan (scanning along
the long axis of the cantilever), therefore, a perpendicular scan may be more desirable. Generally, one
picks a scanning angle which gives the same topographic data in both directions; this angle may be
slightly different than that for the perpendicular scan.
Physically, the AFM consists of three main parts: the optical head which senses the cantilever deflection,
a piezoelectric tube scanner which controls the scanning motion of the sample mounted on its one end,
and the base which supports the scanner and head and includes circuits for the deflection signal. The
AFM connects directly to a control system. A front view of the AFM is shown in Figure 1.19A. Due to
the weight of the optical head, the sensing system cannot be mounted on the piezo tube, therefore, the
optical head and the cantilever are held stationary while the sample is scanned under them. The optical
sensing system is packaged into the optical head of the microscope (Figure 1.19B). The head consists of
a laser diode stage, a photodiode stage preamp board, a cantilever mount and its holding arm, and a
deflection beam reflecting mirror. The laser diode stage is a tilt stage used to adjust the position of the
laser beam relative to the cantilever. It consists of the laser diode, collimator, focusing lens, base plate,
and the X and Y laser diode positioners. The positioners are used to place the laser spot on the end of
the cantilever. The photodiode stage is an adjustable stage used to position the photodiode elements
relative to the reflected laser beam. It consists of the split photodiode, the base plate, and the photodiode
positioners. The top (AFM) positioner is used to adjust the AFM signal by moving the photodiode up
and down. Similarly, the front (FFM) positioner adjusts the FFM signal by moving the photodiode
elements in and out (used for FFM, to be described later). The preamp board contains preamplifier
circuits for all four photodetecter signals and a laser diode power supply circuit. The cantilever mount
FIGURE 1.18 Schematic of triangular pattern trajectory of the AFM tip as the sample is scanned in two dimensions.
During imaging, data are recorded only during scans along the solid scan lines whereas scratch and wear (to be
described later) take place along both the solid and dotted lines.
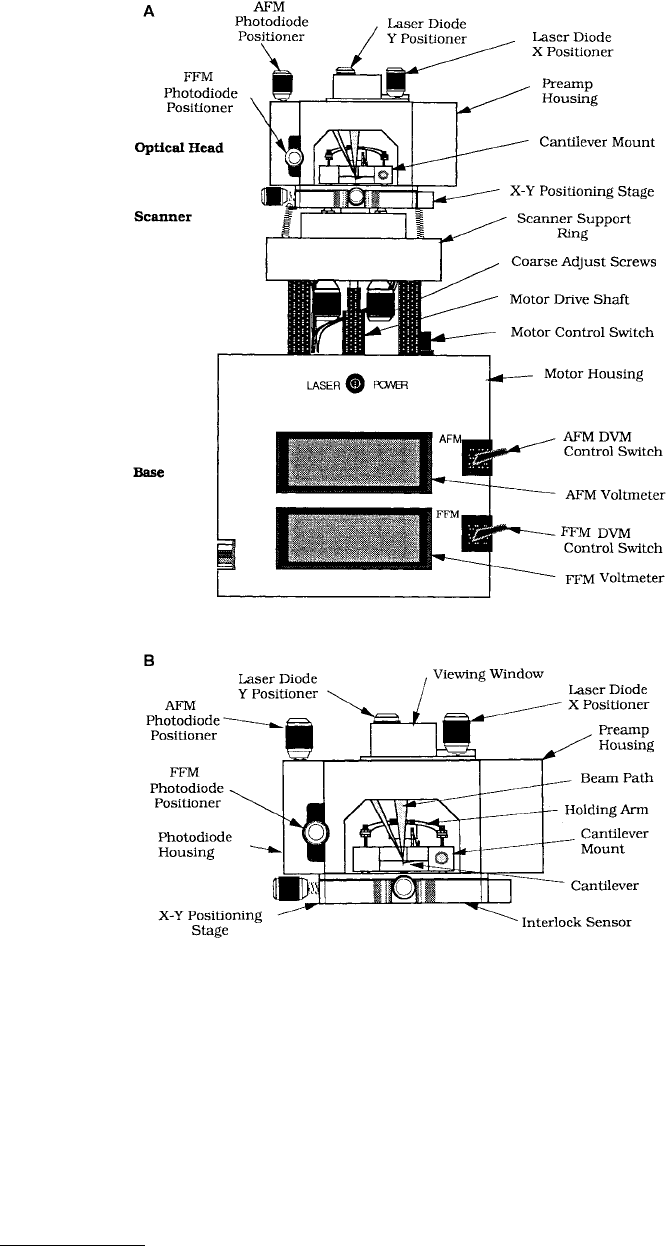
© 1999 by CRC Press LLC
is a metal (for operation in air) or glass (for water) block which holds the cantilever firmly at the proper
angle, Figure 1.19D, and the deflection beam reflecting mirror is mounted on the upper left in the interior
of the head which reflects the deflected beam toward the photodiode.
The scanner consists of an Invar cylinder holding a single tube made of piezoelectric crystal which
provides the necessary three-dimensional motion to the sample, Figure 1.6B. Mounted on top of the tube
is a magnetic cap on which the steel sample puck is placed. The tube is rigidly held at one end with the
FIGURE 1.19 Schematics of a commercial AFM/FFM made by Digital Instruments, Inc.: (A) front view, (B) optical
head, (C) base, and (D) cantilever substrate mounted on cantilever mount (not to scale). (From “Nanoscope III
Atomic Force Microscope, Instruction Manual,” Courtesy of Digital Instruments, Inc., Santa Barbara, CA., 1992)
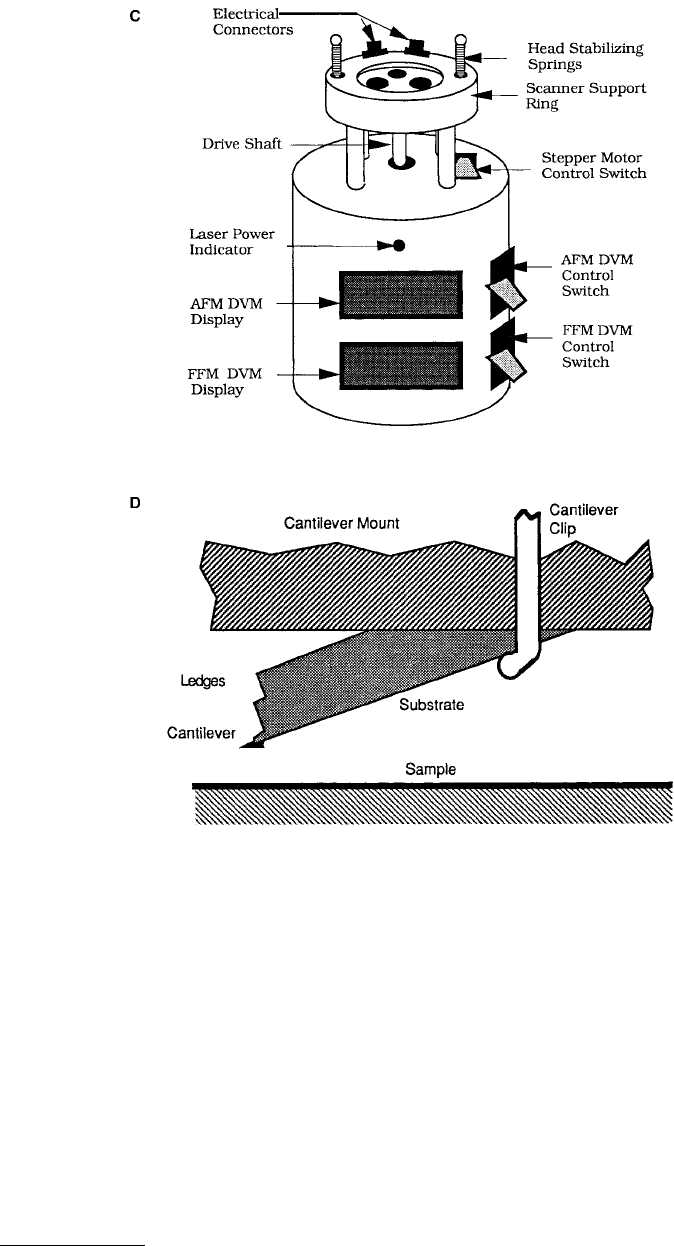
© 1999 by CRC Press LLC
sample mounted on the other end of the tube. Samples up to about 10 × 10 mm or about 15 mm in
diameter and 10 mm in thickness can be used. The scanner also contains three fine-pitched screws which
form the mount for the optical head. The optical head rests on the tips of the screws which are used to
adjust the position of the head relative to the sample. The scanner fits into the scanner support ring
mounted on the base of the microscope, Figure 1.19C. Two of the screws on the scanner are operated
manually while the third is controlled with a stepper motor built into the base of the microscope. The
stepper motor is controlled manually with the switch on the upper surface of the base and automatically
by the computer during the tip-engage and tip-withdraw processes. The base also houses electronic
circuits which are essential to the alignment and operation of the microscope. The two liquid-crystal
(digital voltmeter or DVM) displays on the base show either the sum of the photodiode signals or the
differential photodiode signals depending on the position of the respective control switches on the base.
These voltages are required during the optical alignment of the system.
FIGURE 1.19 (continued)

© 1999 by CRC Press LLC
The scan sizes available for this instrument are 0.7, 12, and 125 µm. The scan rate must be decreased
as the scan size is increased. A maximum scan rate of 122 Hz can be used. Scan rates of about 60 Hz
should be used for small scan lengths (0.7 µm). Scan rates of 0.5 to 2.5 Hz should be used for large scans
on samples with tall features. High scan rates help reduce drift, but they can only be used on flat samples
with small scan sizes. Scan rate or scanning speed in length/time is equal to twice the scan length times
the scan rate in Hz, and in the slow direction, it is equal to scan length times the scan rate in Hz divided
by the number of data points in the transverse direction. For example, for 10 × 10 µm scan size scanned
at 0.5 Hz, the scan rates in the fast and slow scan directions are 10 µm/s and 20 nm/s, respectively.
Normally 256 × 256 data points are taken for each image. The lateral resolution at larger scans is
approximately equal to scan length divided by 256. The piezotube requires X–Y calibration which is
carried out by imaging an appropriate calibration standard. Cleaved graphite is used for small scan heads
while two-dimensional grids (a gold-plating ruling) can be used for longer-range heads.
To prepare AFM for imaging, the following steps are required: installing a cantilever, loading a sample,
aligning the optics, and doing the coarse approach of the tip to the sample. By loosening the cantilever
holding-arm screw located on the back of the optical head, the cantilever mount is removed. The
appropriate cantilever is mounted on the cantilever mount with a clip (Figure 1.19D), and the cantilever
mount is replaced into the optical head. The AFM is provided with 12.7-mm-diameter steel pucks that
can be attached to the magnetic cap on the end of the scanner tube. The sample is placed on the puck
by using a sticky tab or a quick-drying glue and the puck is placed onto the magnetic cap on the top of
the scanner tube. Next, the optical head is placed on the magnetic balls mounted on the ends of the three
screws of a scanner on which the sample has already been loaded. When the head is in place, electrical
connections are made. Next the laser, cantilever, and photodiode are aligned. While observing the
substrate/cantilever through a magnifier, the laser spot is adjusted with the two positioning knobs on
the top of the head so that it is positioned on the vertex of the cantilever. After the laser beam is properly
aligned with the cantilever, photodiode positioners are adjusted to center the laser spot in the quad
photodiode. As a first step, the laser spot is centered visually then centered more precisely to maximize
the AFM sum signal (T + B), while setting the FFM difference signal (L – R) to zero (for friction
measurements, to be discussed later). When the AFM sum signal is maximized, one should see a signal
of 5 to 9 V. After optical alignment, the cantilever is lowered with the coarse-approach screw until the
tip is about 0.1 mm above the sample, followed by the fine position of the tip by monitoring the reflection
of the illuminated cantilever on the sample (tip must not touch the sample). A final step prior to engaging
is the setting of the AFM control switch to difference signal (down position) and the adjustment of the
photodiode position until the output of the preamp is set to a desirable value, between –1 and –4 V.
Now the AFM is ready for scanning, which is initiated by engaging the microscope.
Examples of AFM images of freshly cleaved HOP graphite and mica surfaces are shown in Figure 1.20
(Albrecht and Quate, 1987; Marti et al., 1987; Ruan and Bhushan, 1994b).
Force calibration mode is used to study interaction between the cantilever and the sample surface. In
the force calibration mode, the X- and Y-voltages applied to the piezotube are held at zero and a sawtooth
voltage is applied to the Z-electrode of the piezotube, Figure 1.21A. The force measurement starts with
the sample far away and the cantilever in its rest position. As a result of the applied voltage, the sample
is moved up and down relative to the stationary cantilever tip. As the piezo moves the sample up and
down, the cantilever deflection signal from the photodiode is monitored. The force curve, a plot of the
cantilever deflection signal as a function of the voltage applied to the piezotube, is obtained. Figure 1.21B
depicts a typical force–separation curve showing the various features of the curve. The arrow heads reveal
the direction of piezo travel. At point 1, the tip is off the sample surface. From point 1 to point 2 there
is no change in the deflection signal as the piezo extends, because the force is initially zero as the sample
has not come into contact with the tip. At point 2 the tip is a fraction of a nanometer away from the
sample, and the force between the tip and the sample suddenly becomes attractive. The cantilever bends
toward the sample and the attractive force increases gradually until point 2′ of the sample and tip come
into intimate contact and the force becomes repulsive. The maximum forward deflection of the cantilever
