Gupta D. (Ed.). Diffusion Processes in Advanced Technological Materials
Подождите немного. Документ загружается.


array of infinitesimal dislocations, as described by Eshelby.
[56]
The extent
of spreading can be characterized by the half-width, c, of the slipped
region.
The dislocation core spreading illustrated in Fig. 8.20 requires that the
material on one side of the interface be able to slide by small amounts (b)
relative to the material on the other side of the interface. This cannot occur
over large distances in real coherent interfaces. However, for incoherent
interfaces between crystalline and amorphous solids, small relative displace-
ments are possible, and dislocation core spreading may occur over large dis-
tances. When a shear strain is applied across the interface, we can imagine
that some film-substrate bonds are broken and new, energetically more
favorable bonds are formed in their place. Since only a few bonds move, the
mean position of the plane can move by an amount that is much less than b.
Awide range of film-substrate systems have incoherent interfaces and
may be susceptible to dislocation core spreading following a mechanism
like that illustrated in Fig. 8.20. Transmission electron microscopy (TEM)
investigations have shown dislocations disappearing at the interface
between an Al film and its native Al
2
O
3
passivation
[57]
and at the interface
between a Cu film and a SiN
x
barrier layer.
[43]
Gao et al.
[58]
have developed a mathematical model to describe the
time-dependent process of dislocation core spreading along a crystalline-
amorphous interface. The model is briefly described here. We consider
edge dislocations spreading along an interface characterized by a shear
adhesive strength, t
0
, below which no core spreading occurs and above
which spreading takes place in a viscous manner. The equilibrium core
width and the rate of core spreading for single dislocations and a periodic
array of dislocations can be calculated as a function of interface adhesion.
We consider an edge dislocation spreading along an interface between
a crystalline and an amorphous solid, as depicted in Fig. 8.20. At time
t 0, the dislocation core structure is compact. Subsequently, deformation
near the film-substrate interface is assumed to be described by a viscous
model. This problem has been treated in detail by Gao et al.
[58]
for a single
or planar array of dislocations in a homogeneous bulk material or at the
interface between a thin film and a semi-infinite substrate, where the film
and substrate may have the same, or different, elastic constants. Some of
the solutions are analytic and others are based on an implicit finite differ-
ence method. For an edge dislocation spreading along an interface between
a crystal and an amorphous material with the same elastic constants, the
solution shows that the equilibrium core width for a single dislocation is:
c
e
, (18)
Eb
8(1 n
2
)t
0
392 DIFFUSION PROCESSES IN ADVANCED TECHNOLOGICAL MATERIALS
Ch_08.qxd 11/29/04 6:45 PM Page 392

STRESSES IN THIN FILMS AND THEIR RELAXATION, KRAFT, GAO 393
and for a period array of edge dislocations with spacing L is:
c
e
sin
1
tanh
. (19)
We observe that the equilibrium core width scales inversely with the inter-
face adhesion t
0
. The stronger the interface, the more compact the core. The
analyses by Gao et al.
[58]
and Baker et al.
[59]
show that the viscous spreading
of a single dislocation core can be described by the change in the half width,
c(t)
1 0.3634 exp
t
, (20)
of the slipped zone, where h and t
i
are the viscosity and the thickness of
the interface, respectively. At t 0, the half-width
c(0)
4p(1
E
b
n
2
)t
0
(21)
defines a region over which viscous slip occurs immediately because the
shear stress associated with a compact dislocation core exceeds the interface
adhesion t
0
. Although the slipping width c(t) is somewhat ad hoc in repre-
senting the core width, the evolution Eq. (20) provides the insight that the
time scale over which the core spreading occurs is largely determined by the
ratio ht
0
. Since viscosity usually decreases with temperature, we conclude
that core spreading occurs faster at higher temperatures and stronger inter-
faces, and slower at lower temperatures and weaker interfaces. It can be fur-
ther argued that dislocation core spreading reduces the effectiveness of
hardening mechanisms, as discussed in Figs. 8.12 and 8.19.
[58]
As a result,
dislocation-mediated plasticity in thin films is immediately related to diffu-
sional processes as well as to the properties of surfaces and interfaces.
However, a complete understanding of dislocation plasticity is still not
achieved and an incorporation of thermally activated core spreading in the
dislocation models described above has not yet been attempted.
8.3.3 Diffusional Creep
As discussed in Sec. 3.1 and shown in Fig. 8.10, wafer curvature
experiments have shown that the thermal mechanical behavior of Cu
9t
0
t
i
hb
Eb
8(1 n
2
)t
0
pEb
8(1 n
2
)t
0
L
L
p
Ch_08.qxd 11/29/04 6:45 PM Page 393

thin films on substrates depends strongly on the passivation of the film
surface. This phenomenon has recently been explained by a special
kind of Coble-creep in thin films on substrates, often referred to as the
constrained diffusional creep.
[31, 60]
The continuum model for con-
strained diffusional creep developed has adopted the hypothesis that
uncapped, pure Cu films are subject to active surface and grain boundary
diffusion, which causes transport of material between the film surface
and the grain boundaries.
[60]
Diffusion in thin films on substrates is fun-
damentally different in nature from that in bulk materials. A constraint
is imposed by the usually perfect bonding between film and substrate
(for example, material sequence Cu-aSiN
x
-aSiO
x
-Si,
[61–63]
which
implies that no sliding occurs at the film-substrate interface. In contrast
to previously proposed models of diffusion in thin films,
[64]
the con-
straint that no sliding occurs at the film-substrate interface renders the
diffusion in thin films an inherently transient problem. Steady-state
solutions frequently used to describe grain boundary diffusion may not
be used. An additional constraint is that material transport cannot pro-
ceed in the substrate and diffusion has to stop at the film-substrate
interface. Constrained diffusional creep leads to formation of a new
material defect called the grain boundary diffusion wedge, which also
plays an important role in dislocation nucleation processes in thin
films.
[60]
This process corresponds to the classical Coble creep in a thin-
film structure, except that the roots of the grain boundaries are con-
strained not to slide with respect to the substrate. In the remainder of
this section, we briefly describe the theory of constrained diffusional
creep as well as the grain boundary diffusion wedge and its associated
dislocation mechanisms.
In the model of Gao et al.,
[60]
constrained diffusional creep under a
constant nominal stress in the film is considered and diffusion is modeled
as dislocation climb in the grain boundary. The solution for a single edge
dislocation is used as the Green’s function to construct a solution with
infinitesimal Voltera edge dislocations. For an inserted grain boundary
wedge of width 2u(z,t) in a film with thickness h(0 z h), the stress
along the grain boundary is given by:
s
gb
(z,t) s
0
h
0
S(z, z)
∂u
∂
(z
z
,t)
dz, (22)
where S(z,z) is a Green’s function kernel for the continuous dislocation
problem (Cauchy kernel), G is the shear modulus, n is Poisson’s ratio, and
s
0
is the stress in the absence of diffusion. Balancing the diffusive atomic
flux with the displacement rate (mass conservation), the diffusion equation
G
2p(1 n)
394 DIFFUSION PROCESSES IN ADVANCED TECHNOLOGICAL MATERIALS
Ch_08.qxd 11/29/04 6:45 PM Page 394

STRESSES IN THIN FILMS AND THEIR RELAXATION, KRAFT, GAO 395
based on Coble creep,
[65]
∂u
∂
(z
t
,t)
, (23)
is woven into the problem. Here, d
gb
D
gb
denotes the product of grain
boundary thickness and atomic diffusivity, t is time, Ω is the atomic vol-
ume, and kT has the usual meaning. Combining Eqs. (22) and (23) yields
an integro-differential governing equation for constrained diffusional
creep:
h
0
S(z,z)
∂
3
s
∂
g
z
b
(
3
z,t)
dz, (24)
which describes the time evolution of grain boundary stress under the fol-
lowing boundary conditions:
s
gb
(0,t) 0, s
gb
(h,t) s
gb
(h,t) 0 (25)
and an initial condition
s
gb
(z,0) s
0
. (26)
The boundary conditions in Eq. (25) correspond to continuity of
chemical potential at the junction between the film surface with the grain
boundary, as well as no mass flux and no sliding at the film-substrate
interface. The initial condition in Eq. (26) defines a Green’s function
solution to a step loading on the thin film. The solution can be used later
to construct more general solutions to an arbitrary time-dependent load-
ing s
0
(t) via a convolution scheme.
[31]
The solution to Eq. (26) shows that
the insertion of a material wedge into the grain boundary causes expo-
nential stress decay with a characteristic time scaling with the cube of the
film thickness,
t
0
. (27)
The diffusion wedge represents columns of atoms corresponding to an
array of climb-edge dislocations that have been transported into the grain
2p(1 n)kTh
3
Gd
gb
D
gb
Ω
Gd
gb
D
gb
Ω
2p(1 n)kT
∂s
gb
(z,t)
∂t
∂
2
s
gb
(z,t)
∂z
2
d
gb
D
gb
Ω
2kT
Ch_08.qxd 11/29/04 6:45 PM Page 395

boundary. With respect to the lattice distortion around the diffusion
wedge, the dislocations in the grain boundary exemplify geometrically
necessary dislocations
[66, 67]
that are usually associated with nonuniform
plastic deformation. Gao et al.
[60]
used an eigenmode expansion to obtain
an integro-differential eigenvalue problem that is subsequently trans-
formed into a standard Cauchy-type singular equation to be solved by a
Gauss-Chebyshev quadrature scheme. Gao et al. provide details of the
numerical procedure.
[60]
A simplified solution,
s
gb
(z,t) s
0
e
ltt
0
f(zh), (28)
can be used for all practical purposes, where the function f(x) is
defined as:
f(x) 3
1 x
2
, (29)
the parameter l is related to the film thickness h and grain size d as:
l
11.72 1.69(hd) 73.09(hd)
2
0 hd 0.2
8.10 30.65(hd) 0.2 hd 10. (30)
Averaging Eq. (28) over the film thickness shows that the average stress
on the grain boundary decays exponentially as:
s
gb
(t) s
0
e
ltt
0
. (31)
Therefore, on the scale of a characteristic time t
0
l, the traction along the
grain boundary is fully relaxed and the diffusion wedge exhibits the same
traction-free condition as a crack, indicating a singular stress field near
the root of the grain boundary. This leads to extraordinarily large
resolved shear stresses on planes parallel and close to the film-substrate
interface and, in the (111)-textured films, can cause emission of parallel
glide dislocations. Although the resolved shear stresses on the parallel
glide planes induced by a diffusion wedge are similar to those caused by
a crack, differences in the dislocation nucleation process may arise. The
mechanisms involved are still not well understood and are currently
being investigated.
Experimentally, diffusional creep as a major stress relaxation mecha-
nism in uncapped thin copper films has been verified in a number of
studies.
[11, 15, 31, 61, 63]
Experiments have indicated that, while plastic deformation
l
3p
396 DIFFUSION PROCESSES IN ADVANCED TECHNOLOGICAL MATERIALS
Ch_08.qxd 11/29/04 6:45 PM Page 396
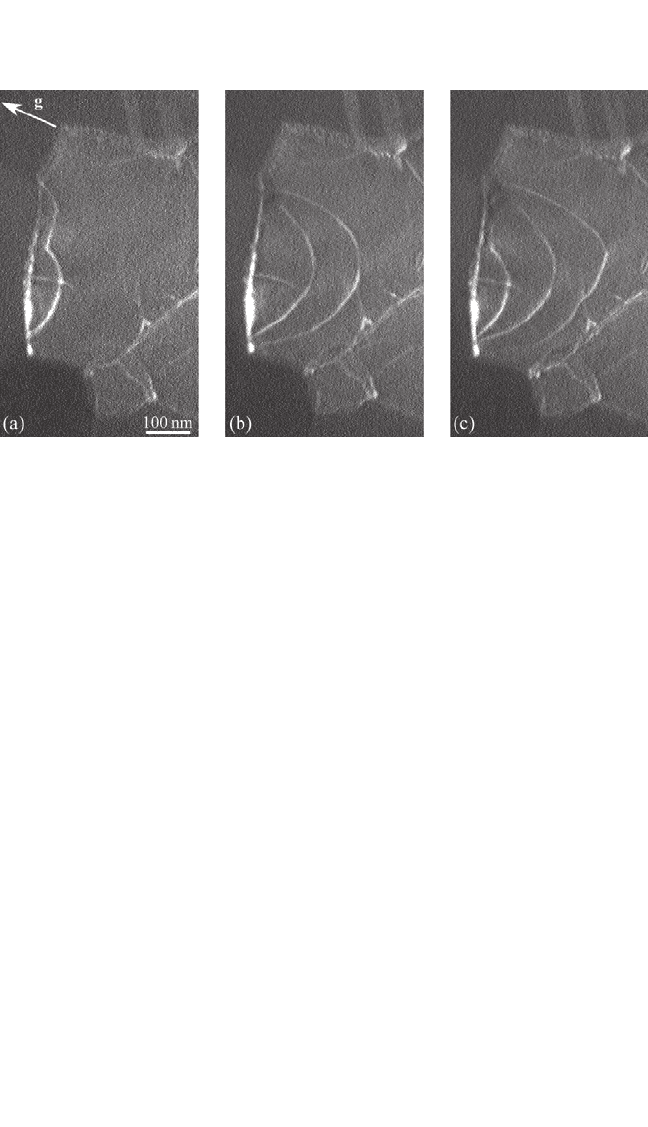
STRESSES IN THIN FILMS AND THEIR RELAXATION, KRAFT, GAO 397
in passivated or relatively thick copper films is characterized by the
“classical” threading dislocations, parallel glide dislocations become
increasingly dominant in unpassivated thin films with thicknesses of less
than 400 nm.
[61–63]
The experimental observations of parallel glide dislo-
cation emission strongly indicate that constrained grain boundary diffu-
sion is a dominant stress relaxation mechanism for unpassivated thin films
on substrate. Figure 8.21 shows an in situ TEM observation of parallel
glide dislocations being emitted from a grain boundary source during the
cooling portion of the second thermal cycle of the Cu-aSiN
x
-aSiO
x
-
Si(100) system. The experiments have also indicated that nucleation of
parallel glide dislocations is very selective to the type of grain boundary.
Grain boundaries with 6- and 66-degree tilt angles seem to be preferred
nucleation sites for parallel glide dislocations. The smallest film thickness
investigated is about 35 nm.
In modeling a thermal cycling experiment, both the nominal stress s
0
and temperature (hence the characteristic time t
0
also) vary with time, and
Eq. (31) cannot be directly used. Weiss et al.
[31]
have developed an inte-
gral convolution scheme to calculate the grain boundary stress and have
used it to determine the average stress over the entire film using an equation
Figure 8.21 During the cooling portion of the second thermal cycle of the Cu-aSiN
x
-
aSiO
x
-Si(100) film-on-substrate system, parallel glide dislocations were emitted from
the grain boundary source. (a) At 170°C, the first dislocation has been emitted and
is pinned in the middle.(b) The second emitted dislocation has quickly overcome the
pinning point and has pushed the first dislocation forward by the time 150°C is
reached. (c) At 135°C, the third dislocation is pinned, while the first two have
advanced far into the grain (180 and 300 nm).From Dehm et al.,
[63]
with permission.
Ch_08.qxd 11/29/04 6:45 PM Page 397

by Xia and Hutchinson:
[68]
s s
0
(s
0
s
gb
)
tanh
. (32)
Weiss et al.
[31]
took the experimentally measured stress in passivated
Cu 1 at.% Al film as the nominal stress s
0
and found that the stress s cal-
culated from Eq. (32) is in reasonable agreement with the measured stress
in unpassivated pure Cu film. Therefore, they concluded that the observed
difference in thermomechanical behavior between passivated and unpas-
sivated films can be attributed to constrained diffusional creep.
By implicitly assuming that surface diffusivity is much faster than
grain boundary diffusivity, the model of Gao et al.
[60]
does not explicitly
consider mass transport along the surface of the film. Depending on mate-
rials, this assumption may not always be valid. Zhang and Gao
[69]
recently
studied coupled surface and grain boundary diffusion and concluded that
the analyses by Weiss et al.
[31]
and Gao et al.
[60]
remain valid even when sur-
face diffusivity is comparable to grain boundary diffusivity. Specifically,
Zhang and Gao
[69]
have shown that the results in
[31]
and
[60]
become gener-
ally valid when an effective diffusivity
d
eff
D
eff
(33)
is used to replace the grain boundary diffusivity d
gb
D
gb
, where d
s
D
s
denotes the surface diffusivity. Note that, due to the large constant coeffi-
cient of 12p, the effect of surface diffusion becomes significant only when
the grain boundary diffusivity is much larger than the surface diffusivity.
8.4 Conclusion
In this chapter, techniques for the measurement of stresses in metal-
lic thin films held on substrates and their relaxation by plastic deforma-
tion and diffusional creep are described. All studies mentioned indicate
clearly that the motion of dislocations is constrained in thin metal films
by the presence of interfaces and grain boundaries. As a result, the
mechanical behavior of thin metal films can be qualitatively summarized
by saying that smaller is stronger. On the other hand, diffusional processes
play a more important role with decreasing dimensions as the density
of fast diffusion pathways increases. Therefore, it would be helpful to
12pd
s
D
s
d
gb
D
gb
12pd
s
D
s
d
gb
D
gb
d
4t
f
4t
f
d
398 DIFFUSION PROCESSES IN ADVANCED TECHNOLOGICAL MATERIALS
Ch_08.qxd 11/29/04 6:45 PM Page 398

STRESSES IN THIN FILMS AND THEIR RELAXATION, KRAFT, GAO 399
describe the deformation behavior of thin films using deformation mech-
anism maps
[70]
similar to the ones established for bulk materials by Frost
and Ashby,
[49]
which include both dislocation-mediated and diffusion-
mediated mechanisms. Unfortunately, clear, quantitative descriptions
have not yet been established for thin films, neither empirically nor the-
oretically, and the use of quantitative descriptions obtained from bulk
materials does not appear to be adequate. This is further accentuated by
the fact that subtle changes in the chemistry of the interfaces, which
might be beyond experimental control, can dramatically influence the
thin-film mechanical behavior. The models discussed for diffusional
creep and dislocation core spreading will contribute to a framework that
will lead eventually to a more complete description of thin-film mechanical
behavior that takes into account the interaction of dislocation plasticity
and diffusional processes. For this, a unified view of the experimental
observations, including mechanical testing as well as in situ electron
microscopy, and of the theory is indispensable.
In most technological applications, thin films are rigidly attached to
a substrate that is typically much thicker than the film itself. As a result
of this configuration, the thin films are commonly subject to high inter-
nal stresses, which may endanger the operation of small-scale devices.
Failure mechanisms discussed in the literature include the following.
(1) Thermal-stress-induced voiding has been a problem for many years
for Al or Cu conductor lines.
[71, 72]
This phenomenon is driven by high
hydrostatic tensile stresses within interconnect lines under a capping
layer during cooling. Even in blanket films, where two-dimensional in-
plane stresses are observed, a few cases of stress-induced voiding have
been reported.
[73, 74]
(2) Stresses may also cause the delamination or
cracking of thin films.
[75]
It has been shown that the plasticity in thin
metal layers affects the interface fracture resistance in thin-film inter-
connect structures.
[76]
Specifically, the TaN/SiO
2
interface fracture energy
was measured in thin-film Cu/TaN/SiO
2
structures in which the Cu layer
was varied over a wide range of thickness. It was found that in a regime
of 0.25 to 2.5 µm, the delaminating resistance is dominated by the con-
tribution of plastic deformation in the metallic layer. (3) More recently,
the behavior of thin metal films under cyclic loading conditions has been
given experimental as well as theoretical consideration. In particular,
cracking of a brittle layer caused by ratcheting in an adjacent ductile
layer has been observed in a thin-film system under cyclic thermal load-
ing.
[77]
Moreover, cyclic mechanical or thermomechanical loading can
also lead to the formation of voids and extrusions in thin metal
films.
[78–80]
From these observations, it has been concluded that the role
of point defects and diffusion is much more important for fatigue in thin
films than in bulk materials.
Ch_08.qxd 11/29/04 6:45 PM Page 399

In summary, continuum theories of plasticity or lifetime models that
incorporate dislocation plasticity and diffusional processes with respect to
a physical or microstructural length scale may turn out to be very helpful
if they can be validated by experiments. The predictive capability of such
theories will be very useful in device simulation codes for microelectron-
ics, MEMS, and other applications.
References
1. W. D. Nix, “Mechanical properties of thin films,” Metal. Trans.,A20:2217–2245
(1989)
2. S. P. Baker, A. Kretschmann, and E. Arzt, “Thermomechanical behavior of
different texture components in Cu thin films,” Acta Mater., 49:2145–2160
(2001)
3. I. A. Blech and A. A. Levi, J. Appl. Mech., 48:442 (1981)
4. G. G. Stoney, “The tension of metallic films deposited by electrolysis,” Proc.
R. Soc. London, A82:172–175 (1909)
5. P. A. Flinn, D. S. Gardner, and W. D. Nix, “Measurements and interpreta-
tion of stress in aluminum-based metallization as a function of thermal
history,” IEEE Transaction on Electron Devices, ED-34(3):689–699
(1987)
6. M. Moske and K. Samwer, “New UHV dilatometer for precise measurement
of internal stresses in thin binary-alloy films from 20–750 K,” Rev. Sci.
Instrum., 59:2012 (1988)
7. R. Abermann, “Internal stress of vapour-deposited aluminum films: effect of
O
2
and water vapour present during film deposition,” Thin Solid Films,
186:233–240 (1990)
8. J. A. Floro, E. Chason, R. C. Cammarata, and D. J. Srolovitz, “Physical ori-
gins of intrinsic stresses in Volmer-Weber thin films,” Mater. Res. Bull.,
271(1):19–25 (2002)
9. R. Venkatraman and J. C. Bravman, “Separation of film thickness and grain
boundary strengthening effects in thin Al films on Si,” J. Mater. Res.,
7(8):2040–2048 (1992)
10. C. A. Volkert, C. F. Alofs, and J. R. Liefting, “Deformation mechanisms of
Al films on oxidized Si wafers,” J. Mater. Res., 9:1147–1155 (1994)
11. R.-M. Keller, S. P. Baker, and E. Arzt, “Stress-temperature behavior of
unpassivated thin copper films,” Acta Mater., 47:415–426 (1999)
12. S. Bader, E. M. Kalaugher, and E. Arzt, “Comparison of mechanical proper-
ties and microstructure of Al(1 wt.% Si) and Al(1 wt.% Si, 0.5 wt.% Cu) thin
films,” Thin Solid Films, 263:175–184 (1995)
13. R.-M. Keller, S. P. Baker, and E. Arzt, “Quantitative analysis of strengthen-
ing mechanisms in thin Cu films: effects of film thickness, grain size, and
passivation,” J. Mater. Res., 13(5):1307–1317 (1998)
14. R. P. Vinci, E. M. Zielinski, and J. C. Bravman, “Thermal strain and stress in
copper thin films, Thin Solid Films, 262:142–153 (1995)
400 DIFFUSION PROCESSES IN ADVANCED TECHNOLOGICAL MATERIALS
Ch_08.qxd 11/29/04 6:45 PM Page 400

STRESSES IN THIN FILMS AND THEIR RELAXATION, KRAFT, GAO 401
15. M. J. Kobrinsky and C. V. Thompson, “The thickness dependence of the flow
stress of capped and uncapped polycrystalline Ag thin films,” Appl. Phys.
Lett., 73:2429 (1998)
16. A. Lahav, K. A. Grim, and I. A. Blech, “Measurement of thermal expansion
coefficients of W, WSi, WN and WSiN thin film metallizations,” J. Appl.
Phys., 67(2):734–738 (1990)
17. P. A. Flinn and C. Chiang, “X-ray diffraction determination of the effect of
various passivations on stress in metal films and patterned lines,” J. Appl.
Phys., 67(6):2927–2931 (1990)
18. B. M. Clemens and J. A. Bain, “Stress determination in textured thin films
using x-diffraction,” MRS Bull., 12(7):46–51 (1992)
19. P. R. Besser, S. Brennan, and J. C. Bravman, “An x-ray method for direct
determination of the strain state and strain relaxation in micron-scale passi-
vated metallization lines during thermal cycling,” J. Mater. Res., 9:13 (1994)
20. O. Kraft and W. D. Nix, “Thermomechanical behavior of continuous and pat-
terned Al thin films,” Materials Reliability in Microelectronics VIII, MRS
Symp. Proc., vol. 516, Warrendale, PA (1998), pp. 201–212
21. O. Kraft and W. D. Nix, “Measurements of the lattice thermal expansion
coefficient of thin films on substrates,” J. Appl. Phys., 83:3035–3038 (1998)
22. M. Hommel and O. Kraft, “Deformation behavior of thin copper films on
deformable substrates,” Acta Mater., 49:3935–3947 (2001)
23. M. Van Leeuwen, J.-D. Kamminga, and E. J. Mittemeijer, “Diffraction stress
analysis of thin films: modeling and experimental evaluation of elastic con-
stants and grain interactions,” J. Appl. Phys., 86(4):1904–1914 (1999)
24. W.-M. Kuschke and E. Arzt, “Investigations of stresses in continuous
thin films and patterned lines by x-ray diffraction,” Appl. Phys. Lett.,
64(9):1097–1099 (1994)
25. B. C. Larson, W. Yang, G. E. Ice, J. D. Budai, and J. Z. Tischler, “Three-
dimensional structural x-ray microscopy with submicrometer resolution,”
Nature, 451:887–890 (2002)
26. R. Spolenak, N. Tamura, B. C. Valek, A. A. MacDowell, R. S. Celestre,
H. A. Padmore, W. L. Brown, T. Marieb, B. W. Batterman, and J. R. Patel,
“High resolution microdiffraction studies using synchrotron radiation,” 6th
International Workshop on Stress-Induced Phenomena in Metallization, AIP
Conf. Proc. 612, Melville, NY (2002), pp. 217–228
27. N. Tamura, R. S. Celestre, A. A. MacDowell, H. A. Padmore, R. Spolenak,
B. C. Valek, N. Meier Chang, A. Manceau, and J. R. Patel, “Submicron x-ray
diffraction and its applications to problems in materials and environment,”
Rev. Sci. Instrum., 73(3):1369–1372 (2002)
28. N. Tamura, A. A. MacDowell, R. S. Celestre, H. A. Padmore, B. C. Valek,
J. C. Bravman, R. Spolenak, W. L. Brown, T. Marieb, H. Fujimoto, B. W.
Batterman, and J. R. Patel, “High spatial resolution grain orientation and
strain mapping in thin films using polychromatic submicron x-ray diffrac-
tion,” Appl. Phys. Lett., 80(20):3724–3726 (2002)
29. D. Weiss, unpublished data (2001)
30. M. D. Thouless, K. P. Rodbell, and C. J. Cabral, “Effect of surface layer on the
stress relaxation in thin films,” J. Vac. Sci. Technol., A14(4):2454–2461 (1996)
Ch_08.qxd 11/29/04 6:45 PM Page 401
