Лебедев А.И. Физика полупроводниковых приборов
Подождите немного. Документ загружается.


192
Гл. 2. Биполярные транзисторы
одиночных «дискретных» приборов, так и сложных интегральных
микросхем, состоящих из миллионов элементов.
Кремний является не единственным материалом, из которого из*
готавливают интегральные схемы. В настоящее время для этих це-
лей также используются арсенид галлия и фосфид индия, которые
выпускаются промышленностью в виде пластин диаметром 100 мм.
Подвижность и скорость насыщения электронов в GaAs и 1пР заметно
выше, чем в кремнии, и поэтому эти материалы долго рассматривались
как материалы, которые придут на смену кремния в быстродейству-
ющих приборах [69]. Однако в последние годы интерес к GaAs как
материалу для будущих сверхбыстродействующих ИС стал ослабевать.
Причиной этому являются два обстоятельства: 1) примерно втрое более
низкая теплопроводность GaAs по сравнению с Si, которая не поз-
воляет эффективно отводить от арсенида галлия достаточно высокую
рассеиваемую мощность, характерную для современных ИС, и 2) вы-
сокая хрупкость GaAs. Это является серьезным препятствием на пути
создания арсенид-галлиевых СБИС с уровнем интеграции, близким
к достигнутому в настоящее время на кремнии. Тем не менее, GaAs
остается важным материалом для производства сверхбыстродействую-
щих цифровых и аналоговых ИС среднего уровня интеграции. Второй
из обсуждаемых материалов — 1пР — технологически менее развит по
сравнению с GaAs, однако созданные на его основе приборы в настоя-
щее время имеют самое высокое быстродействие. Из этих двух матери-
алов изготавливают D-триггеры, делители частоты, аналого-цифровые
преобразователи и целый ряд аналоговых сверхвысокочастотных ИС,
необходимых для спутниковой и оптоволоконной связи. Использова-
нию германия для создания интегральных схем мешает невысокая
максимальная рабочая температура изготавливаемых из него диодов
и транзисторов.
Рассмотрим сначала основные технологические приемы, ис-
пользуемые в планарной технологии на кремнии, а затем про-
иллюстрируем их применение на примере создания биполярных
транзисторов (дискретных приборов и элементов интегральных
схем). Особенности технологии создания полевых транзисторов
с МОП-структурой и ИС на их основе будут рассмотрены нами
в п. 4.2.
Фотолитография. Некоторые специалисты полагают, что
половиной своих поразительных успехов современная микроэлек-
троника обязана развитию техники литографии,
!
) Оптическая
1
) Литографией называют разработанный в конце XVIII века способ пе-
реноса изображения на бумагу с плоской (нерельефной) печатной формы,
при котором места на поверхности печатной формы, которые должны дать
отпечаток, покрываются специальным составом, который смачивается печатной
краской.
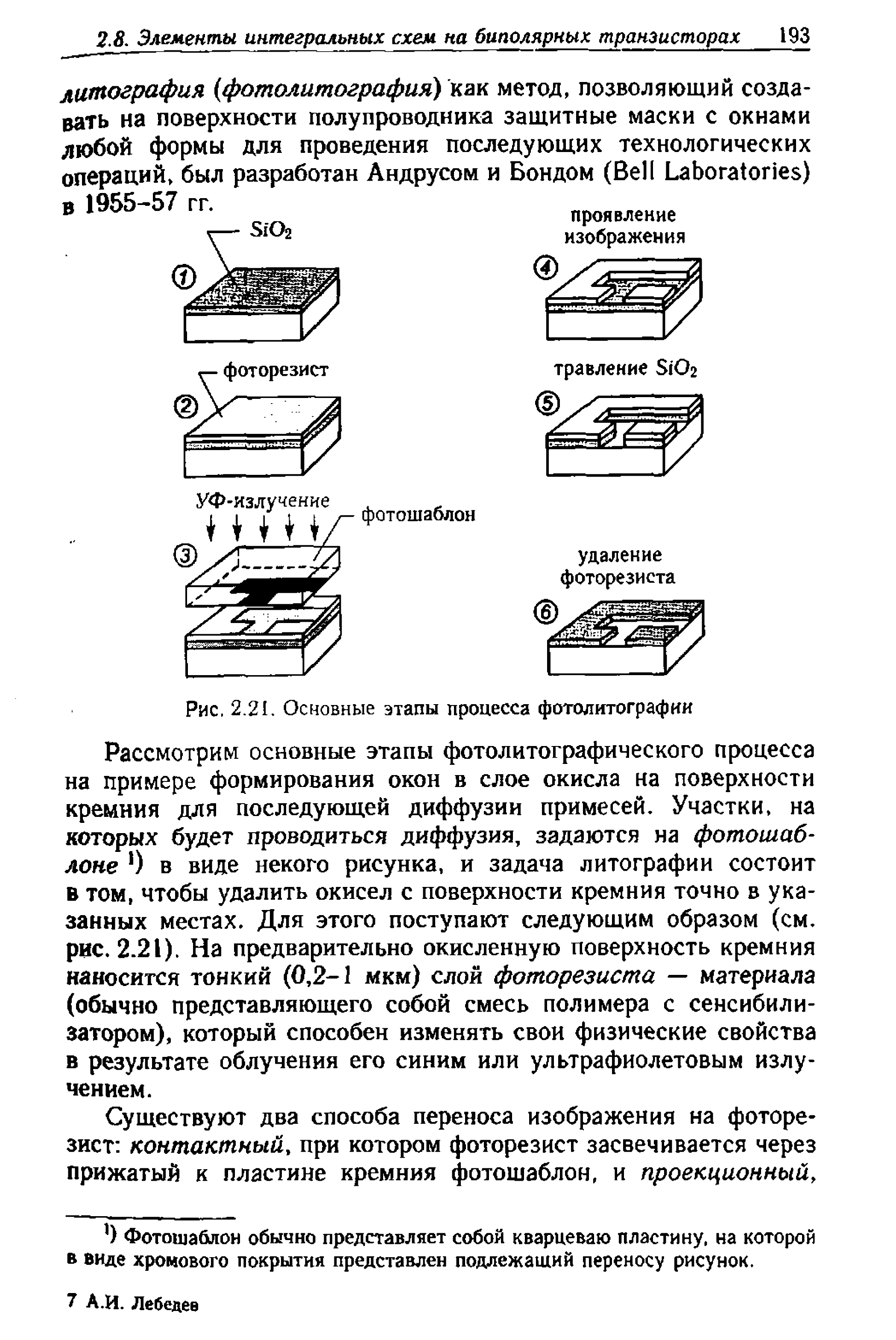
2.8. Элементы интегральных схем на биполярных транзисторах 193
литография (фотолитография) как метод, позволяющий созда-
вать на поверхности полупроводника защитные маски с окнами
любой формы для проведения последующих технологических
операций, был разработан Андрусом и Бондом (Bell Laboratories)
в 1955-57 гг.
SiOs
проявление
изображения
фоторезист
травление SiC>2
0
I
I
||1 II
0
4*
УФ-излучение
ШНА
фотошаблон
удаление
фоторезиста
Рис, 2.21. Основные этапы процесса фотолитографии
Рассмотрим основные этапы фотолитографического процесса
на примере формирования окон в слое окисла на поверхности
кремния для последующей диффузии примесей. Участки, на
которых будет проводиться диффузия, задаются на фотошаб-
лоне 0 в виде некого рисунка, и задача литографии состоит
в том, чтобы удалить окисел с поверхности кремния точно в ука-
занных местах. Для этого поступают следующим образом (см.
рис. 2.21). На предварительно окисленную поверхность кремния
наносится тонкий (0,2-1 мкм) слой фоторезиста — материала
(обычно представляющего собой смесь полимера с сенсибили-
затором), который способен изменять свои физические свойства
в результате облучения его синим или ультрафиолетовым излу-
чением.
Существуют два способа переноса изображения на фоторе-
зист: контактный, при котором фоторезист засвечивается через
прижатый к пластине кремния фотошаблон, и проекционный,
') Фотошаблон обычно представляет собой кварцеваю пластину, на которой
в виде хромового покрытия представлен подлежащий переносу рисунок.
7 А.И. Лебедев

194
Гл. 2. Биполярные транзисторы
при котором изображение рисунка проецируется на фоторезист
с помощью оптической системы. При контактном способе экс-
понирования для исключения возможности повреждения слоя
фоторезиста и рисунка на фотошаблоне последний располага-
ют на небольшом расстоянии от поверхности пластины. Поэто-
му контактный способ обеспечивает не слишком высокое про-
странственное разрешение. Проекционный метод с оптическим
уменьшением изображения в 4-5 раз позволяет получить более
высокое разрешение и поэтому преимущественно используется
в настоящее время.
В результате фотохимических реакций, идущих под действием све-
та, фоторезист меняет свои свойства (139): в так называемых пози-
тивных фоторезистах (например, полиметилметакрилате) ультрафи-
олетовое облучение разрушает полимерные связи и остатки полимера
на экспонированных участках растворяются в растворителе (метили-
зобутилкетоне) более, чем в 10 раз быстрее, чем неэкспонированные
участки. В другом, известном еще с 30-х годов, позитивном фоторе-
зисте — смеси диазонафтохинона с новолаком — ультрафиолетовое
облучение трансформирует гидрофобные (отталкивающие воду) моле-
кулы диазосоединения в гидрофильную кислоту, и экспонированные
участки фоторезиста затем легко смачиваются растворителем (рас-
твор щелочи) и удаляются. В негативных фоторезистах (например,
смесях циклических полиизопренов с диазидами или в специально син-
тезированных азидокаучуках), наоборот, под действием света начина-
ется распад азидов, образуются реакционно-способные радикалы, кото-
рые осуществляют поперечную сшивку линейных полимерных цепочек
с образованием на экспонированных участках нерастворимых объемно
сшитых полимеров. В последнее время для инициации полимеризации
все чаще используют ониевые соли, в результате фотодиссоциации ко-
торых образуются кислоты Льюиса, обладающие каталитическим дей-
ствием [140]; это позволяет значительно повысить чувствительность
негативных фоторезистов.
При помещении экспонированной пластины в растворитель
изображение «проявляется» (растворимые участки фоторезиста
удаляются) и рисунок с фотошаблона оказывается представлен-
ным на поверхности пластины в виде островков полимера, После
задубливания резиста, при котором его адгезия к слою окис-
ла и кислотостойкость возрастают, пластину помещают в рас-
твор смеси NH4F+HF и растворяют участки SiC>2, не защи-
щенные фоторезистом. Наконец, после удаления задубленного
фоторезиста с помощью химического или плазменного травления
(см. с. 202) получается пластина, на окисленной поверхности
которой в соответствии с рисунком на фотошаблоне открыты
участки незащищенной поверхности кремния.

2.8. Элементы интегральных схем на биполярных транзисторах 195
На сегодняшний день минимальный размер элементов в инте-
гральных схемах (минимальная длина затвора в случае полевых
транзисторов) составляет 0,055-0,09 мкм и продолжает неуклон-
но уменьшаться,
]
) поэтому возможности оптической литографии
приближаются к своему теоретическому пределу, налагаемому
дифракцией. Уменьшение размеров элементов заставило в се-
редине 80-х годов перейти от ртутных ламп к использованию
источников света с более короткими длинами волн. Сейчас
ими являются эксимерные лазеры KrF и ArF, работающие в обла-
сти вакуумного ультрафиолета (X
—
248 и 193 нм, соответствен-
но). Для создания элементов, размеры которых лежат вблизи
или за дифракционным пределом, создаются специальные фо-
тошаблоны, в которых для коррекции дифракционных искаже-
ний вводятся специальные «предыскажения» (фазовые сдвиги),
однако изготовление таких фотошаблонов обходится довольно
дорого.
Непрерывное совершенствование техники оптической лито-
графии отодвигает тот момент, когда ее возможности будут ис-
черпаны. Так, в настоящее время быстро развивается техника
иммерсионной литографии, в которой пространство между лин-
зой и слоем фоторезиста заполняется жидкостью (обычно водой).
Уменьшение длины волны при распространении света в жид-
кости (показатель преломления воды на длине волны 193 нм
составляет п
г
« 1,44) и увеличение апертуры позволяют достиг-
нуть более высокого разрешения. Эта техника уже была опро-
бована в промышленности и позволила получить минимальный
размер элементов 45 нм, По прогнозам, к 2009 г. с ее помощью
в оптической литографии будет достигнуто разрешение 32 нм.
В качестве альтернативных методов литографии для полу-
чения более высокого разрешения в настоящее время разра-
ботаны методы электронно-лучевой литографии, в которой
изображение «рисуется» на резисте с помощью электронного
луча в сканирующем электронном микроскопе, рентгеновская
') Минимальный размер 90 нм характерен для основной массы выпуска-
емых в настоящее время процессоров. Первые процессоры, выполненные по
05 нм технологии, появились в 2006 г., а в 2008 г. должны появиться процес-
соры с минимальным размером элементов 45 нм. Микросхемы динамической
(см, с. 275) и флэш-памяти (см. с. 289) с минимальным размером элементов
90 нм начали производиться еще в 2005 г. По состоянию на 2006 г., наи-
меньший размер элементов (55 нм) имеет флэш-память, выпускаемая фирмой
Samsung.
7*

196
Гл. 2. Биполярные транзисторы
литография, в которой резист экспонируется мягким рентгенов-
ским излучением от источника синхротронного излучения или
более дешевого импульсного источника — плазмы, возбуждаемой
лазером, и ионная литография, при которой фоторезист «за-
свечивается» пучком высокоэнергичных ионов [58]. Электронно-
лучевая литография с непосредственным экспонированием ре-
зиста электронным пучком имеет недостаточную для массового
производства производительность и поэтому используется в ос-
новном для создания экспериментальных структур и фотошабло-
нов для оптической и рентгеновской литографии.
Наиболее перспективной для создания приборов с субмик-
ронными размерами (< 0,1 мкм) представляется проекционная
ионная литография, первые практические шаги в реализации
которой были сделаны в 1985 г. В этом методе широкий пу-
чок ионов водорода или гелия с энергией 10 кэВ падает на
кремниевую мембрану толщиной 2-3 мкм и диаметром 150-
200 мм, в которой с помощью электронно-лучевой литографии
сделаны сквозные окна в соответствии с требуемым рисунком.
Прошедшие через окна ионы ускоряются до энергии 50-200 кэВ,
фокусируются системой электростатических линз с уменьшени-
ем размера изображения в 3-20 раз и направляются на слой
резиста. Из-за более тяжелой массы ионов боковое рассеяние
ионов в резисте оказывается меньше, чем для электронов, и
поэтому в ионной литографии достигается более высокое разре-
шение по сравнению с электронно-лучевой литографией. Кроме
того, в отличие от электронно-лучевой и рентгеновской литогра-
фии, ионная литография практически не вносит радиационных
повреждений в расположенный под слоем резиста полупро-
водник.
Литография является наиболее важной операцией планарной
технологии, поскольку от ее разрешающей способности и точ-
ности совмещения зависит плотность упаковки элементов в ИС.
Литография является и наиболее часто используемой в планар-
ной технологии операцией. Так, при производстве микросхем
памяти емкостью 1 Гбит (разработка 2002 г.) требуется 31 опе-
рация литографии, 18 из которых являются «критическими»,
то есть требующими максимального разрешения и точности сов-
мещения.
Более подробную информацию о разных методах литографии,
изготовлении шаблонов, свойствах фоторезистов можно найти
в работах [58, 139-143].

2.8. Элементы интегральных схем на биполярных транзисторах 197
Технология локальной диффузии. Возможности диффузии
как способа введения примесей III и V групп в Ge и Si для
создания в полупроводнике областей р- и n-типа проводимости
были впервые продемонстрированы Пфанном из Bell Laboratories
и Холлом и Данлэпом из General Electric в 1949-1950 гг.
В 1955 г. Дерик и Фрош (Bell Laboratories) запатентовали
использование слоя окисла, созданного на поверхности кремния
при его термическом окислении, в качестве маски для защиты
Si от проникновения в него диффундирующих примесей. Ос-
нованием для этого является то, что коэффициент диффузии
многих важных легирующих примесей (В, Р, As) в SiC>2 на по-
рядок меньше, чем в кристаллическом Si, и поэтому слой окисла
толщиной 0,5-1 мкм может служить эффективной защитой, не
позволяющей указанным примесям проникать с поверхности в
лежащий под. окислом кремний. Заметим, что этот метод не
годится для защиты кремния при легировании его примесями Ga
и AI, коэффициент диффузии которых в SiC>2 выше, чем в Si.
Для создания защитного слоя окисла кремниевую пластину
нагревают в атмосфере сухого или влажного кислорода или
просто в парах воды. Было установлено, что присутствие в кис-
лороде даже небольшой примеси паров воды (~10
_3
%) вызывает
резкое увеличение скорости окисления (на 1-1,5 порядка). Слой
образующегося Si02 оказывается в 2,2 раза толще слоя израсхо-
дованного на окисление кремния, и поэтому на границе Si/Si02
возникают сильные механические напряжения, которые могут
привести к повреждению структуры. По этой причине окисление
обычно проводят при температурах выше 950 °С, при которых
возникающие упругие напряжения снимаются за счет вязко-
го течения образующегося стеклообразного (аморфного) SiC>2.
Для получения пленки толщиной 1 мкм время окисления во
влажном кислороде при атмосферном давлении и 1000 °С состав-
ляет ~4 часа [58].
Следует отметить, что в современной технологии слои Si02
используются не только в качестве защитных масок, но и как
источник примеси при проведении диффузии. Дело в том,
что, попадая в S1O2, примеси бора и фосфора образуют с
двуокисью кремния сравнительно легкоплавкие боросиликатное
и фосфорно-силикатное стекло. При обычных для диффузии тем-
пературах эти стекла становятся жидкими, они прекрасно сма-
чивают поверхность кремния и растекаются по ней. Помимо со-
здания на поверхности однородной содержащей примесь пленки,
это покрытие выполняет очень важную функцию — предохраняет
поверхность кремния от эрозии (газового травления). По этой

198
Гл. 2. Биполярные транзисторы
причине первый этап операции диффузии (так называемую за-
гонку примеси) проводят в проточной системе, добавляя в поток
газа, содержащий примесь, еще и кислород. При этом открытые
участки поверхности кремния покрываются тонким слоем окис-
ла, который реагирует с находящейся в газовой фазе примесью
и образует соответствующее примесно-силикатное стекло. На
втором этапе операции диффузии, называемом разгонкой при-
меси, примесные атомы диффундируют из этой пленки стекла
в глубь кристалла. Описанная технология позволяет получить
диффузионные слои с концентрацией примеси до 10
18
см
-3
.
Типичные температуры загонки и разгонки примеси в кремнии
составляют 1000 и 1200
D
C, соответственно.
Фосфорно-силикатное стекло выполняет еще одну важную
функцию: оно служит геттером примесей щелочных и некото-
рых переходных металлов, которые могут попадать в структуры
во время их изготовления. Как мы увидим в п.п. 3.1.1 и 4.1.1,
активизирующиеся во время термообработки примеси золота,
меди и железа могут существенно уменьшать время жизни в Si,
а примеси щелочных металлов — вызывать нестабильность ха-
рактеристик МОП-транзисторов.
Ионная имплантация. Говоря о легировании полупровод-
ников, нельзя обойти вниманием метод ионной импланта-
ции [108, 144], заключающийся в бомбардировке поверхности
кристалла ионами легирующих примесей, ускоренными до энер-
гии 5-500 кэВ. В результате этой бомбардировки примеси внед-
ряются в кристалл и распределяются там по глубине так, что их
профиль распределения имеет приблизительно гауссову форму
с максимумом, находящимся на некотором расстоянии от по-
верхности. Глубина залегания этого максимума зависит от массы
и энергии ионов и обычно составляет 0,03-1 мкм.
1
)
Облучение высокоэнергичными ионами как метод направленного
изменения свойств полупроводников был впервые использован в 1950-
52 гг. Олом [145] для улучшения характеристик кремниевых дио-
дов, фотопреобразователей и точечных транзисторов. Несколько позже
При имплантации полупроводника ионами, движущимися в направлении
одной из кристаллических осей, рассеяние ионов в кристалле резко ослабля-
ется и наблюдается явление каналирования, состоящее в аномально сильном
проникновении ионов в кристалл. В кремнии это явление наиболее сильно
выражено для ионов, движущихся в направлении {110}. Для устранения неже-
лательного влияния этого эффекта на профиль легирования, оси кристалла
во время имплантации разориентируют на угол 5-10° относительно направле-
ния пучка ионов.

2.8. Элементы интегральных схем на биполярных транзисторах 199
Бредов с соавт. [146] изучали влияние облучения ионами К на вольт-
амперные характеристики точечных диодов. В 1955 г. Кассинс [147]
пытался использовать ионную имплантацию для легирования герма-
ния, но возникающие при бомбардировке образцов радиационные де-
фекты помешали ему добиться успеха. В 1957 г. Шокли [148] получил
патент на способ создания с помощью ионной имплантации заглублен-
ного слоя, тип проводимости которого противоположен типу проводи-
мости остальных частей кристалла; в патенте указывалось на необ-
ходимость проведения постимплантационного отжига для устранения
радиационных дефектов. Первыми изготовленными с помощью ион-
ной имплантации полупроводниковыми приборами были детекторы
ядерных излучений [149] и элементы солнечных батарей [150, 151].
G середины 70-х годов ионная имплантация становится стандартной
технологической операцией при производстве полупроводниковых при-
боров.
^ По сравнению с диффузией основными преимуществами ион-
ной имплантации как метода легирования являются: возмож-
ность более тонкого управления профилем и концентрацией вво-
димой примеси; возможность получения слоев с концентрацией
примеси выше 10
18
см"
3
; возможность создания очень мелких
0$ О, 1 мкм) легированных слоев и высокая степень чистоты (как
следствие использования масс-спектрометрических сепараторов
для выделения необходимого изотопа примеси при импланта-
ции). Кроме того, ионная имплантация характеризуется невы-
соким рассеянием внедряемых ионов в поперечном направлении
(20-40% от средней глубины проникновения), что позволяет
при использовании этого метода сохранять высокое разрешение,
задаваемое фотолитографией, и создавать легированные области
очень малых размеров.
Поскольку при ионной имплантации в кристаллах возника-
ем'высокая концентрация радиационных дефектов (число кото-
рЫх обычно намного превосходит число внедренных атомов),
1
)
то после имплантации необходимо провести термообработку
полупроводника, чтобы отжечь эти дефекты, восстановить кри-
сталлическую структуру и перевести легирующие примеси из
нейтральных комплексов в электрически активное состояние.
В случае кремния эта термообработка проводится при темпера-
*)
При высокой дозе облучения ионами (>10
14
-10
15
см"
2
) приповерхност-
ный слой полупроводника может вообще аморфизоваться. Избежать амор-
физации поверхности можно проводя «горячее внедрение», то есть проводя
имплантацию в нагретый кристалл. Это особенно важно для GaAs, поскольку,
в отличие от Si, при кристаллизации возникающего в GaAs аморфного слоя
получается материал очень низкого качества. Поэтому ионную имплантацию
в GaAs и InP проводят при температурах 150-250
®С.

200 Гл. 2. Биполярные транзисторы
турах 500-1000 °С, причем чем выше доза внедренных ионов,
тем более длительная и высокотемпературная термообработка
требуется для отжига дефектов. В кристаллах, в которых припо-
верхностный слой аморфизовался, отжиг при -^600 °С приводит
сначала к образованию дислокационной структуры, которая от-
жигается только при ~1000 °С. Заметим, что при указанных тем-
пературах диффузия в кремнии еще незначительна, и профиль
распределения внедренных примесей по глубине практически не
меняется.
В 1974-1975 гг. как альтернатива термическому отжигу была
предложена технология лазерного отжига [152]. При лазерном
отжиге имплантированные структуры в течение короткого вре-
мени облучаются импульсным или непрерывным светом лазера,
который при плотности возбуждения 1-10 Дж/см
2
оказывает
действие, эквивалентное термообработке при 1000 °С. Оказыва-
ется, что действие интенсивного облучения светом не сводится
только к нагреву полупроводника: в образцах наблюдаются эф-
фекты, которые отсутствуют при термическом отжиге {108]. Эти
особенности связываются с интенсивной генерацией электронно-
дырочных пар светом и, по-видимому, являются следствием из-
вестного факта, что темп отжига радиационных дефектов воз-
растает при рекомбинации неравновесных носителей на этих
дефектах. Важным преимуществом лазерного отжига является
то, что время обработки пластины обычно не превышает одной
минуты, в то время как продолжительность термического отжига
измеряется часами.
В качестве примера использования ионной имплантации рас-
смотрим формирование профиля легирования базы транзистора
со «скрытым» эмиттером. Начнем с того, что при создании
транзисторов по стандартной планарной технологии (см. с. 203)
их эмиттеры создаются последними и располагаются на самом
верху структуры, а необходимый для создания в базе тянуще-
го электрического поля профиль легирования базы транзистора
(с убыванием концентрации по мере удаления в глубь кристал-
ла, см. рис. 2.56) получается за счет диффузии акцепторной
примеси. В то же время для изготовления современных инте-
гральных микросхем И
2
Л (см. п. 2.8.2) необходимы транзисторы,
в которых скрытый (лежащий в глубине структуры) п
+
-слой
служил бы эмиттером, а область n-типа на поверхности — кол-
лектором. Чтобы такой транзистор имел высокий коэффициент
усиления и высокое быстродействие, необходимо сформировать

2.8. Элементы интегральных схем на биполярных транзисторах 201
такой профиль легирования ба-
зы • при котором концентрация
примеси возрастает по мере
удаления от поверхности. Та-
кой профиль может быть по-
лучен только ионной имплан-
тацией. Распределение легирую-
щих примесей в транзисторе со
•скрытым» эмиттером, в котором
необходимое распределение ак-
цепторов в базе создано ионной
имплантацией атомов бора, пока-
зано на рис. 2.22.
В 1987 г. в связи с разработкой
методов создания все более мелких
jHn-переходов была предложена мо-
дификация метода ионной имплан-
тации — метод ионной имплантации при погружении в плазми
или, как его еще называют, метод плазменного легирования (153]. О
Этот метод позволил преодолеть недостаток стандартной схемы ион-
ной имплантации — проблему получения большого тока ионов при
их малой энергии. Реализовать этот метод можно в обычной ка-
мере для плазменной обработки полупроводников, добавив в по-
ток газа-носителя {Н2, Не, Аг) небольшое количество газообразных
соединений легирующих примесей (ВГНБ, РНз, АбНз). При подаче
на полупроводниковую подложку коротких импульсов отрицательного
напряжения амплитудой 1-10 кВ (длительность 5-20 мкс, частота
0,2-5 кГц) в результате электрического разряда в камере возбужда-
ется плазма, и ускоренные ионы внедряются в незащищенные участ-
ки поверхности полупроводника. Профиль получаемого распределения
атомов примеси по глубине имеет максимум вблизи поверхности (и,
следовательно, похож на профиль, получаемый при диффузии), однако
примеси локализованы в очень тонком (200-600 А) слое, а их кон-
центрация может превышать 10
20
см~
3
. Различные применения этого
метода имплантации рассмотрены в обзорной статье [154].
Ионная имплантация является важным компонентом совре-
менной технологии БИС и СБИС, позволяющим создавать неглу-
бокие р-n-переходы, необходимые для современных биполяр-
ных и полевых транзисторов субмикронных размеров. С по-
мощью ионной имплантации изготавливаются перспективные
ДЛЯ интегральных микросхем подложки со структурой кремний-
Рис. 2.22. Распределение примесей
в транзисторе со «скрытым» эмит-
тером и иоино- легирован ной базой.
Вектор С указывает направление
встроенного электрического поля,
способствующего дрейфу инжекти-
рованных электронов от эмиттера
к коллектору
') Для обозначения этой технологии в зарубежной литературе используют
аббревиатуру РШ (plasma immersion ion implantation).
