Лебедев А.И. Физика полупроводниковых приборов
Подождите немного. Документ загружается.


172
Гл. 2. Биполярные транзисторы
Поскольку присутствие подложки, на которой выращивает-
ся гетероструктура, заметно увеличивает емкость коллекторного
перехода и постоянную времени в 1998 г. была пред-
ложена технология создания гетеропереходных транзисторов
с удаленной подложкой (transferred-substrate НВТ). На струк-
турах lnP/In
x
Gaj-iAs/InP с удаленной подложкой в 1998 г.
удалось увеличить максимальную частоту генерации до 425 ГГц,
а в 1999 г. появились сообщения о транзисторе с f
max
=
= 1080 ГГц [122]. Таким образом, в настоящее время устройства
на биполярных транзисторах способны генерировать колебания,
длина волны которых в вакууме короче 0,3 мм (эта область длин
волн отвечает дальней ИК-области спектра).
GalnAs
р
+
J п | те
1-
www
э б
n
+
-Si p
+
-Sii_
I
Ge
I
n-Si
к
к
Рис, 2.13. Энергетические диаграммы гетеропереходных транзисторов: а —
конструкция с широкозонным эмиттером, 6 — конструкция с варнзонной базой
Несколько неожиданным результатом, обнаруженным при
исследовании гетеропереходных транзисторов InP/In^Gai-^As,
оказалось то, что с ростом напряжения на коллекторе время
пролета т
ес
может возрастать [123]. Причиной этого является то,
что электроны, попадающие в коллекторный переход и ускоряе-
мые там электрическим полем, приобретают энергию, достаточ-
ную для перехода из основного минимума зоны проводимости
в побочные минимумы, в которых подвижность электронов и
скорость дрейфа существенно ниже. Этот эффект междолинного
рассеяния выражен тем сильнее, чем больше толщина коллек-
торного перехода и выше напряженность электрического поля в
нем. Так, в коллекторе толщиной 3000 А в работе [123] при
увеличении напряжения на коллекторе наблюдалось двукратное
возрастание времени пролета тс (см. формулу (2.19)). Проведен-
ное авторами моделирование показало, что междолинное рассея-
ние при движении в поле коллектора становится существенным
уже при его толщине 2000 А,

2.4. Высокочастотные свойства и быстродействие транзисторов 173
Другой тип структуры биполярного гетеропереходного
транзистора имеет энергетическую диаграмму, показанную
на рис. 2.136. Идея создания такого транзистора с базой из
полупроводника с переменной шириной запрещенной зоны
была впервые высказана Крёмером в 1954 году, а Мартин и
Стреттон [124] теоретически изучили высокочастотные свойства
этого транзистора. Оригинальное название этой структуры
{graded bandgap base transistor — транзистор с градиентом
ширины запрещенной зоны в базе) почему-то не прижилось,
и в современной литературе эти транзисторы тоже называют
гетеропереходными биполярными транзисторами (НВТ). Идея
этой конструкции — создать в базе транзистора очень сильное
тянущее электрическое поле для дрейфа носителей за счет
использования в качестве базы варизонной структуры с
непрерывно уменьшающейся по мере удаления от эмиттера
«Еириной запрещенной зоны (см. рис. 2.136). Кроме очевидного
уменьшения времени пролета носителей через базу, наличие
тянущего поля увеличивает коэффициент инжекции эмиттера,
что позволяет более сильно легировать базу транзистора при
t
сохранении высокого коэффициента усиления.
В начале 80-х годов фирма IBM предложила создать описы-
ваемый транзистор, используя хорошо отлаженную кремниевую
Технологию и твердый раствор Si
i
_
ж
Ое
ж
в качестве материала
0азы. Такие транзисторы были получены в 1987 г. и оказались
намного дешевле гетеропереходных транзисторов на основе по-
лупроводников группы A
I
"B
V
. Основным препятствием для со-
здания варизонной структуры в базе является большое различие
параметров решетки Ge и Si (около 4%, см. таблицу на с. 85).
Это может приводить к возникновению дефектов на гетерогра-
ницах. Однако, как мы уже отмечали в п. 1.6.1, в тонких слоях
небольшое рассогласование решеток может «сдерживаться» за
счет упругой деформации слоя (псевдоморфная структура). Для
пары Si-Sii-xGex предельные значения х составляют 8-12%
Ge при толщине базы 800-1000 А и 16-24% Ge при толщине
базы 400-500 А. Высокая максимальная частота генерации этих
транзисторов получается за счет возможности более сильно ле-
гировать базу и уменьшать Гб (типичные концентрации носи-
телей в эмиттере, базе и коллекторе составляют 7 • 10
18
, 10
19
и 4- Ю
16
см
-3
), а сильное тянущее электрическое поле в базе
(30-50 кВ/см) существенно увеличивает частоту отсечки.
Первые промышленные низкошумящие гетеропереходные
транзисторы Si/Sii-^Gex с частотой отсечки fr > 15 ГГц
появились в 1999 г. (транзистор 43RF0100 фирмы IBM);

174
Гл. 2. Биполярные транзисторы
в 2002 г. частота отсечки этих транзисторов уже достигала
350 ГГц [125], а /
тах
— 185 ГГц. Минимальный коэффициент
шума, полученный в этих гетеропереходных транзисторах, со-
ставляет 0,2 дБ. В настоящее время из транзисторов Si/Sii_a;Ge
x
уже созданы интегральные схемы, содержащие более 10
5
транзи-
сторов. О современном состоянии разработок приборов на основе
этих гетеропереходных транзисторов можно прочитать в [126].
Транзисторы на горячих электронах. Использование гете-
ропереходов позволяет создать транзисторы, в которых потенци-
альные барьеры образуются не за счет чередования слоев одного
полупроводника разного типа проводимости, а за счет чередова-
ния слоев различных полупроводников. При этом все три обла-
сти транзистора могут иметь один и тот же тип проводимости
и транзистор будет работать только на основных носителях.
В качестве носителей в таких транзисторах используют элек-
троны, поскольку их подвижность в полупроводниках обычно
выше подвижности дырок. Строго говоря, такие транзисторы уже
нельзя отнести к биполярным приборам, и мы рассматриваем их
в этом разделе несколько условно.
Примером такого типа транзисторов может служить транзи-
стор на горячих электронах [88, 127, 128], также называемый
баллистическим транзистором. О Работа этого транзистора
происходит следующим образом. Приложенное между эмитте-
ром и базой напряжение модулирует поток электронов, тунне-
лирующих из эмиттера в базу сквозь потенциальный барьер,
созданный из широкозонного полупроводника или диэлектрика
(см. рис. 2.14,а). В базе энергия этих электронов относительно
уровня Ферми оказывается равной
Е — F
n
« gVg
3
, а их скорость
намного превышает скорость насыщения. Если толщину базы
сделать очень тонкой (меньше длины свободного пробега го-
рячих электронов), то происходит их баллистический перенос,
при котором большинство электронов без рассеяния достигают
') Идея создания транзистора с туннельной инжекцией горячих электронов
была впервые высказана и реализована на структурах AI/AI2O3/AI/AI2O3/A!
Мидом [129]. По оценкам автора, потенциальное быстродействие этих тран-
зисторов (10
12
Гц) может даже превышать быстродействие биполярных тран-
зисторов. Однако из-за невысокого коэффициента усиления перспективы прак-
тического использования транзисторов на горячих электронах пока не ясны,
В зарубежной литературе для обозначения этих транзисторов используются
аббревиатуры НЕТ (hot-electron transistor) и THETA (tunneling hot-electron
transfer amplifier).
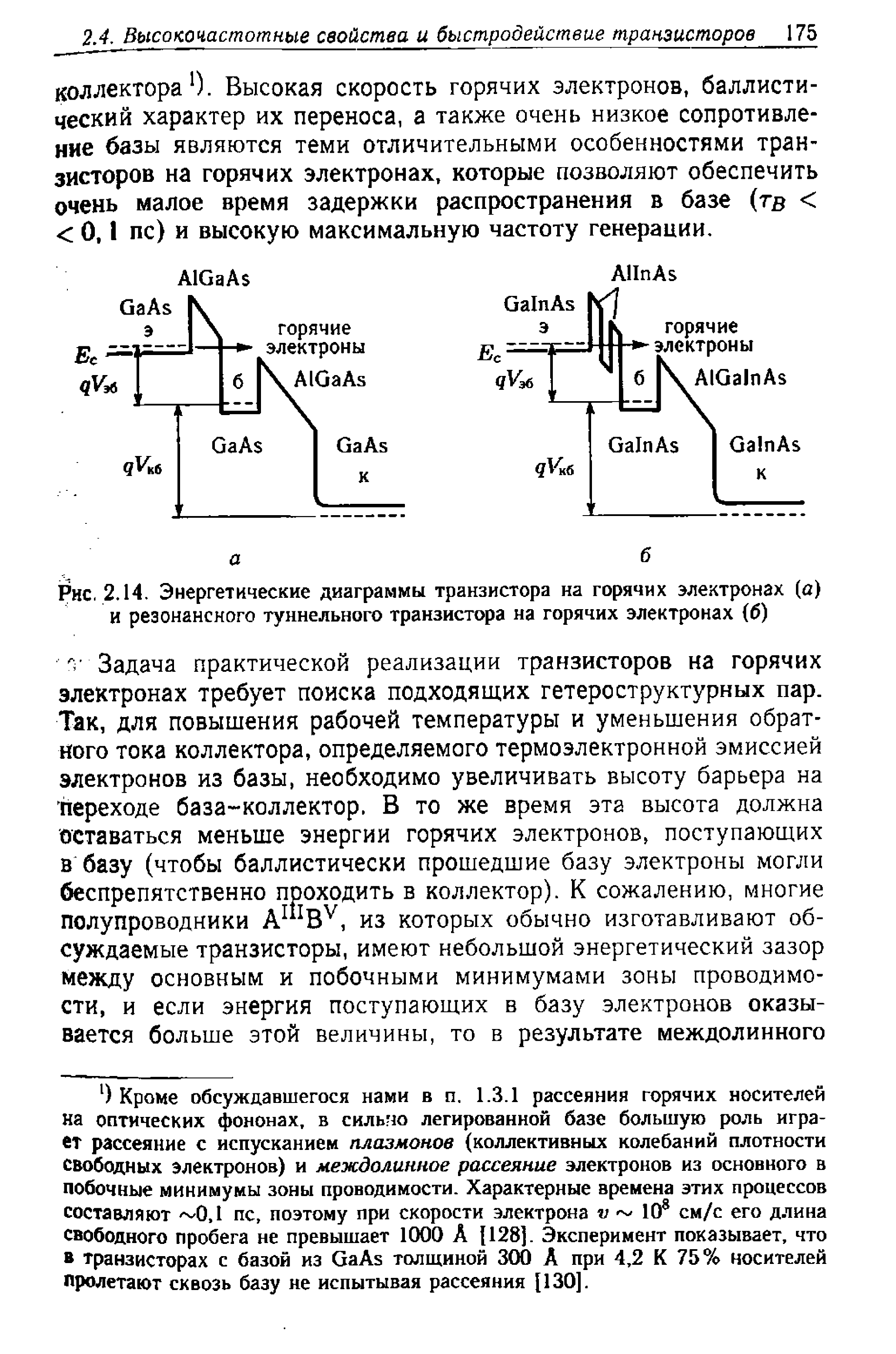
2.4. Высокочастотные свойства и быстродействие транзисторов 175
коллектора
1
). Высокая скорость горячих электронов, баллисти-
ческий характер их переноса, а также очень низкое сопротивле-
ние базы являются теми отличительными особенностями тран-
зисторов на горячих электронах, которые позволяют обеспечить
очень малое время задержки распространения в базе (тв <
< 0,1 пс) и высокую максимальную частоту генерации.
AIGaAs AlInAs
Рис. 2.14. Энергетические диаграммы транзистора на горячих электронах (о)
и резонансного туннельного транзистора на горячих электронах (б)
"5" Задача практической реализации транзисторов на горячих
электронах требует поиска подходящих гетероструктурных пар.
Так, для повышения рабочей температуры и уменьшения обрат-
ного тока коллектора, определяемого термоэлектронной эмиссией
электронов из базы, необходимо увеличивать высоту барьера на
'переходе база-коллектор. В то же время эта высота должна
оставаться меньше энергии горячих электронов, поступающих
в"
базу (чтобы баллистически прошедшие базу электроны могли
беспрепятственно проходить в коллектор). К сожалению, многие
полупроводники A
I
^
I
B
V
, из которых обычно изготавливают об-
суждаемые транзисторы, имеют небольшой энергетический зазор
между основным и побочными минимумами зоны проводимо-
сти, и если энергия поступающих в базу электронов оказы-
вается больше этой величины, то в результате междолинного
1
) Кроме обсуждавшегося нами в п. 1.3.1 рассеяния горячих носителей
на оптических фононах, в сильно легированной базе большую роль игра-
ет рассеяние с испусканием плазмонов (коллективных колебаний плотности
свободных электронов) и междолинное рассеяние электронов из основного в
побочные минимумы зоны проводимости. Характерные времена этих процессов
составляют пс, поэтому при скорости электрона v ~ 10
8
см/с его длина
свободного пробега не превышает 1000 А {128]. Эксперимент показывает, что
в транзисторах с базой из GaAs толщиной 300 А при 4,2 К 75% носителей
пролетают сквозь базу не испытывая рассеяния [130].

176
Гл. 2. Биполярные транзисторы
рассеяния длина свободного пробега электронов в базе сильно
уменьшается. Это, в частности, относится к GaAs, в котором
энергетические зазоры АЕГ-L = 0.28 эВ и АЕг-х = 0.48 эВ
слишком малы, чтобы транзистор мог работать при комнатной
температуре. В твердом растворе InjGai-^As величина зазора
АЕг-ь возрастает с ростом х, достигая эВ в In As [69].
Кроме рассеяния горячих носителей в базе, серьезную про-
блему при разработке транзисторов на горячих электронах созда-
ет эффект квантовомеханического (надбарьерного) отраже-
ния электронов от барьера, образованного коллектором. Согласно
квантовой механике, даже если энергия электрона такова, что
возможно классическое преодоление этого барьера, некоторая
часть электронов, достигающих коллектора, отражается назад
в базу, и, рассеиваясь в ней, увеличивает ток базы. Доля от-
раженных электронов
R
определяется соотношением волновых
чисел электрона к\ перед барьером и после него и может
составлять М0% [88] (для прямоугольного барьера R = (к\-
—
к2)
2
/(к\ + /сг)
2
). Поэтому получение высоких коэффициентов
усиления в транзисторах на горячих электронах представляет се-
рьезную проблему. В тщательно сконструированных транзисто-
рах на горячих электронах коэффициент усиления (3 достигает
25 при 77 К и 17 при 300 К, а частота отсечки — 40 ГГц [127].
Как вариант транзистора на горячих электронах можно рас-
сматривать и конструкцию транзистора с металлической ба-
зой [14, 127]. В этой конструкции роль базы выполняет тонкий
слой металла (толщиной в несколько десятков А). При такой
толщине горячие носители практически не успевают рассеяться
в слое металла и легко достигают коллектора. Однако из-за
сильного вырождения электронов в металле значения волновых
векторов fci и
в
металле и полупроводнике существенно разли-
чаются, и эффект квантовомеханического отражения на границе
металл-кремний проявляется очень сильно. Поэтому в монолит-
ных кремниевых транзисторах Si/CoSi2/Si, в которых базой слу-
жит тонкий слой силицида кобальта (имеющий металлическую
проводимость), максимальный коэффициент усиления по току
в структурах без «дыр» в слое базы составляет а ~ 0,15 [127].
Сочетание идеи транзистора на горячих электронах с иде-
ей резонансно-туннельного диода позволяет создать резонансно-
туннельный транзистор на горячих электронах (RHET —
resonant-tunneling hot-electron transistor). В этом транзисторе
(см. рис. 2.14 6) для инжекции горячих электронов использу-
ется структура резонансно-туннельного диода, описанная на-
ми на с. 115. Наиболее привлекательным в этих транзисторах

2.5. Транзисторы в схемах усиления сигналов
177
указывается существование падающего участка на их вольт-
доперных характеристиках, которое может найти применение
При создании различных логических элементов. Частота отсечки
ф таких транзисторах достигает 40 ГГц.
Т
V
2.5. Транзисторы в схемах усиления сигналов
\
г 2.5.1. Схемы включения транзистора и выбор рабочей
Зочки. Как мы показали в п. 2.1, характеристики транзистора
позволяют использовать его в качестве усилителя электрических
<*йгналов. С точки зрения теории электрических цепей, выводы
•фанзистора можно включить так, чтобы один из выводов от-
носился к входной цепи, другой — к выходной цепи, а третий
;вывод был общим для обеих цепей (см. рис. 2.16а ниже). В за-
висимости от того, какой из трех выводов транзистора является
фбщим, различают следующие схемы включения транзисторов:
£ общим эмиттером (ОЭ), общей базой (ОБ) и общим коллек-
тором (ОК) [26, 131].
- В схеме с ОЭ входной сигнал подается на базу транзистора,
% выходной — снимается с коллектора; схема с ОЭ имеет отно-
сительно высокие входное и выходное сопротивление и характе-
ризуется высокими коэффициентами усиления по току и напря-
^нию. В схеме с ОБ сигнал подается на эмиттер транзистора
и снимается с коллектора; эта схема включения характеризуется
•низким входным и высоким выходным сопротивлением, а уси-
ление в схеме возможно только по напряжению (напомним,
Что коэффициент усиления современных транзисторов по току
Or чуть меньше единицы). В схеме с ОК сигнал подается на
базу транзистора и снимается с эмиттера; эта схема включения
•карактеризуется высоким входным и низким выходным сопро-
тивлением, а усиление в схеме происходит только по току (на-
пряжение на эмиттере в схеме с ОК практически точно следует
за напряжением на базе и поэтому коэффициент усиления по
напряжению близок к единице).
Для получения максимальной амплитуды выходного сигнала
и наименьших нелинейных искажений необходимо правильно
выбрать положение рабочей точки в электрической схеме, то
есть значения тока коллектора (1
К
) и напряжения на нем (У
К
э)
при нулевой амплитуде переменного сигнала. Рабочая точка А
(см. рис. 2.156) выбирается так, чтобы она лежала вблизи се-
редины нагрузочной прямой (так, чтобы У
кЭ
составляло прибли-
зительно половину напряжения питания схемы). Для расчета

178 Гл. 2. Биполярные транзисторы
вход
°Е
п
выход
<
2
250
200
< 150
ж
s
юо
50
1
[
ЪР o-J II
1 I 1
V*
а
0 2 4 6 8 10
Кэ, в
в
О 160 320 480
V,
6
, мВ
Рис. 2.15. Выбор рабочей точки усилителя на транзисторе: а — электрическая
схема, б, в — выходные и входные характеристики германиевого транзистора
ГТ322А
электрической схемы усилителя по типовой выходной вольт-
амперной характеристике (рис. 2.156) находится ток базы, от-
вечающий рабочей точке, а по типовой входной вольт-амперной
характеристике (рис. 2.15 в) находится отвечающее этому току
напряжение на эмиттерном переходе. После этого по известным
напряжениям и токам рассчитываются величины всех сопротив-
лений в схеме, При расчете схемы необходимо учесть неизбеж-
ный разброс параметров транзисторов (прежде всего, коэффи-
циента усиления /3) и их изменение с температурой. В схемах
на германиевых транзисторах приходится также принимать во
внимание довольно большой обратный ток коллектора 1
К
о и его
сильную зависимость от температуры. Для обеспечения хорошей
температурной стабильности рабочей точки значение тока в цепи
делителя напряжения на резисторах R\ и R2 обычно выбирают
в 5-10 раз больше рассчитанного тока базы, а в цепь эмиттера
добавляют резистор Я
э
, осуществляющий отрицательную обрат-
ную связь по току. Подробнее о расчете электрических схем
усилителей можно прочитать в [26, 131].
2.5.2. Описание транзистора с помощью h-параметров.
При расчете электронных схем методами теории электрических
цепей транзистор представляют в виде четырехполюсника (см.
рис. 2.16 а). Напряжение и ток на входе этого четырехполюсника
будем обозначать буквами с индексом 1 (Uь Л), а напряжение
и ток на выходе — буквами с индексом 2 (U2, h)- При описании
четырехполюсников два из этих четырех параметров считаются
независимыми переменными, а два других — зависящими от них
функциями. Характеристики четырехполюсника можно предста-
вить в виде семейства кривых, на которых зависимость каждого

2.5. Транзисторы в схемах усиления сигналов
! 79
из зависимых параметров как функция одного из независимых
параметров откладывается для ряда фиксированных значений
второго независимого параметра. В качестве примера таких ха-
рактеристик на рис. 2.156, в представлены зависимость /
к
(Кэ)
для ряда значений /
б
и зависимость /б(^бэ)
П
Р
И
Д
В
У
Х
значениях
1/
к9
для отечественного транзистора ГТ322А. Эти зависимости,
представленные в параметризованной форме (модель Эберса-
Молла [14]), используются при математическом моделировании
сложных электронных схем с помощью компьютерных программ,
наиболее популярной среди которых является программа SPICE.
h\2U2
h22
и
2
а о
s
Рис. 2.16. Представление транзистора в виде четырехполюсника (а) и эквива-
лентная схема транзистора на низких частотах (б)
' Вольт-амперные характеристики транзистора, вообще говоря,
являются нелинейными. Однако когда уровни сигналов неве-
лики, то связь между входными и выходными параметрами
можно с хорошей точностью считать линейной. В этом случае
расчет электронных схем существенно упрощается, поскольку
транзистор можно рассматривать как «черный ящик» и описы-
вать его набором дифференциальных (малосигнальных) парамет-
ров, которые равны отношению изменения зависимого параметра
к вызвавшему его малому изменению одного из независимых
Параметров при фиксированном значении другого независимого
параметра. В дальнейшем эти небольшие приращения входных и
выходных параметров мы будем обозначать маленькими буквами
(«ь U2, гг).
Для описания четырехполюсника с помощью введенных вы-
ше дифференциальных параметров наиболее употребительными
являются наборы z-, у- и h-пара метров. Для набора г-параметров
в качестве независимых переменных выбираются входной
г \
и
выходной i2 токи, для набора у-параметров ими служат вход-
ное uj и выходное т*2 напряжения, а для набора /i-параметров
независимыми переменными являются входной ток i\ и выходное
напряжение и2.

180
Г2. Биполярные транзисторы
Рассмотрим подробнее /i-параметры, которые часто использу-
ются при расчете электронных схем на транзисторах на низких
частотах. Линейные уравнения, выражающие зависимые пара-
метры через независимые переменные, имеют вид
Щ = h\\i\ -f hi2«2, ,
0 0
сч
• • I l yz.Zo)
1>2
=
П2\%\ Л-П22Щ-
Как следует из этих уравнений, параметр Н,ц характеризует
входное сопротивление транзистора при постоянном напряжении
на выходе (щ = 0). Параметр h{2 характеризует коэффициент
обратной связи по напряжению при неизменном входном токе
(ii = 0). Параметр характеризует коэффициент передачи тока
в прямом направлении при постоянном напряжении на выходе
(•U2 = 0). Параметр /122 характеризует выходную проводимость
при неизменном входном токе (i| = 0). Система уравнений (2.25)
позволяет представить транзистор на низких частотах в виде
эквивалентной схемы, которая показана на рис. 2.16 Д
Необходимо отметить, что значения /i-параметров различны
для разных схем включения. Для обозначения схемы включения,
к которой относятся эти параметры, после цифровых индексов в
обозначении параметра указывают одну из букв: э, б или к. Зная
значения /i-параметров для одной из схем включения, можно
вычислить соответствующие значения и для любой другой схемы
включения [132]. Так, например, коэффициент усиления по току
в схеме с ОЭ (/? = /121э) связан с коэффициентом усиления по
току в схеме с ОБ (а = /1215) следующим соотношением:
(2.26)
1 — а
В справочной литературе для многих транзисторов приво-
дятся зависимости /i-параметров от тока коллектора, которые
обычно измеряются на частоте 1 кГц при некотором заданном
напряжении на коллекторе. Такие зависимости для двух типич-
ных кремниевых транзисторов показаны на рис. 2.17,
В принципе, если рассматривать /i-параметры как комплекс-
ные величины, зависящие от частоты, то набор этих параметров
можно использовать для расчета электронных схем, работающих
в широком диапазоне частот. Однако для расчетов высокоча-
стотных схем (>100 МГц) удобнее использовать у-параметры.
Переход от ^.-параметров к наборам у- и г-параметров произ-
водится с помощью несложных формул, выводимых в теории
электрических цепей [132].

2.5. Транзисторы в схемах усиления сигналов
181
£
0,1 0,2 0,5
Л
/к, мА
0,1
0,2
0,1 0,2 0,5 I 2 5 Ю
/к, мА
2
U
£
S
еч
100
50
20
10
5
I I IIIIII
: 2N440I,
меиевг 1
т
ш
2Ы«401,меискг2
. ZK4400,
элемент 1
2N4400.
меиевг 2
£2*511111
i
0,1 0,2
0,5 1 2
/к, мА
5 10
Рис. 2.17. Зависимость ^-параметров кремниевых транзисторов 2N4400
и 2N4401 при = 10 В и Г
окр
= 25 °С. Кривые, обозначенные элемент 1
и элемент 2, указывают типовой разброс параметров транзисторов (26)
Все /i-параметры непосредственно связаны с внутренним
устройством и характеристиками транзисторов, о которых мы
говорили выше. Так, h\\б представляет собой дифференциальное
сопротивление эмиттерного р-п-перехода при прямом смещении
(hi
16
~ kT/qI
9
), /1213 есть ни что иное как коэффициент усиления
ПО току транзистора в схеме с ОЭ, а /&21б ~
то же
самое
в схеме с ОБ, Выходная проводимость транзистора /г22
э
связана
с рассмотренным в п. 2.2.5 эффектом Эрли. Наконец, параметр
h\2
3
описывает изменение напряжения на эмиттерном переходе
при фиксированном токе базы, вызванное изменением толщины
нейтральной области базы W' при изменении напряжения на кол-
лекторе. Как следует из формулы (2.4), уменьшение W' с ростом
Уж вызывает уменьшение Vбэ.
то есть знак
должен быть
отрицательным, однако из-за возрастания сопротивления базы
с уменьшением W' и увеличения падения напряжения на этом
сопротивлении при протекании тока в базе знак h\2
э
в реальном
транзисторе может измениться [113].
